식각 공정
기출문제 풀이
기출문제 ❶
건식 식각 공정의 종류와 원리를 설명하시오.
STEP 1 접근 전략
설명형 문제로 난이도는 중하 수준이며 건식 식각 공정 전반에 대한 기본적 문제이다.
건식 식각 공정의 4가지 종류와 방식에 대해 간략히 설명한다.
스퍼터링 식각 외 모두 적용되는 건식 플라즈마 식각 원리에 대해 설명한다.
너무 광범위한 문제이므로, 너무 지엽적이거나 깊게 들어가지 않도록 한다.
STEP 2 답안 구조화 TIP
Q 건식 식각 공정?
종류 및 특성
건식 식각 원리(플라즈마 식각)
식각제(라디칼) 확산 이동 → 피 식각 박막 표면 흡착 → 표면 반응 → 휘발성 반응 부산물 생성 → 탈착 및 확산 → 배기
STEP 3 모범답안
건식 식각은 크게, ① 플라즈마 내의 활성종(라디칼)을 식각제(Etchant)로 하여 화학 반응을 통해 식각하는 화학적(플라즈마) 식각, ② 플라즈마 쉬스 전압에 의해 이온을 가속시켜 피식각 물질을 물리적으로 떼어내는 물리적(스퍼터, Sputter) 식각, ③ 상기 화학적 식각과 스퍼터 식각을 혼합한 형태로 이온에 의한 표면 충돌을 통해 에너지 전달 후 화학적 식각이 보다 쉽게 이루어질 수 있도록 하여 식각율을 크게 개선한 반응성 이온 식각(Reactive Ion Etching, RIE), ④ 억제제(Inhibitor)를 사용하여 라디칼과 피 식각 물질의 표면 간의 반응을 억제함으로써 측벽을 보호할 수 있어 비등방성 식각 특성을 개선한 이온 강화 억제 식각(Ion enhanced inhibiting etching)의 4가지 방식으로 나눌 수 있습니다. 건식 식각은 습식 식각 대비 상기 4가지 공법 중 화학적 식각인 플라즈마 식각을 제외하고는 모두 수직 식각 특성이 강한 비등방성(Anisotropic) 식각으로 nm 수준의 미세 패턴의 식각이 가능하나 이온에 의한 물리적 식각을 동반하므로 선택비가 상대적으로 낮다는 특성을 갖습니다. 특히 이온만을 식각제로 사용하는 물리적(스퍼터, Sputter) 식각은 기판 바이어스 전압이 가장 높아 선택비가 가장 낮은 특성을 보입니다. 플라즈마 식각의 원리는 상기 4가지 공정 종류 중 스퍼터링 식각을 제외한 모든 공정에서 기본적으로 적용되며, 그 내용은 ① 플라즈마 내 식각제(라디칼)가 웨이퍼 표면의 경계층(Boundary layer)을 통해 웨이퍼 쪽으로 확산해 이동하고 ② 이동한 라디칼이 웨이퍼 표면의 피 식각층에 흡착됩니다. ③ 흡착된 라디칼과 피 식각층의 원자(분자)가 반응하면 ④ 이렇게 반응하여 만들어진 반응 부산물(By-Product)은 반드시 증기압이 높은 기체 상태가 되어야 합니다. 그리곤 마지막으로 ⑤ 반응 부산물이 확산에 의해 웨이퍼에서 탈착되어 배기로 나가게 됩니다.
고득점 답안 건식 식각 시 선택비를 제어할 수 있는 방법에 대해 예를 들어 설명한다. |
건식 식각 시 선택비를 제어할 수 있는 방법은 크게 3가지가 있습니다. 첫째, 탄소 격리(Carbon blocking) 현상을 이용하는 방법으로, Si에 대한 |
꼬리 질문 1 건식 식각 시 식각Angle을 줄이는 방법을 설명하시오. |
폴리머 계열의 식각 억제제(Inhibitor)를 피복시킴으로써 측벽을 보호해 수직성을 확보하는 이온 강화 억제제(Inhibitor)에 의한 식각 방법에서는, 억제제를 형성하기 위한 첨가제로 플라즈마에서 반응 후 증기압이 낮은 반응 부산물이 되어 표면에 증착되기 용이한 물질이 선호됩니다. 억제제는 주로 |
꼬리 질문 2 건식 식각 중 과도 식각이란 무엇인지 설명하시오. |
하부 피 식각 박막이 평탄하지 않고 굴곡을 가지게 되면 건식 식각이 진행됨에 따라 국부적으로 얇은 부분의 박막이 식각되면서 그 부분의 기판이 먼저 드러나게 됩니다. 이때 식각 대상 박막과 기판과의 식각 선택비가 좋지 않으면 남은 박막이 식각되는 동안 기판이 식각되어 손상을 입는 문제가 발생합니다. 생산성 향상을 위해서는 식각 처리량(Throughput)이 커야 하고 그러려면 식각 속도가 빨라야 하지만 선택비 문제로 인한 기판 손상은 제품의 특성 및 품질의 저하를 가져옵니다. 일반적으로 식각 속도가 빠른 공정 조건과 선택비가 좋은 공정 조건은 서로 트레이드 오프 관계에 있어 식각 시작부터 기판이 드러나는 순간까지는 식각 속도가 빠른 레시피를 사용하여 식각하고, 기판의 노출에 따른 종말점 감지(End Point Detection, EPD) 후에는 자동적으로 선택비가 좋은 레시피로 전환되도록 전체 레시피를 만들어 실행시키면 생성성과 품질 모두를 만족시킬 수 있게 됩니다. 이때 식각 시작부터 종말점 감지까지의 식각을 주 식각(Main etch)이라 하고, 이후 선택비가 우수한 레시피를 써서 잔여 박막을 상대적으로 느린 식각율로 식각하는 단계를 과도 식각(Over etch)이라 합니다.
|
꼬리 질문 3 식각 공정의 주요 파라미터에 대해 설명하시오. |
① 식각율(Etch Rate, E/R)은 일정 시간 동안 박막을 얼마만큼 제거할 수 있는지를 나타낸 값으로, 식각된 박막의 두께를 식각 시간으로 나눈 식각 속도를 의미합니다. 습식 식각의 경우는 식각제(Etchant)로 사용되는 케미칼의 종류, 농도, 온도에 따라, 건식 식각은 플라즈마 가스의 종류, 압력, 유속, 온도, 기판 전압에 따라 식각율이 달라집니다. ② 식각 선택비(Selectivity)란 식각 과정에서 동시에 식각되는 서로 다른 물질의 식각율의 비율로 정의됩니다. 즉 제거해야 할 층의 식각 속도와 보호해야 할 층(예를 들어 마스크 또는 정지층)의 식각 속도의 비율을 말하며, 일반적으로 특정 박막만을 식각해야 하므로 가능한 선택비가 높아야 합니다. 이는 식각율에 영향을 받으면서 반비례 관계에 있습니다. ③ 균일도(Uniformity)는 웨이퍼 내(In-a-Wafer), 웨이퍼 간(Wafer-to-Wafer), 로트(Lot) 간 식각 후 잔여막의 두께, 식각율의 균일도 등 식각이 얼마나 고르게 진행됐는지 또는 공정의 재현성을 평가하는 척도입니다. 통상 웨이퍼 내 여러 위치에서 측정하여 표준 편차를 구하거나 생산성을 고려하여 최소 포인트만을 측정하여 불균일성[(최대 식각율 - 최소 식각율)/(2 × 평균 식각율)[%]]을 나타내기도 합니다. 식각율의 균일도는 플라즈마의 밀도, 가스 유량 및 압력 등의 플라즈마 균일도의 개선으로 확보할 수 있으며, 이 또한 식각율에 영향을 받는 파라미터입니다. |
기출문제 풀이
기출문제 ❷
CCP-RIE와 ICP-RIE 장치를 비교하시오.
STEP1 접근 전략
비교형의 중 난이도 문제로 건식 식각 장치에 사용되는 2가지의 대표적 RF 플라즈마 소스 에 대한 이해도를 묻는 문제이며, 출제 빈도가 높다.
CCP와 ICP 플라즈마의 구조, 동작 원리 및 장단점을 설명한다.
STEP2 답안 구조화 TIP
Q CCP vs. ICP?
RF 플라즈마 → CCP & ICP(고밀도)
CCP
- 커패시터 형상 → 개방형 → 전자-벽면 충돌↑ → 손실 발생 → 저밀도
- 대면적 웨이퍼 가능, 플라즈마 & 쉬스 전압 동시 제어 → 기판 손상↑
ICP
- 코일 → 나선형, 솔레노이드형
- 전류 변화 → 자계 변화 → 전계 변화 → 전자의 회전
- 플라즈마 전원/기판 바이어스 전원 별도 가능 → 플라즈마 밀도↑ & 기판 손상↓
STEP3 모범답안
고주파 플라즈마 방식에는 용량성 결합 플라즈마(Capacitive Coupled Plasma, CCP)와 유도성 결합 플라즈마(Inductive Coupled Plasma, ICP)가 있습니다. CCP 방식은 두 전극이 마주보고 있는 커패시터 형상을 하고 있어 붙여진 명칭이고, ICP 방식은 코일을 이용하여 자기장을 발생시키는 원리이기 때문에 유도성 플라즈마라고 합니다. CCP에는 챔버의 상부에 나선형으로 코일이 감겨 있는 나선형(평면형)과 챔버의 벽을 감싸는 솔레노이드형(실린더형)이 있습니다. CCP는 RF 전원의 한 주기에 대해 전기장이 한쪽 방향으로만 개방적이어서 전자가 이동 중 챔버 벽이나 전극과 부딪혀 손실의 발생이 크므로 유도성 플라즈마 대비 상대적으로 저밀도 플라즈마라고 할 수 있습니다. CCP는 전극이 마주 보고 있어 대면적으로 균일한 플라즈마를 형성시킬 수 있다는 장점이 있지만 한 쌍의 전극으로 플라즈마의 생성/유지 및 쉬스 전압의 제어를 동시에 해야 하므로 플라즈마의 물리적 반응(이온 에너지)과 화학적 반응(전자 및 활성종의 밀도)을 독립적으로 제어하기가 어렵습니다. 이는 플라즈마의 고밀도화를 위한 높은 전력 사용 시 기판 전압 증가로 인해 이온 에너지 증가에 따른 기판 손상을 야기하기 때문입니다.
반면, ICP는 절연체에 코일을 감아 만든 안테나에 인가되는 고주파 교류 전류에 의해 자기장이 형성되고, 자기장의 시간 변화에 의해 전기장이 유도(패러데이 법칙)되어 이 전기장을 따라 전자가 원 운동을 하게 되는 원리입니다. 따라서 ICP는 전기장이 폐쇄적이어서 전자가 회전하며 운동하므로 챔버 벽이나 전극과 충돌하지 않아 상대적으로 고밀도의 플라즈마를 얻을 수 있습니다. 사용 압력은 수 mTorr에서 수 Torr 범위이고, 플라즈마의 밀도 제어는 ICP 플라즈마 소스를 사용하며 이온의 입사 에너지는 일반적으로 기판 바이어스를 추가하여 플라즈마의 물리적, 화학적 반응의 독립적 제어가 가능합니다.
꼬리 질문 1 고밀도 플라즈마를 사용하는 이유에 대해 설명하시오. |
고밀도 플라즈마란 정전 결합 플라즈마(CCP) 방식으로 얻을 수 있는 플라즈마의 밀도에 비해 높은 밀도를 얻는 경우를 말합니다. 이는 약 |
핵심 이론 정리
1. 건식 식각
건식 식각이란 진공 챔버 내에 가스를 공급하여 플라즈마를 발생시킨 후, 실리콘 기판이나 박막과의 화학·물리적 반응을 통해 휘발성이 강한 반응 부산물(By-Product)을 생성시켜 박막을 제거하는 공정이다. 크게 화학적 식각, 스퍼터(Sputter) 식각, 반응성 이온 식각, 이온 강화 억제 식각의 4가지 방식으로 나눌 수 있다. 화학적 식각인 플라즈마 식각을 제외하고는 모두 수직 식각 특성이 강한 이방성(Anisotropic) 식각이며, nm 수준의 미세 패턴의 식각이 가능하다.
(1) 물리적(스퍼터, Sputter) 식각
물리적(스퍼터) 식각은 [그림 3-27(a)]와 같이 자기 직류 바이어스(DC Self bias)에 의해 만들어진 높은 플라즈마 쉬스(Sheath) 전압을 이용해 이온을 가속시키고, 가속된 이온을 피 식각막에 충돌시켜 제거하는 물리적 식각이다. 선택비가 좋지 않은 단점이 있지만 수직 방향의 이등방성(Anisotropic)식각이 가능하다.
(2) 화학적(Chemical) (플라즈마) 식각
플라즈마 식각이라고도 하는 화학적 식각은 플라즈마 내 존재하는 중성 라디칼들이 피 식각물 표면과 화학적으로 반응한 후, 증기압이 높은 휘발성 반응 부산물을 형성하여 배기되면서 이루어진다. 이와 같이 화학적 식각은 라디칼의 확산에 의한 식각이므로 방향성이 없는 등방성 식각이며 화학 반응을 기반으로 하여 선택비가 우수하다.
(3) 반응성 이온 식각(Reactive Ion Etching, RIE)
반응성 이온 식각은 스퍼터 식각에서 사용되는 이온과 화학적 식각의 라디칼을 모두 이용하는 혼합형의 방식으로, 먼저 높은 에너지로 가속된 이온이 피 식각 박막의 표면에 충돌하면서 스퍼터링을 일으키고, 이는 피 식각 박막의 원자나 분자 간 결합을 파괴한다. 이후 결합이 약화된 박막 표면의 원자와 라디칼이 쉽게 화학 반응을 일으켜 화학적 식각 원리에 따라 박막이 제거되는 원리이다. 또한 반응성 이온 식각에서 라디칼의 화학적 반응은 측벽 방향보다 이온의 스퍼터링으로 결합력이 약화된 박막의 바닥 방향에 집중되므로 수직 식각의 비율이 증가하여 이방성 식각이 가능하다.
(4) 이온 강화 억제제에 의한 식각(Ion enhanced inhibitor etching)
RIE 중에서도 식각제의 반응성이 너무 높은 경우에는 이방성이 잘 확보되지 않는 경우가 있다. 이 문제는 피 식각 박막의 측벽에 식각 억제 물질을 피복 시킴으로써 개선할 수 있으며, 이렇게 측벽을 보호하여 수직성을 확보하는 방식을 이온 강화 억제제(Inhibitor)에 의한 식각이라 한다. 식각의 원리는 [그림 3-28]과 같으며 먼저 반응 기체와 함께 첨가제를 주입한다. 주입된 첨가제는 화학 반응을 통해 피 식각 박막의 측벽과 바닥면에 화학적으로 안정하여 화학적 식각을 방해하는 식각 억제제 물질을 형성한다. 직진성의 이온 충돌로 인해 측벽이 아닌 바닥면의 억제제만 제거되어 노출된 바닥면은 라디칼에 의한 화학적 식각에 의해 식각되고 다시 ⓐ 억제제 형성, ⓑ 이온에 의한 바닥면 식각, ⓒ 라디칼에 의한 바닥면의 화학적 식각의 과정을 반복하게 된다. 그 결과 거의 수직에 가까운 식각 형상(프로파일, Profile)을 얻을 수 있는 것이다.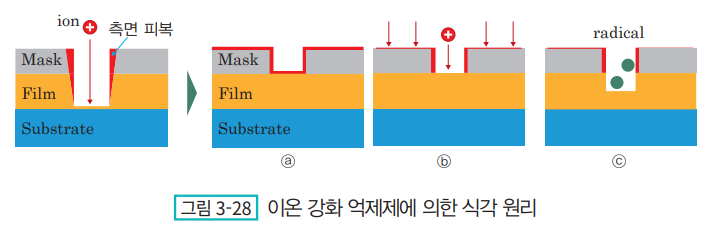
2. 고주파 플라즈마: CCP와 ICP
고주파 플라즈마 방식에는 용량성 결합 플라즈마(Capacitive Coupled Plasma, CCP)와 유도성 결합 플라즈마(Inductive Coupled Plasma, ICP)가 있다. CCP 방식은 [그림 3-29(a)]와 같이 두 전극이 마주보고 있는 커패시터 형상을 하고 있어 붙여진 명칭이고, ICP 방식은 코일을 감아 만든 안테나를 이용하여 자기장을 발생시키는 원리이기 때문에 유도성 플라즈마라고 한다. 에너지 전달 방식이 변압기의 원리와 유사하다는 의미로 ICP 대신 T(Transformed)CP라고도 불린다. ICP의 구조로는 [그림 3-29(b)]와 같은 챔버의 상부에 나선형으로 코일이 감겨 있는 나선형(평면형) ICP와 [그림 3-29(c)]와 같이 챔버의 벽을 감싸는 솔레노이드형(실린더형) ICP가 있다. 먼저 CCP는 주로 10mTorr~10Torr 범위의 압력에서 공정이 이루어지고 전극 간의 거리는 1~10cm로 좁다. RF 전원의 한 주기에 대해 전기장이 한쪽 방향으로만 개방적이므로, 전자가 이동 중에 챔버 벽이나 전극과 부딪혀 손실될 가능성이 크다. 따라서 ICP 대비 상대적으로 저밀도의 플라즈마(
반면 ICP는 [그림 3-30(a)]와 같이 절연체에 코일을 감아 만든 안테나에 고주파 교류 전류를 인가해 자기장을 형성하고, 자기장의 시간 변화에 의해 유도된 전기장을 따라 전자가 원운동을 하는 원리이다. 따라서 ICP는 전자가 폐쇄적인 전기장을 따라 원운동을 하게 되므로, 챔버 벽이나 전극과 충돌하지 않아 상대적으로 고밀도의 플라즈마(
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기