예상문제 풀이
예상문제 ❶
Atomic Layer Etching(ALE) 공정에 대해 설명하시오.
STEP1 접근 전략
설명형 문제로 난이도는 중상 수준이며, 최신 식각 기술인 ALE 공정에 대한 문제로서, 최신 공정 트렌드에 대한 관심을 알아보고자 하는 의도에서 출제 가능성이 있다.
공정의 필요성, 원리, 장단점 및 응용에 대해 설명한다(ALD와 비교 설명하는 것도 좋다).
STEP2 답안 구조화 TIP
Q 원자층 식각 공정?
미세화 → 정밀 식각 요구 → Self-Limited ALE
반응-A(흡착, 표면 개질) → 퍼지 → 반응-B(탈착) → 퍼지
공정 윈도우
장점: 매끄러운 표면, 등방/비등방성 식각 가능, 높은 선택비
단점: 생산성↓, 공정 윈도우↓
응용: SAC 공정 등
STEP3 모범답안
반도체 소자의 미세화에 따라 더욱 정밀한 식각이 요구되고 있으며 이에 원자층 식각(Atomic Layer Etching, ALE) 공정의 필요성이 부각되고 있습니다. 원자층 식각은 원자층 증착(Atomic Layer Deposition, ALD)과 유사하게 자기 제한(Self-Limited)적인 표면 개질(Surface modification) 단계와 그 후 개질된 층의 제거 단계로 구성된 주기적 프로세스입니다. ALE 공정의 원리를 염소(Cl_2)와 아르곤(Ar)을 사용한 실리콘 식각 공정을 예로 들어 설명하면, 먼저 반응-A는 Cl_2 반응 가스를 실리콘 표면에 흡착시키는 단계로, 표면이 Cl_2 전구체(Precursor) 기체에 노출되어 노출된 실리콘 표면이 Cl_{2}에 의해 모두 흡착되면 추가적으로 Cl_2 전구체를 투여하더라도 더 이상의 반응이 일어나지 않고 자기 제한적인 특성에 따라 화학 흡착됩니다. 이러한 흡착은 다음 단계에서의 원자층을 제거하기 위한 이온 충돌 에너지를 감소시키는 역할을 합니다.
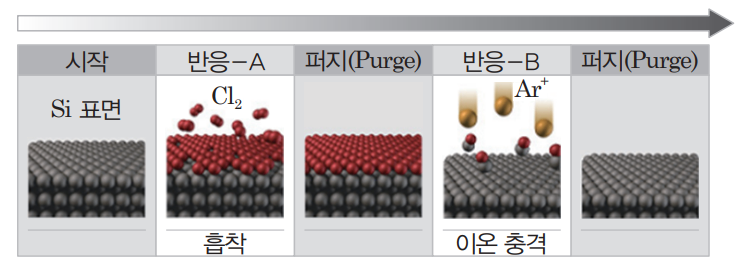 다음은 질소(N_2)나 아르곤(Ar)과 같은 비활성 기체를 충분한 시간동안 흘려 반응-A 단계에서의 과잉 전구체나 반응 부산물을 모두 제거하는 퍼지(Purge) 단계로, 이때 Cl_{2}가 퍼지되지 않고 남아 있으면 다음 반응-B 단계에서 Cl_{2}가 아르곤 이온(Ar^+)에 의해 분해되어 원치 않게 Si 표면이 식각되는 문제가 발생합니다. 다음은 반응-B 단계로 실제로 박막이 식각되는 단계입니다. 이때의 반응제(Co-Reactant)는 전자, 이온, 중성 원자, 열 에너지 및 광자(Photon) 등 다양합니다. 역시 이 단계에서도 자기 제한적 반응이 중요하며 열 에너지에 의한 SiCl2 탈착의 경우에는 등방성(Isotropic) ALE, 이온 충격에 의해 개질된 층을 제거하는 경우에는 비등방성(Anisotropic) ALE가 됩니다. 이온 충격의 경우에는 자기 제한적 프로세스가 가능한 특정 이온 에너지 영역이 존재하는데, 이를 공정 윈도우(Process window)라고 합니다. 이 윈도우를 넘어선 과도한 에너지 영역에서는 스퍼터링이 일어나 더 이상의 ALE 공정이 구현되지 않습니다.
다음은 질소(N_2)나 아르곤(Ar)과 같은 비활성 기체를 충분한 시간동안 흘려 반응-A 단계에서의 과잉 전구체나 반응 부산물을 모두 제거하는 퍼지(Purge) 단계로, 이때 Cl_{2}가 퍼지되지 않고 남아 있으면 다음 반응-B 단계에서 Cl_{2}가 아르곤 이온(Ar^+)에 의해 분해되어 원치 않게 Si 표면이 식각되는 문제가 발생합니다. 다음은 반응-B 단계로 실제로 박막이 식각되는 단계입니다. 이때의 반응제(Co-Reactant)는 전자, 이온, 중성 원자, 열 에너지 및 광자(Photon) 등 다양합니다. 역시 이 단계에서도 자기 제한적 반응이 중요하며 열 에너지에 의한 SiCl2 탈착의 경우에는 등방성(Isotropic) ALE, 이온 충격에 의해 개질된 층을 제거하는 경우에는 비등방성(Anisotropic) ALE가 됩니다. 이온 충격의 경우에는 자기 제한적 프로세스가 가능한 특정 이온 에너지 영역이 존재하는데, 이를 공정 윈도우(Process window)라고 합니다. 이 윈도우를 넘어선 과도한 에너지 영역에서는 스퍼터링이 일어나 더 이상의 ALE 공정이 구현되지 않습니다.
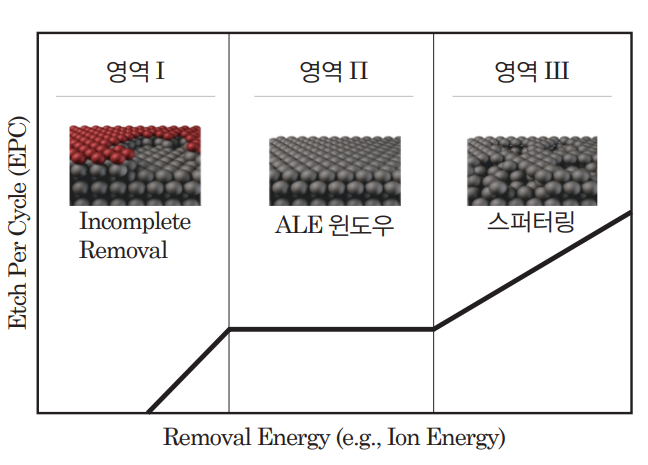 ALE 공정은 매끄러운 표면을 얻을 수 있고, 등방성 및 비등방성 식각의 선택이 가능하며 다양한 종횡비 구조의 박막을 높은 선택비로 식각할 수 있어 마이크로 트렌치(Trench) 및 마이크로 로딩 효과(Micro-Loading effect) 등의 개선을 포함한 많은 장점을 가지나, 공정 시간이 길어 생산성이 낮고 상기 설명한 공정 윈도우가 좁다는 단점도 있어 이 공정 여유도를 넓힐 수 있는 전구체와 공정 조건의 개발이 활발히 진행되고 있습니다. 현재 ALE 공정은 이방성과 높은 선택성으로 인해, 인접한 스페이서(Spacer)를 손상시키지 않고 좁은 콘택을 형성할 수 있는 자기 정렬 콘택(Self-Aligned Contact, SAC) 공정 등에 적용되고 있습니다.
ALE 공정은 매끄러운 표면을 얻을 수 있고, 등방성 및 비등방성 식각의 선택이 가능하며 다양한 종횡비 구조의 박막을 높은 선택비로 식각할 수 있어 마이크로 트렌치(Trench) 및 마이크로 로딩 효과(Micro-Loading effect) 등의 개선을 포함한 많은 장점을 가지나, 공정 시간이 길어 생산성이 낮고 상기 설명한 공정 윈도우가 좁다는 단점도 있어 이 공정 여유도를 넓힐 수 있는 전구체와 공정 조건의 개발이 활발히 진행되고 있습니다. 현재 ALE 공정은 이방성과 높은 선택성으로 인해, 인접한 스페이서(Spacer)를 손상시키지 않고 좁은 콘택을 형성할 수 있는 자기 정렬 콘택(Self-Aligned Contact, SAC) 공정 등에 적용되고 있습니다.