반도체 공정 기초
학습 포인트 |
본 단원에서는 반도체 공정을 이해하기 위한 기본적인 내용에 대해 설명한다. 반도체 공정에 대한 개괄적인 내용 및 반도체 공정이 이루어질 원판인 웨이퍼의 제조 공정, 그리고 반도체 공정을 이해하는 데 필수적인 진공과 플라즈마 기술에 대해 학습하도록 한다. |
개념 맵 |
1 반도체 공정 개요
반도체 제조 공정은 크게 반도체 공정이 진행되는 기판의 역할을 하는 웨이퍼 제조 공정과 웨이퍼를 가공하는 전공정(Front-end), 가공된 웨이퍼 내 칩(Chip)들을 자르고 조립하는 후공정(Back-end)으로 나뉜다. 첫 단계인 웨이퍼 제조 공정을 별도의 공정으로 분류하기도 하고, 전공정에 포함시키기도 하는데, 전공정에는 포토, 식각, 박막 증착, 금속배선, 산화 및 확산, 이온 주입, 화학적 기계적 연마(CMP), 세정 공정 등이 있으며, 후공정에는 웨이퍼 상태에서의 전기적 검사 단계인 EDS(Electrical Die Sorting)및 패키지(Package), 그리고 최종 검사(Final test) 과정이 포함된다. 8대 공정이라는 용어는 반도체 업계의 공식적인 용어는 아니지만, 주로 삼성전자에서 공정의 구성 항목으로 언급하는 용어이다. 삼성전자에서는 웨이퍼 제작, 산화, 포토, 식각, 증착&이온 주입, 금속배선, EDS, 패키지로 후공정까지를 포함하여 분류하고 있으며, 일반적으로는 8대 공정에 전공정(포토, 식각, 박막, 배선, 산화/확산, 이온 주입, CMP, 세정 공정)을 포함한다. 이에 본 서에서는 일반적인 분류에 따른 상세한 공정 단계를 다루고자 한다.
(1) 웨이퍼 제조 공정(Silicon wafer production process)
웨이퍼 제조 공정은 규석 등의 원석을 정제하여 다결정 실리콘으로 만든 후 초크랄스키(Czochralski, Cz) 방법을 이용해 고온에서 실리콘 용융액을 만들어 단결정 실리콘 종자(Seed)를 투입한다. 그 후 서서히 끌어 올리면서 잉곳(Ingot)이라고 하는 실리콘 기둥을 만든다. 다이아몬드 파우더가 코팅된 강철 와이어를 사용해 잉곳을 얇게 자르고, 화학적 식각 및 연마 과정을 통해 표면 손상을 제거한 후 세정 및 검사과정을 거치고 나면 웨이퍼 제조 공정이 완료된다.
(2) 반도체 전공정
①포토 공정(Photolithography)
포토 공정이란 반도체 회로 정보를 담고 있는 마스크 상의 패턴을 감광성 고분자 물질(Photoresist, 포토레지스트, PR)이 도포되어 있는 웨이퍼 상에 특정 빛을 조사하여 전사시키는 공정을 말한다. 포토 공정은 ⅰ) 포토레지스트와의 접착력을 위한 HMDS(Hexa-Methyl Di-Silazane) 표면 처리, ⅱ) 고분자 수지(Resin), 광 감응물질, 용제(Solvent)로 구성된 포토레지스트를 웨이퍼 상에 도포하는 감광액(PR) 도포(Coating), ⅲ) 포토레지스트 내 용매 제거를 위한 소프트 베이크(Soft bake), ⅳ) 이전에 형성된 층과의 위치 정합성을 맞추고 마스크에 빛을 조사하여 포토레지스트의 화학적 반응을 유도하는 정렬 및 노광(Align&Exposure), ⅴ) 포토레지스트의 화학 작용을 촉진하는 노광 후 열처리(Post Exposure Bake, PEB), ⅵ) 현상액을 사용해 포토레지스트를 선택적으로 제거하는 현상(Develop), ⅶ) 포토레지스트의 경도를 올리는 하드 베이크(Hard bake), ⅷ) 현상 후 검사(After Develop Inspection, ADI) 등의 세부 공정으로 구성된다.
②식각 공정(Etch)
식각 공정이란 불소(F) 등의 할로겐족 고 반응성 식각제(Echant)를 사용하여 포토 공정에서 정의된 박막의 일부 또는 전부를 물리·화학적 방법으로 제거하는 공정이다. 크게 액체 상태의 화학 약품(Chemical, 케미칼)을 사용하면서 등방성 특성을 갖는 습식 식각(Wet etch)과, 진공 플라즈마 내의 반응성이 높은 활성종(Radical) 및 고 에너지의 이온을 식각제로 사용하면서 미세 패턴 형성에 용이한 건식 식각(Dry etch)이 있다.
③박막 증착 공정(Thin film deposition)
통상 1μm 이하의 얇은 두께의 필름(Film)을 증착하는 공정을 말한다. 공정 방식에는 크게 반응 가스와 기판과의 화학적 반응을 통해 박막을 증착하는 화학 기상 증착(Chemical Vapor Deposition, CVD)과 증착 입자에 에너지를 전달하여 화학적 반응 없이 물리적으로 박막을 증착시키는 물리 기상 증착(Physical Vapor Deposition, PVD) 방법이 있다. CVD 방식에는 열을 반응 에너지원으로 하는 상압 및 저압 CVD, 플라즈마를 에너지원으로 하는 플라즈마 증속 CVD(Plasma Enhanced CVD, PE-CVD), 그리고 CVD와 유사한 원자층 증착(Atomic Layer Deposition, ALD) 등이 있으며, PVD 방식에는 금속을 증발시켜 증착시키는 진공 증착(Evaporation) 방식과 플라즈마 상태에서 강한 전기장에 의해 가속된 이온을 금속 타겟(Target)에 충돌시켜 떨어져 나온 금속 입자를 웨이퍼 상에 증착시키는 스퍼터링(Sputtering) 증착 방식이 있다.
④금속배선 공정(Metallization)
금속배선 공정은 웨이퍼 상에 형성된 소자들 간에 전력이나 신호를 전달해 주는 배선을 형성하는 공정으로, 이들 금속배선은 웨이퍼와의 부착성이 좋아야 하고 전기저항이 작아 전류가 잘 흘러야 하며 열과 화학적인 반응에 의한 금속 특성의 변화가 없어야 한다. 현재는 이러한 조건을 만족하는 물질인 W, Al, Cu 등이 주로 사용된다.
⑤ 산화 및 확산 공정(Oxidation&Diffusion)
산화 공정은 반도체 소자 간 누설 전류 차단, 불순물 확산 방지 등의 역할을 하는 SiO2 박막을 고온에서 성장시키는 공정으로, 건식과 습식 산화 방식으로 나뉜다. 산소에 의한 건식 산화는 산화막 성장속도가 느리지만 얇고 고품질의 막을 형성할 때 사용되고, 수증기를 사용하는 습식 산화는 산화막 성장속도가 빨라 보다 두꺼운 막을 형성할 때 사용된다. 확산 공정은 n 또는 p형 접합을 만들기 위해 불순물을 고온에서 웨이퍼에 주입하고 확산시키는 공정이다. 등방성 확산 특성으로 미세 패턴 형성이 어려워 현재는 거의 사용되지 않는 방식이다.
⑥이온 주입 공정(Ion implantation)
이온 주입 공정은 진공에서 불순물(도펀트)을 함유하는 가스를 플라즈마 상태로 만들고, 플라즈마 내 이온을 고 에너지로 가속시켜 웨이퍼에 불순물을 주입해 반도체에 전도성을 부여하는 공정이다. 확산 공정의 단점인 등방성(Isotropic) 확산으로 인한 반도체 소자 미세화의 어려움 등을 극복하고자 도입되었다. 고 에너지의 이온 주입으로 인한 웨이퍼 격자 손상 등의 결함은 급속 열처리 공정 적용으로 개선 가능하다.
⑦ 화학적 기계적 연마 공정(Chemical Mechanical Polishing, CMP)
CMP 공정은 화학·물리적 작용을 이용하여 이전 공정에서 형성된 구조물에 의한 웨이퍼 상의 단차를 제거하여 평탄화시키거나 불필요한 박막을 제거하는 공정이다. CMP 공정은 포토 공정의 초점 심도 여유 확보 및 구리 다마신(Damascene) 공정 등의 글로벌 평탄화에 대한 요구에 부응하기 위해 도입되었다.
⑧세정 공정(Cleaning)
세정 공정은 웨이퍼 표면의 이물질을 비롯하여, 유기 오염물, 금속 불순물, 그리고 자연 산화막 등의 원하지 않는 모든 불순물을 물리·화학적 방법을 사용하여 제거하는 공정이다. 강산 또는 강알칼리 용액을 사용하는 습식 세정과 플라즈마, 자외선 등을 사용하는 건식 세정으로 분류할 수 있다.
(3) 반도체 후공정
① EDS(Electrical Die Sorting)
EDS 공정이란 전기적 테스트를 통해 웨이퍼 상에 만들어진 반도체 소자의 불량을 선별하는 과정이다. 이때 (정상 작동 칩 수/설계된 최대 칩 수)를 수율(Yield)이라고 하며 메모리와 같이 여분의 회로를 가지고 있는 경우 물리적·전기적 회로 수정(Repair)을 통해 불량품을 양품으로 만들어 수율을 올리기도 한다.
② 패키지(Package) 및 최종 검사(Final test)
패키지는 웨이퍼 상의 반도체 칩을 자르고 포장하는 과정을 말한다. 칩들은 외부의 열악한 환경 및 충격으로부터 보호되어야 하므로 외부와 단절되어야 함은 물론, 외부의 입출력 신호와 연결될 수 있도록 전기적 연결이 되어야 한다. 이렇게 패키지가 완료된 칩에 대해 전기적으로 최종 양품을 선별하는 과정을 패키지(Package) 테스트 또는 최종 검사(Final test)라고 한다.
2 실리콘 웨이퍼 제조 공정
실리콘(Si) 웨이퍼는 소자 제조 업체가 아닌 웨이퍼 제조 전문 업체의 영역이지만, 웨이퍼 상에 형성되는 반도체 소자의 특성에 큰 영향을 미치는 중요한 원재료이므로 기본적인 웨이퍼 제조 공정에 대한 이해가 필요하다. 웨이퍼 제조 공정은 크게 ① 순수한 실리콘을 정제하는 공정, ② 단결정의 실리콘 웨이퍼를 제조하는 공정의 두 단계로 구분할 수 있다.
(1) 규암(Quartzite)으로부터 순수한 실리콘을 정제하는 공정
① 금속급 실리콘(Metallurgical Grade Silicon, MGS) 확보 단계
규암을 코크스(Coke) 등과 함께 용해로에 넣고 고온으로 가열하면 실리콘이 추출되는데, 이때 추출되는 실리콘을 금속급 실리콘이라 한다. 금속급 실리콘에는 철이나 알루미늄 등의 불순물이 포함되어 있는데, 이들을 제거하기 위해 정제과정을 거친다.
② 전자급 실리콘(Electronic Grade Silicon, EGS) 확보 단계
정제과정은 우선, 금속급 실리콘에 염산가스(HCl)를 반응시켜 3염화실란(Trichlorosilane, SiHCl3)을 만든다. 3염화실란은 끓는점이 약 31℃이기 때문에 분별 증류법을 이용해 쉽게 불순물을 제거하고 순수한 3염화실란으로 정제할 수 있다. 정제된 3염화실란에 수소를 반응시키면 순수한 실리콘을 얻을 수 있는데, 이는 정제된 다결정의 순수한 실리콘이며, 이것을 전자급 실리콘(Electronic Grade Silicon, EGS)이라고 한다.
(2) 순수한 실리콘으로부터 단결정의 실리콘 웨이퍼를 제조하는 공정
① 단결정 실리콘 잉곳(Ingot) 확보 단계
정제된 다결정 실리콘으로부터 단결정 실리콘 웨이퍼를 제조하는 방식에는 [그림 1-4]와 같은 초크랄스키(Czochralski, CZ) 방식과 플로팅 존(Floating-Zone, FZ) 방식이 있으나, 주로 대구경화 측면에서 유리한 CZ 방식을 사용하고 있다.
ⅰ) CZ 방식
다결정의 전자급 실리콘을 도가니(Crucible)에 넣고 열을 가해 액체 상태로 녹인(녹는점 1,420℃) 후, 단결정의 소형 막대기(실리콘 씨앗(Seed))를 꽂아 서서히 회전시키면서 들어올린다([그림 1-5] 참조). 이때, 웨이퍼의 전기 전도도를 조절하기 위한 불순물(도펀트)을 첨가하는데, 도핑 균일도 향상을 위해 씨앗과 액상 실리콘은 서로 반대 방향으로 회전하고, 씨앗의 결정성을 따라 액상 실리콘이 식으면서 씨앗 위에 단결정 형태의 고체 덩어리 봉이 만들어진다. 이러한 과정을 단결정 성장이라 하고, 생성된 단결정 봉을 잉곳(Ingot)이라 한다. 이때 잉곳의 지름은 당김 속도를 제어함으로써 결정되며 이것이 곧 웨이퍼의 크기가 된다. 웨이퍼의 크기가 클수록 한 번에 만들 수 있는 칩 수가 증가하기 때문에 6인치, 8인치, 12인치 등으로 점차 증가하는 추세이다.
ⅱ) FZ 방식
다결정 실리콘 봉(Rod)을 고주파 코일(RF Coil)에 의해 가열함과 동시에 한쪽 방향으로 이동시키면서 재결정화시켜 단결정의 잉곳을 얻는 방식이다. 도가니를 사용하지 않기 때문에 도가니로부터의 불순물 유입이 없어 고순도의 실리콘 단결정 형성이 가능하나 대구경화가 어려워 고순도 웨이퍼가 필요한 전력 소자(Power device) 등의 특수 용도로 사용된다.
② 절단(Cutting), 연마(Grinding) 및 플랫존(Flat-Zone) 형성 공정
ⅰ) 결정 결함이 많이 몰려 있는 잉곳의 상하부를 절단한다.
ⅱ) 최종 웨이퍼의 직경을 맞추는 직경 맞춤(Diameter grinding) 공정을 진행한다.
ⅲ) 플랫 연마(Flat grinding)를 통해 웨이퍼의 기준점이 되는 플랫존(노치)을 형성시킨다.
③웨이퍼 슬라이싱 공정(Slicing)
다이아몬드 톱이나 다이아몬드 코팅 강철 와이어를 이용해 잉곳을 수백 μm 두께로 얇게 절단한다.
④가장자리 라운딩 공정(Edge rounding)
밀링 커터(Milling cutter)로 웨이퍼의 가장자리를 둥글게 갈아내는 가장자리 라운딩(Edge rounding)을 함으로써 날카로운 모서리에 응력이 집중되어 발생하는 웨이퍼 파손(Chipping) 및 이물질 생성 등의 위험을 방지한다.
⑤ 연마 공정(Lapping&Polishing)
ⅰ) 표면 손상을 제거하고 웨이퍼 두께를 목표치에 근접하게 맞추어 응력을 낮추기 위해 웨이퍼의 앞뒷면을 갈아내는 1차 양면 연마(Lapping)를 실시한다.
ⅱ) 미세 표면 손상을 제거하기 위해 실리콘 웨이퍼의 습식 식각을 진행한다(KOH or HNO3/HF등).
ⅲ) 초 평탄 경면(무손상)을 형성하고 웨이퍼 두께를 최종 목표치에 맞추기 위해 슬러리(Slurry)를 이용한 CMP(Chemical Mechanical Polishing)를 행한다.
⑥ 검사 공정(Wafer inspection)
검사 공정(Wafer inspection)을 통해 양품과 불량품을 선별한다.
3 진공 기술
대부분의 반도체 공정은 앞으로 서술할 플라즈마(Plasma)를 이용한다. 반도체 공정 과정에서 플라즈마는 저압의 진공 챔버(Chamber) 내에서 생성되며, 진공도에 따라 공정 결과에 많은 차이가 발생하므로 이러한 진공 기술에 대한 기본적인 내용을 이해하는 것은 매우 중요하다. 본 절에서는 진공의 정의, 기체의 특성 및 진공 상태를 만드는 기계적 시스템 등에 대해 학습하도록 한다.
(1) 진공 기초
① 진공의 정의
사전적 의미로서의 진공(Vacuum, 眞空)은 ‘인위적으로 만들 수 없는, 물질이 전혀 존재하지 않는 공간’으로 정의되나, 반도체 공정에서의 진공이란 ‘어떤 밀폐된 공간(Chamber, 챔버) 내의 압력이 대기압보다 낮은 상태’를 말한다. 여기서 압력이란 공기 분자들이 밀폐 용기의 벽면에 부딪혀 생기는 단위 면적당 힘(N/m2)으로 정의되므로 압력이 낮다는 것은 용기 내의 공기 분자 수가 대기압 대비 상대적으로 적다는 의미이다. 이렇게 챔버 내의 공기 분자 수를 줄여 저압 상태로 만들기 위해 챔버 내의 공기를 외부로 강제 배기시키는 장치를 진공 펌프(Pump)라 한다.
② 진공의 필요성
진공이 필요한 이유는 ⅰ) 반응 가스 외에 반도체 공정에 불필요한 오염원이나 가스에 의한 챔버 및 웨이퍼의 오염, 부식, 산화를 방지하고, ⅱ) 가스 분자 간의 잦은 충돌을 막아 평균 자유 이동 거리(Mean Free Path, MFP)1를 증가시켜 ⅲ) 플라즈마를 효율적으로 발생시키고 유지되게 하기 위함이다.
평균 자유 이동 거리(Mean Free Path, λ)1: 기체 분자가 다른 입자와 충돌하지 않고 움직이는 평균적인 거리
③ 진공의 단위
1643년 이탈리아의 수학자이자 물리학자인 에반젤리스타 토리첼리(Evangelista Torricelli)는 [그림 1-9]와 같이 유리관에 수은을 가득 채운 뒤 수은이 담긴 통 안에 거꾸로 뒤집어 세우는 실험을 했고, 유리관 위쪽에 진공이 생기는 것을 발견하였다.2 실험 결과 수은 기둥의 높이는 항상 일정하게 760mm가 나왔다. 토리첼리는 이 현상이 수은 기둥의 무게와 대기에서 공기가 누르는 힘이 균형을 이루기 때문에 발생했다고 설명하였다. 지표면에서의 대기압은 1기압이고, 이 값을 토리첼리의 수은 기둥으로 나타내면 약 76cm(760mm)가 되므로 1기압을 760mmHg라 하고, 토리첼리의 이름을 따 760Torr라고 정하였다. 진공 상태의 단위는 압력의 단위와 같고, 반도체 공정에서는 주로 Torr와 국제 표준 단위(SI)인 파스칼(Pa, N/m2)이 많이 사용된다. [표 1-1]에 각 압력 단위의 상관 관계를 나타내었다.
‘토리첼리의 진공’이라 하며, 엄밀하게는 기화된 수은과 수증기 등이 약간 들어 있는 상태임.2
표 1-1 압력의 단위 환산표
단위 | Torr (mmHg) | Pascal (N/m2) | Bar | atm | Psi (a) |
1atm | 760 | 101,325 | 1.01325 | 1 | 14.696 |
1Torr | 1 | 133.32 | 1.33 × 10-3 | 1.32 × 10-3 | 19.34 × 10-3 |
1Pa | 7.50 × 10-3 | 1 | 10-5 | 9.87 × 10-6 | 145 × 10-6 |
1bar | 750.06 | 100,000 | 1 | 0.98692 | 14.504 |
1psi(a) | 51.715 | 6,894.76 | 68.95 × 10-3 | 68.05 × 10-3 | 1 |
④ 진공의 분류
진공의 정도는 다양하게 구분되나 [표 1-2]와 같이 일반적으로 저 진공, 고 진공, 초 고진공의 3단계로 단순하게 분류한다.
표 1-2 진공의 분류
구분 | 저 진공 | 고 진공 | 초 고진공 |
정의 | |||
입력범위 | 760~10-3Torr | 10-3~10-8Torr | < 10-8Torr |
펌프 | 저 진공(러핑) 펌프 | 고 진공(High Vacuum, HV) 펌프 | 초 고진공(Ultra HV, UHV) 펌프 |
단독 사용 | 러핑 + HV 펌프 | 러핑 + HV + UHV 펌프 | |
적용 예 | 박막 증착 공정 | 이온 주입, 진공 증착 공정 | 표면 분석(AES, XPS 등) |
ⅰ) 저 진공(Low vacuum)
760(1기압)~10-3Torr의 영역대로, 이러한 상태를 만들기 위해 사용되는 펌프를 저 진공 펌프 또는 러핑(Roughing) 펌프라 한다. 주로 반도체 공정 중 박막 증착 공정에 사용되는 영역대이다.
ⅱ) 고 진공(High vacuum)
10-3~10-8Torr의 영역대로, 이러한 상태를 만들기 위해서는 고 진공 펌프 단독으로는 불가하고, 저 진공 펌프인 러핑 펌프와 함께 사용해야 한다. 주로 이온 주입(Ion implantation), 진공 증착(Evaporation) 공정에 사용되는 영역대이다.
ⅲ) 초 고진공(Ultra High Vacuum)
< 10-8Torr의 영역대로, 고 진공의 경우와 같이 초 고진공 펌프 단독으로는 불가하고, 고 진공 및 러핑 펌프와 함께 사용해야 한다. 반도체 공정보다는 주로 AES(Auger Electron Spectroscopy), XPS(X-ray Photoelectron Spectroscopy)와 같은 표면 분석 장비에 사용되는 영역대이다.
(2) 기체의 특성 및 흐름
① 기체의 기본 특성
진공을 이해하기 위해서는 기체의 기본적인 특성에 대한 학습이 필요하다. 기체 분자 수가 매우 적은 진공에서는 기체가 거의 이상기체와 유사하게 움직이므로 이상기체의 특성에 대한 이해가 필요하다. 다음은 이상기체의 특성을 나타낸 것이다.
기체 분자는 끝없이 충돌하면서 무작위 직선 운동을 함.
기체 분자 사이의 충돌과정에서 운동 에너지의 손실은 없음(완전 탄성 충돌).
분자 간 거리가 멀어 기체 분자 자체의 부피는 무시 가능
기체 분자 사이의 인력, 반발력 등 상호 작용 무시 가능
평균 운동 에너지(Ek) = 3/2kBT = 1/2mv-2
(kB: 볼츠만 상수, 1.38 × 10-23J/K, T: 절대온도, v¯: 평균 속도)
이때, 동일한 온도에서 모든 기체의 평균 운동 에너지는 같음.
ⅰ) 기체 분자의 속력 분포([그림 1-10] 참조)
기체 분자는 탄성 충돌을 통해 에너지를 교환함으로써 속도가 변화한다. 기체 분자는 0 이상의 속도를 가질 수 있으나 모두 동일한 속도는 가질 수 없으며 맥스웰-볼츠만(MaxwellBoltzmann) 속력 분포를 따른다.
ⅱ) 기체 분자의 속도([그림 1-11] 참조)
기체 분자의 속도는 절대온도가 증가하고 분자의 질량이 감소함에 따라 증가하고(
ⅲ) 충돌 단면적(Collision cross-section, σ) ([그림 1-12] 참조)
두 입자 간의 충돌 시 충돌하는 면적으로, 충돌 확률과 관계되며 충돌 단면적은 두 원자의 반지름의 합을 반경으로 하는 원의 면적(
ⅳ) 평균 자유 이동 거리(Mean Free Path, MFP, λ) ([그림 1-13] 참조)
기체 분자가 다른 기체 분자와 충돌하지 않고 움직이는 평균적인 거리를 말하며, 기체의 밀도 및 충돌 단면적에 반비례한다.
(n: 기체의 밀도, σ: 충돌 단면적)
압력이 감소하면 기체 밀도가 낮아져 MFP는 증가하고, 기체 분자는 직진성을 갖게 된다. 플라즈마에 사용되는 Ar+의 경우,
② 기체의 흐름
▣ 기체의 유동
챔버 내에서의 기체의 유동은 크게 점성 유동(Viscous flow)와 분자 유동(Molecular flow)으로 분류된다.
ⅰ) 점성 유동(Viscous flow) ([그림 1-14(a)] 참조)
챔버 내의 기체 분자 수가 많은 고압 상태에서의 기체 유동을 말하며 기체 분자 간 충돌에 의한 내부 마찰 발생으로 시냇물과 같은 Stream 형태로 이동하는 유동이다. 따라서 펌핑(Pumping) 시 챔버와 펌프를 연결하는 파이프의 직경이 작거나 펌프와 챔버 간의 거리가 멀어도 유동에 문제가 없다.
ⅱ) 분자 유동(Molecular flow) ([그림 1-14(b)] 참조)
기체 분자 수가 적은 저압 상태에서의 유동을 말한다. 긴 기체 분자의 MFP로 인해 챔버 벽과의 충돌 외에는 분자들 간의 상호 작용이 없어 펌핑(Pumping) 시 점성 유동과 같이 쉽게 기체 분자가 유동하지 않으므로 챔버와 펌프를 연결하는 파이프의 직경이 커야 하고 펌프와 챔버 간의 거리도 가까워야 한다.
▣유량의 정의
반도체 공정이 진행되는 진공 설비를 간략하게 표현하면 [그림 1-15(a)]와 같고, 시간에 따른 챔버 내 압력 변화를 [그림 1-15(b)]에 나타내었다.
우선, 가스 유입부에 연결된 밸브(Valve)를 닫아 공정에 필요한 반응 가스를 흘리기 전에, 챔버 내 불필요한 가스나 오염원을 제거하기 위해 펌프의 최대 성능까지 배기시켜 챔버 내의 압력을 최저 압력(Base pressure)까지 낮춘다. 일정 시간 후 밸브를 열어 반응 가스를 유입시키면 챔버 내의 압력은 증가하게 된다. 이때 유입되는 반응 가스의 유입량과 배기 가스의 유출량이 균형을 이루면, 챔버 내의 압력은 공정 압력(Process pressure)으로 일정하게 유지되면서 안정적으로 공정이 진행된다. 따라서 공정 압력을 정확히 제어하기 위해서는 유입되는 가스 및 배기되는 가스의 유량을 정량적으로 표현할 필요가 있고, 이를 펌프, 챔버 및 MFC(Mass Flow Controller)3 입장에서 각각 정의할 수 있다.
MFC(Mass Flow Controller)3: 공정 중 사용되는 반응 가스의 유량을 정확하게 제어하는 장치
ⅰ) 배기속도(Pumping speed(S)) - 펌프 입장
펌프의 기체 방출 능력을 의미하며, 단위 시간당 흐르는 기체의 부피를 말한다. 단위는 [L/sec]이다.
ⅱ) 배기량(Throughput(Q = PS)) - 챔버 입장
[그림 1-16(a)]의 물 펌프의 경우, 유량은 단위 시간당 배출된 물의 체적으로 배출량을 표시할 수 있으나 [그림 1-16(b)]의 진공 펌프의 경우는 배기되더라도 나머지 기체가 공간을 채워 버려 이동한 체적으로 배기량을 표시할 수 없고 체적 변화 없이 밀도만 감소하게 된다. 즉, 용기 내의 압력이 변화하므로 배출된 기체 유량은 체적으로만 표시할 수 없고 배기속도에 압력을 곱해 정량화시켜야 하는데, 이를 배기량(Throughput, Q)이라 한다. 단위는 [Torr·L/sec]를 사용한다.
ⅲ) 가스 유량(Gas flow) - MFC 입장
단위 시간당 흐르는 반응 가스의 양으로, MFC(Mass Flow Controller) 등으로 제어한다. 가스 유량의 단위는 유입되는 가스의 양에 따라 SCCM(Standard Cubic Centimeter per Minute)또는 SLPM(Standard Liter per Minute)을 사용한다. 여기서 ‘Standard’란 0℃, 1기압 상태를 의미하는데, 반응 가스는 진공 상태가 아닌 대기압 상태에서 유입되기 때문이다. 따라서 유입되는 가스량과 배기량(Q) 간의 균형을 제어하기 위해서는 이들 간의 관계를 알아야 한다. 1[Torr·L/sec]≅80sccm인데, 이는 1[Torr·L/sec] × (1/760)[atm/Torr] × 1,000[cc/L] × 60[sec/min]로부터 계산된 값이다.
▣기체 잔류시간(Gas residence Time, τ)
챔버 내로 들어온 가스가 배기되기까지 챔버 내에 머무르는 평균 시간을 말하며 다음과 같은 식으로 표현할 수 있다([그림 1-17] 참조).
(V: 체적, P: 압력, S: 배기속도, Q: 배기량)
압력이 일정할 때, 유량과 잔류시간(τ)은 반비례 관계에 있다. 잔류시간이 너무 길면 반응 가스가 부족하게 되고, 반응 부산물의 재반응이 일어날 수 있다. 반대로, 잔류시간이 너무 짧으면 기판과의 반응성이 저하되어 반응 속도가 감소할 수 있다.
▣컨덕턴스(Conductance, C)
챔버와 펌프 사이에 있는 연결 파이프의 형상 및 크기에 따른 기체 유동에 대한 저항으로 인해, 펌프와 챔버에서 느끼는 배기속도 차이를 컨덕턴스라 한다. 진공 시스템 내에서 연결관이 가스를 이동시키는 능력, 즉 챔버 입구 및 파이프가 단위 시간 동안 통과시키는 기체의 부피를 말한다. 따라서 컨덕턴스의 단위 또한 배기속도와 같은 [L/sec]이다([그림 1-18] 참조).
직렬 컨덕턴스의 경우, 전체 컨덕턴스는 컨덕턴스가 낮은 부품의 직렬 연결에 의해 결정되고, 병렬 컨덕턴스의 경우는 각 컨덕턴스를 합해 전체 컨덕턴스를 구한다. 이는 앞서 설명한 분자 유동에서 중요한 파라미터이다(넓은 입구, 짧은 길이, 직선화).
(3) 진공 시스템
① 진공 펌프
▣진공 펌프의 분류
진공 펌프는 [표 1-3]과 같이, 동작 원리에 따라 압축 배출식 펌프(Gas transfer vacuum pump)와 가스 포집식 펌프(Entrapment vacuum pump)로 분류할 수 있다. 압축 배출식 펌프는 챔버 내 기체(분자)를 압축하여 고압으로 만들어 배출시키는 방식이며, 가스 포집식 펌프는 기체 분자의 응결 및 흡착을 통해 펌프 내에 기체 분자를 가두어 놓는 방법이다. [그림 1-19]와 같이, 앞서 설명한 진공도에 따라 저 진공, 고 진공, 초 고진공 펌프로 분류할 수 있는데, 압축 배출식 펌프는 다시, 저 진공(점성 유동)에서 부피를 변화시켜 압력을 조절하는(V ∝ 1/P) 용적 이송식과 고 진공(분자 유동)에서 분자 자체에 운동량을 전달, 압축하여 배기시키는 운동량 전달식 펌프로 나눌 수 있다. 대표적인 용적 이송식 펌프로는 로터리 베인(Rotary vane) 및 루츠(Roots) 펌프가 있으며, 운동량 전달식 펌프로는 터보 분자 펌프(Tubo Molecular Pump, TMP)가 대표적이다. 가스 포집식 펌프는 극저온에서 가스 분자를 응결시켜 고 진공을 만드는 크라이오(Cryo) 펌프가 반도체 공정에서 주로 사용된다.
표 1-3 동작 원리에 따른 진공 펌프 분류
작동 방식 | 펌프 종류 | 적용 | ||
대분류 | 중분류 | 소분류 | 로터리 피스톤(Rotary Piston) pump 다이아프램(Diaphragm) pump | 저 진공 |
압축 배출식 | 용적 이송식 *점성 유동 | 왕복 운동 | 로터리 베인(Rotary vane) 펌프 루츠(Roots) 펌프 스크류(Screw) pump | |
운동량 전달식 *분자 유동 | 유체 분사 | 벤추리(Venturi) 펌프 | 고 진공 | |
확산(Diffusion) 펌프 | ||||
분자 펌프 | 터보 분자(Turbo Molecular) 펌프 | |||
가스 포집식 | 응축식 | 저온 응결 | 크라이오(Cryo) 펌프 | 초 고진공 |
흡착식 | 화학 흡착 | Sputter ion pump Ti 승화(Sublimation) 펌프 | ||
▣저 진공 펌프(Roughing Pump)
저 진공 펌프는 저 진공을 만드는 펌프지만, 터보 분자 펌프나 크라이오 펌프와 같은 고 진공 펌프와 함께 고 진공을 형성하는 1차 펌프의 역할을 한다.
ⅰ) 로터리 베인(Rotary vane) 펌프
펌프의 구조는 [그림 1-20]과 같이 케이스(Case)에 해당되는 고정자(Stator)와 고속으로 회전하는 회전자(Rotor), 회전자에 부착된 날개(Vane), 흡입구 및 배기구 등으로 구성되어 있다. 회전자의 중심은 고정자에 의해 만들어진 원통형의 빈 공간인 실린더(Cylinder)의 중심과는 일치하지 않고 편심(Eccentric)되어 있어 실린더와 회전자 사이 공간의 용적은 회전자가 회전함에 따라 계속 변하도록 되어 있다. 날개는 스프링에 의해 실린더 내벽으로 밀려 계속 변화하는 ‘회전자와 실린더 사이의 공간’을 밀봉(Sealing)해 주는 역할을 한다. 그러나 이러한 기계적인 밀봉은 기체가 새어 나갈 수 있으므로 틈새에 오일을 채워 틈을 막아준다. 이로써 오일은 밀봉 역할과 동시에, 윤활 및 마찰열의 냉각 역할을 한다. 오일은 오일 저장소에서 펌프 내부로 순환되고 압축된 기체 분자와 함께 배출 밸브를 통해 배기된다.
로터리 베인 펌프의 구동은 [그림 1-21]과 같이 ‘흡입 - 차단 - 압축 - 배기’의 총 4단계가 반복된다. 흡입 단계에서는 회전자와 실린더 사이 공간의 용적이 증가하여 압력이 낮아지므로 기체 분자가 챔버로 흡입되고, 차단 단계에서는 회전자의 날개가 흡입구를 차단하여 실린더 안의 기체를 고립시킨다. 압축 단계에서는 회전자와 실린더 사이 공간의 용적이 감소하여 기체 분자가 압축된다. 배기 단계에서는 기체 분자의 압력이 높아져 배기 밸브를 강제로 열며 상대적으로 압력이 낮은 외부(대기)로 기체가 배기된다.
ⅱ) 루츠(Roots) 펌프
루츠 펌프(Roots pump)는 [그림 1-22]와 같이 두 개 또는 세 개의 회전자가 반대로 회전하면서 ‘흡입 - 압축 - 배기’의 과정이 동시에 이루어진다. 이 펌프의 장점은 오일을 사용하지 않는 건식 펌프이므로 오일의 역류로 인해 진공 챔버가 오염될 가능성이 없어, 고순도를 필요로 하는 반도체 공정에서 많이 사용된다는 점이다. 그러나 사용 중 과도한 열이 발생하여 회전자에 열변형이 발생하거나 축이 휘는 경우, 회전자 간의 충돌로 인한 고장 가능성이 있고, 회전자와 회전자 사이, 회전자와 실린더 벽 사이의 공간이 많아 기체가 역으로 빠져나갈 수 있어 한 번에 진공을 잡기 어렵다는 단점이 있다. 따라서 두 개 이상의 루츠 펌프를 직렬로 연결하거나 로터리 베인 펌프와 함께 사용하기도 한다.
▣고 진공 펌프(High vacuum pump)
ⅰ) 터보 분자 펌프(Turbo Molecular Pump, TMP)
TMP는 챔버 내의 공기 분자 수가 적은 분자 유동(Molecular flow)에 의한 배기로, 각각의 공기 분자에 운동량을 전달하여 배기시키는 원리이다. 펌프의 구조는 [그림 1-23]과 같이 고속 모터의 중심축에 일정한 간격을 따라 회전자(Rotor)와 고정자(Stator)가 교대로 장착되어 있고, 각각의 회전자와 고정자 디스크에는 매우 얇은 날개(Blade)가 촘촘히 부착되어 있다.
날개는 경사지게 설치되어, 기체 분자의 운동에 일정한 방향성을 부여하여 아래쪽으로 기체를 배출시키도록 설계되어 있고, 흡입된 기체 분자의 역류를 방지하기 위해 회전자와 고정자의 날개는 서로 엇갈려 장착되어 있다. 회전자는 보통 20,000~80,000rpm 정도의 고속으로 회전하는데, 이는 회전 속도가 기체 분자의 평균 운동 속도보다 빨라야만 기체 분자에 운동량을 전달할 수 있기 때문이다. 이때 기체 분자가 흡기구를 통해 유입되면, 디스크에 장착된 날개에 충돌하게 되고, 날개의 각도에 의해 아래쪽으로 방향이 꺾이면서 다시 충돌하여 순차적으로 배기구 쪽으로 이동하게 된다. 흡기구 쪽은 가능한 많은 양의 기체를 펌프 안으로 끌어들이기 위해서 날개 각도를 약 30°~40° 정도의 큰 각도로 만들고, 배기구 쪽으로 갈수록 각도를 약 10°~20° 정도로 줄여, 기체 분자가 잘 빠져 나가지 못하고 축적되게 하여 아래로 갈수록 압력이 높아지게 설계되어 있다. 즉, 흡기구와 배기구 간의 압력 차이를 비율로 나타낸 ‘기체의 압축비’를 높이게 되어 있는 구조이다(흡기구 쪽 압력을 P1, 배기구 쪽 압력을 P2라 하면 압축비는 P2/P1이 된다). 압축비는 펌프의 배기능력을 나타내며, 수치가 높을수록 퍼져 있는 기체를 빠른 시간 내에 펌프로 모아 배기구 쪽으로 이동시킬 수 있다는 의미이다.
TMP는 로터리 베인 펌프 등의 1차 펌프로 저 진공을 만든 이후 2차 펌프로 사용되는데, 반드시 1차 펌프로 필요한 진공도까지 먼저 배기한 후 사용해야 한다. 만약 1차 펌프로 충분히 낮은 진공이 만들어지지 않은 상태에서 터보 펌프 쪽 밸브를 열게 되면, 순간적인 압력 차이로 터보 펌프의 날개 부분이 충격을 받을 수 있고 작은 이물질들이 고속으로 회전하는 날개에 충돌하거나 정밀 부품들 사이에 침투하여 손상을 입힐 수 있다. 한편, TMP의 단점으로는 수소나 헬륨과 같이 가벼운 기체는 평균 운동속도가 너무 빨라 압축비가 낮으므로 제거하기 어렵다는 점이다.
ⅱ) 크라이오(Cryo) 펌프
크라이오 펌프는 극저온에서 증기압이 낮은 기체를 액화시킨 다음 얼리는 냉온응축(Cryocondensation)과, 극저온에서도 증기압이 높아서 액화되지 않는 기체들의 운동 에너지를 빼앗아 표면에서 움직이지 못하게 하는 냉온흡착(Cryo-sorption)의 2가지 원리를 사용하여 고 진공을 만드는 펌프이다. 즉, [그림 1-24]의 20K 이하에서 증기압이 N2보다 낮으면 기체의 증기압력은 10-8Pa 이하로 떨어지므로 그래프상 N2 우측편에 위치한 기체들은 모두 응축시킬 수 있으나, 좌측에 있는 H2, He, Ne과 같은 가벼운 기체는 20K에서 응축되지 않으므로, 흡착을 통해 기체 분자를 제거하게 된다.
크라이오 펌프는 [그림 1-25]와 같이 펌프 내부를 극저온으로 만들어 주는 2단의 냉동기(Cold head), 외부와 연결되는 부분에 설치하여 펌프의 온도를 유지시키는 일종의 차단막인 배플(Baffle), 그리고 펌프 내부에서 응축되지 않는 기체들을 흡착하는 역할을 하는 활성탄(Activated charcoal) 등으로 구성된다. 크라이오 펌프는 극저온을 만들기 위해 액체 헬륨(He)을 냉매로 사용하는데, 높은 압력의 액체 헬륨을 냉동기에서 단열 팽창시키게 되면 헬륨의 기화로 인해 주변의 열을 빼앗으면서 극저온이 형성된다. 80K 쉴드와 배플이 연결된 냉동기 1단은 냉동 용량이 크지만 80K 범위까지만 도달하며, 15K 패널이 연결된 냉동기 2단의 경우 냉동 용량은 작지만 15K까지 냉각되어 극저온 냉각이 가능하다. 따라서 [그림 1-24]를 토대로 했을 때, 80K 쉴드와 배플에서는 주로 챔버 내 수증기(H2O)를, 15K 패널에서는 Ar, N2, O2 등을 응축시킬 수 있다. 저온에서도 증기압이 높아 얼리기 어려운 H2, He, Ne과 같은 가벼운 기체는 냉온흡착(Cryo-sorption) 방식으로 진공을 만든다. 이 기체들은 15K 패널 하부에 연결되어 20K 이하로 냉각된 다공성의 활성탄 내 작은 방(Cryo-array)으로 들어가 운동량이 감소, 활성탄에 흡착하게 됨으로써 고 진공을 만든다. 크라이오 펌프의 단점은 응축과 흡착에 의해 15K패널 안에 기체를 보관하므로 정기적으로 펌프 온도를 올려 기체를 배출할 필요가 있다는 것이며, 이 과정을 재생(Regeneration)이라 한다. 따라서 크라이오 펌프 또한 TMP와 같이 충분한 저압 상태에서 사용하지 않으면 많은 기체 분자들이 응축 및 흡착됨으로써 재생 주기가 짧아져 설비 가동율이 저하될 수 있다. 또한 활성탄이 오염되면 흡착능력이 눈에 띄게 저하되는데, 이에 대한 관리도 필요하다.
② 진공 게이지(Gauge)
고 진공 펌프 가동, 고 진공 밸브 개방 및 고 진공 게이지 등의 동작 시점 결정, 공정 진행 시의 압력 조건 등을 확인하기 위해서는 챔버나 펌프 내부의 압력(진공) 수준을 정량적으로 측정하고 모니터링하는 것이 매우 중요하며, 이렇게 진공 상태의 압력을 측정하는 장치를 진공 게이지(Gauge)라 한다. 여기서 압력을 측정하는 것은 바로, 챔버 내 공기의 분자 밀도를 측정한다는 의미이다. 진공 펌프와 유사하게, 진공 게이지의 측정 원리 및 구조 등의 차이로 인해 저 진공부터 초 고진공까지를 동일한 방식으로 측정하는 것은 어렵고, [그림 1-26]과 같이 진공도에 따라 측정 방식이 상이하다. 반도체 공정에서는 일반적으로, 피라니(Pirani) 게이지, 정전용량 마노미터(Capacitance Manometer) 및 이온(Ion) 게이지 등을 사용한다.
ⅰ) 피라니 게이지(Pirani gauge)
필라멘트 게이지 튜브와 휘트스톤 브릿지(Wheat‑stone bridge) 회로로 구성되며, 필라멘트에 부착된 열전대(Thermocouple, T/C)로 기체 분자 운동에 의한 필라멘트 온도의 변화를 저항의 변화로 검출하는 원리이다.
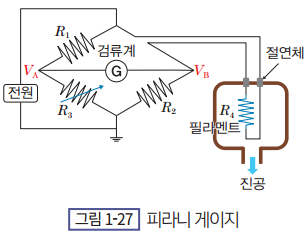
ⅱ) 정전용량 마노미터(Capacitance manometer)
격막(Diaphragm), 상대 전극, 유전체, 전기신호 출력 및 처리부로 구성되며 격막으로 나뉜 공간의 압력차에 따라 격막의 휨이 발생하고 상대 전극과의 정전용량 변화를 측정하여 압력으로 변환하는 원리이다.
ⅲ) 열 음극 이온 게이지(Hot cathode ion gauge)
음극(필라멘트), 양극 그리드(Grid), 이온 컬렉터(Collector)의 3극으로 구성되며, 가열된 필라멘트에서 전자가 발생하고 양극인 그리드로 끌려가면서 기체 분자와 충돌하여 기체 분자가 이온화된다. 이온화된 분자는 이온 컬렉터에 충돌하면서 전류를 발생시키고, 이 전류값(이온의 개수)을 압력으로 변환하는 원리로 작동하는 고 진공 게이지이다. 만약 저 진공에 사용하면 필라멘트 산화로 게이지의 손상 및 측정 오류가 발생할 수 있다 .
③ 고 진공 시스템의 구성
일반적으로 식각 및 증착 등의 반도체 공정에 사용되는 가장 기본적인 고 진공 시스템의 구성은 [그림 1-30]과 같다.
▣진공 펌프
ⅰ) 저 진공 펌프는 다음의 2가지 기능을 수행한다.
러핑(Roughing) 펌프: 챔버와 저 진공 펌프 사이의 러핑 라인(Roughing line)을 통해 챔버를 저 진공 상태로 만들어 주는 기능(~10-Torr)
배킹(Backing) 펌프: 고 진공 펌프와 저 진공 펌프 사이의 포어 라인(Fore-line)을 통해 고 진공 펌프를 보조하여 기체를 배출시키는 기능
ⅱ) 고 진공(High vacuum) 펌프: 고 진공 형성(10-3~10-8Torr)
▣진공 게이지(Vacuum(Pressure) gauge)
진공도 측정 장치로, 진공도에 따라 상이한 게이지를 사용한다.
▣진공 밸브(Vacuum valve): 챔버와 외부 환경을 개폐시키는 장치
벤트 밸브(Vent valve): 웨이퍼 장착 등을 위해 진공 챔버의 개방이 필요할 경우, 이 밸브를 열어 N2 등의 기체를 주입해 챔버 내를 대기압 상태로 만들어 개방한다.
▣플랜지 등 기밀 부품, 압력 조절기, 배플, 트랩(오일 등 액체, 열 차단) 등([그림 1-31] 참조)
④ 고 진공 시스템의 동작
[그림 1-30]과 같은 고 진공 시스템의 동작 과정은 다음과 같다.
ⅰ) 모든 밸브 닫음: 일반적으로 밸브는 닫혀 있음(Normally off).
ⅱ) 저 진공 펌프 가동: 러핑 라인 밸브와 포어 라인 밸브 전단까지 펌핑됨.
ⅲ) 러핑 라인 밸브 개방: 진공 챔버 내를 저 진공 상태로 만듦.
ⅳ) Cross-over 압력까지 대기: 고 진공 펌프(TMP)를 가동 가능한 압력까지 대기
ⅴ) 러핑 라인 밸브 닫음: 진공 챔버와 저 진공 펌프 사이 단절
ⅵ) 포어 라인 밸브 개방: TMP를 가동 가능한 수준까지 가동하여 고 진공 펌프 내 고 진공화
ⅶ) TMP 가동: TMP 적정 회전 속도까지 기다림.
ⅷ) 고 진공 밸브(게이트) 개방: 진공 챔버의 고 진공화 진행. TMP 배기단의 압력은 대기압보다 낮아 대기로의 직접 배출은 불가하며, 저 진공 펌프를 통해 배출(배킹(Backing) 펌프 기능)
ⅸ) 이온 게이지 가동: 충분한 고 진공 확보 후 고 진공 게이지 가동
4 플라즈마(Plasma)
(1) 개요
플라즈마(Plasma)는 반도체 8대 공정 중 화학적 기계적 연마(CMP) 공정을 제외한 대부분의 공정에서 사용하는 공법이므로, 이에 대한 이해가 반드시 선행되어야 한다. [그림 1-32]와 같이 가장 낮은 에너지 상태인 고체에 열에너지를 가하면, 분자 간 결합력이 약화되어 액체가 되었다가 이후 기체로 전이를 일으킨다.
계속해서 기체에 열에너지를 가하여 수천 °C가 되면, 기체 분자는 [표 1-4]와 같은 여러 반응을 거쳐 기존의 중성 원자를 포함한 전자, 이온, 활성종(Radical) 및 광자(Photon) 등의 다양한 입자로 변화하게 된다. 이러한 입자들이 모여 전기적으로 중성인 플라즈마(Plasma) 상태를 이루고, 이는 중성 기체의 전기적 성격과 근본적으로 달라 ‘제 4의 물질 상태’라고 부르기도 한다.
표 1-4 플라즈마 반응
Type | 일반 반응 | 예 |
이온화(Ionization) | e- + A → A+ + 2e- | e- + O → O+ + 2e- |
재결합(Recombination) | e- + A+ → A | e- + O+ → O |
여기(Excitation) | e- + A2 → A2* + e- | e- + O2 → O2* + e- |
탈여기(Relaxation) | A2* → A2 + hν | Ar* → Ar + hν |
해리(Dissociation) | e- + AB → A* + B* + e- | e- + CF4 → CF3* + F* + e- |
지금부터는 플라즈마 내의 다양한 반응 메커니즘에 대해 살펴보도록 하자. 먼저 [그림 1-33]과 같이 반응 가스가 주입된 진공 챔버(Chamber)에 강한 전기장을 인가하여 전압, 압력 및 전극 간 거리 등의 조건을 만족시키면, 챔버 내의 전자가 가속되어 열 전자(Hot electron)가 된다. 그리고 중성 가스는 이러한 열 전자와 충돌하여 이온화(Ionization) 반응이 일어난다. 여기서 챔버 내의 전자는 자외선(UV photon), 우주선(Cosmic ray) 또는 음극에서 방출된 전자들이다. 이온화 과정에서 이탈한 전자와 이온화 과정에 참여했던 전자는 다시 중성 기체와 충돌하면서 연쇄적인 이온화 반응을 일으키고, 챔버 내는 계속해서 플라즈마 상태를 유지할 수 있게 된다. 한편, 전체 기체 원자 수 대비 이온화된 입자 수를 의미하는 이온화율(Ionization rate)은 주로 플라즈마 내의 전자 에너지에 의해 결정되는데, 통상 반도체 공정에서 사용되는 플라즈마의 이온화율은 < ~0.001% 정도로 매우 낮은 수치이다. 이는 이온이 플라즈마 내 전자와 재결합하여 다시 중성 원자로 변화하기 때문이다.
다음은 [그림 1-34(a)]와 같은 플라즈마 내 여기, 탈여기 반응이다. 전자는 중성 원자와 충돌하면서 에너지를 전달하는데, 그 에너지가 전자를 원자로부터 완전히 이탈시켜 자유전자가 될 만큼의 에너지에 미치지 못할 경우가 있다. 이 경우에는 전자가 높은 에너지의 궤도로 옮겨가는 여기(Excitation) 반응이 발생한다. 여기된 전자는 다시 안정된 상태의 낮은 에너지 궤도로 회귀하면서, 자신이 가진 에너지를 빛 에너지(E = hν)로 내어 놓는 탈여기(Relaxation) 반응이 일어난다. 이렇게 탈여기되면서 발생하는 광자(Photon)를 이용하여, 플라즈마의 형성 여부 및 공정의 종말점(End point)을 알아낼 수 있다.
마지막은 [그림 1-34(b)]와 같이 안정 상태에 있던 분자를 반응성이 매우 강한 중성의 활성종(Radical)으로 해리(Dissociation)시키는 반응이다. 분자의 화학 결합을 분리하여 활성종을 만드는 반응의 에너지는 이온화 에너지보다는 작으며, 생성된 활성종은 반응성이 높아 주로 화학 반응에 참여하게 된다.
후술하겠지만 이들 플라즈마 입자는 공정의 방식에 따라 사용되는 입자가 상이하다. 주로 금속을 증착하는 물리 기상 증착(Physical Vapor Deposition, PVD)의 일종인 스퍼터링(Sputtering) 공정에서는 이온을 사용하고, 플라즈마 증속 화학 기상 증착(Plasma Enhanced Chemical Vapor Deposition, PECVD)에서는활성종을, 그리고 반응성 이온 식각(Reactive Ion Etching, RIE)에서는 활성종과 이온 모두를 사용한다.
(2) 플라즈마의 발생
평균 자유 이동 거리(Mean Free Path, MFP, λMFP)란 하나의 가스 원자가 진공 내의 다른 가스 원자와의 충돌 사이에 이동한 거리를 모든 원자에 대해 평균한 값, 즉 충돌 없이 이동 가능한 거리를 말한다. 이는 기체의 밀도 및 원자의 충돌 단면적에 반비례한다.
충돌 단면적(Collision cross section, σ)은 크고 딱딱한 두 입자(원자와 원자 등)가 충돌할 때의 충돌 면적을 말하지만, 우리의 관심사인 입자 크기가 매우 다른 전자와 원자의 충돌에서는 이러한 의미가 적용되지 않는다. 이때는 충돌하는 전자가 가지는 에너지에 의존하여 충돌 단면적 크기가 결정되는데, 원자 내의 전자가 핵 주위의 빈 공간에서 핵과의 정전기력에 의해 공전하고 있으므로, 전자의 충돌 단면적도 전자와 핵 간의 정전기적 반응에 의존한다고 볼 수 있는 것이다. [그림 1-36]과 같이 충돌하는 전자의 에너지가 점점 커지게 되면, 충돌하는 전자가 핵과 반응할 가능성이 증가하므로 충돌 단면적이 커지게 된다. 그러나 그 에너지가 너무 커지면 전자의 속도가 매우 빨라, 핵과의 반응 시간이 감소하므로, 오히려 충돌 단면적이 감소하는 현상을 보인다. 따라서 충돌 단면적은 이온화가 일어날 수 있는 확률이라고도 정의할 수 있는 것이다. [그림 1-36]의 붉은 색으로 표시한 아르곤(Ar)의 경우, 이온화가 일어날 수 있는 최소 에너지, 즉 원자로부터 가장 약하게 결합되어 있는 전자를 제거하는 데 드는 에너지는 15.8eV이며, ~100eV까지 증가하다 다시 감소하는 형태를 보인다. 참고로 아르곤 원자를 여기시켜 빛을 내는 데 필요한 에너지는 ~11.56eV이다.
(3) 직류 플라즈마(DC Plasma)
[그림 1-37(a)]와 같이 직류 플라즈마는 두 개의 평행 전극판 사이에 강한 전기장을 인가하여 플라즈마를 생성시킨다. 생성된 플라즈마는 주로 PVD 공정 중 금속을 증착하는 스퍼터링 공정에 사용되는데, 스퍼터링 공정 원리에 대해서는 박막 공정(Thin film) 단원에서 다루기로 하고 여기서는 플라즈마 전위(Plasma potential)와 플라즈마 쉬스(Sheath)에 대해 설명한다. 앞서 설명한 바와 같이 플라즈마는 챔버 내의 전압, 압력 및 전극 간 거리 등의 조건이 만족해야 생성될 수 있다고 했으므로, 먼저 압력(P) 및 전극 간 거리(d)의 곱(P × d)과 방전 전압(Breakdown voltage)의 관계를 알아보자. 방전 전압이란 두 전극 사이에 전압을 인가했을 때 방전이 일어나는, 즉 플라즈마가 형성되는 전압을 말한다. 수식적으로는 다음과 같이 나타낼 수 있으며, 방전 전압이 낮을수록 효율적임을 의미한다.
이러한 방전 전압의 특성을 보여 주는 커브를 파셴 커브(Paschen curve)라고 하는데, [그림 1-38]과 같이 나타낼 수 있다. 파셴 커브에 따르면, 초기에는 압력 및 전극 간 거리의 곱이 증가함에 따라 방전 전압이 감소하였지만, 최솟값에 도달한 후 다시 증가하는 모습을 보인다. 초기 반비례 영역에서 방전 전압이 높은 이유는 압력이 낮거나 전극 간의 거리가 매우 가까워짐에 따라, 충돌할 입자 수가 적어 방전이 어려워지기 때문이다. 반면 비례 영역에서는 압력이 높거나 전극 간의 거리가 멀어지면서 입자 수가 너무 많아졌고, 이에 따라 입자가 충분한 에너지를 얻기 전에 충돌이 이뤄지면서 방전이 어려워진 것이다(방전 전압이 증가하게 되었다).
[그림 1-37(a)]와 같이 진공 챔버 내 플라즈마가 형성되고 나면, 플라즈마 내 전위는 [그림 1-37(b)]와 같은 모양을 하게 된다. 그 모양은 선형적인 전위 분포를 보이는 것이 아니라, 양극(접지 전극) 대비 벌크 플라즈마의 전위가 약간 높게 형성된다. 이를 플라즈마 전위(Plasma potential, VP)라고 하며 5~15V수준이다. 플라즈마 전위는 벌크 플라즈마 내에서 이온(ni)과 전자(ne)의 농도가 동일하므로 균일한 전위 분포를 보이게 되고, 음극(Cathode)에서는 가해준 전압만큼 음의 전위가 형성된다. 따라서 음극의 전위는 가해준 전압(|VC|)에 VP를 더해준 값이 된다. 통상 스퍼터링에 사용되는 전압은 수백~수천 V 수준이다. 한편, [그림 1-37(a)] 및 [그림 1-37(c)]와 같이 양쪽 전극 근처에서는 빛을 발하지 않는 어두운 영역인 플라즈마 쉬스(Sheath)를 볼 수 있는데, 이 영역에서는 전위의 변화가 나타난다. [그림 1-37(c)]의 우측 접지(Anode) 전극 부분을 확대한 [그림 1-37(d)]를 보면, 이 영역에 있는 전자는 이온에 비해 훨씬 가벼우므로 빠른 속도(이온 대비 ~1,000배)로 양극(접지 전극)을 향해 빠져나간다. 그 결과 영역의 대부분이 양이온으로 가득 차게 되어, 양이온의 농도가 전자의 농도 대비 매우 커지게 된다. 결국 양이온은 공간 전하로 작용하여 [그림 1-37(e)]와 같이 접지 전극 대비 전위를 증가시키고, 벌크 플라즈마와 전극 간 전위차(VP)를 형성한다. 이러한 전위차는 벌크 플라즈마 내의 전자에게 있어 [그림 1-37(f)]의 전위 장벽으로 작용하기 때문에, 이 전위 장벽보다 낮은 에너지를 갖는 전자는 이 영역으로 진입할 수가 없다. 따라서 전자가 거의 없는 이 영역은 중성 원자의 여기 및 탈여기 반응이 일어날 수 없어 빛이 발하지 않는 어두운 영역(Dark space)이 되는 것이다. 이 영역을 양극 쉬스(Anode sheath)라 한다. 마찬가지로 [그림 1-37(b)]의 음극(Cathode) 쪽에서도 강한 음의 전압 인가로 인해 전자가 밀려나 양이온으로 가득 차게 되므로, 빛의 발생이 없는 다크(Dark) 영역이 생성된다. 이를 음극 쉬스(Cathode sheath)라 한다. 이 영역에 있는 양이온은 강한 전기장에 끌려 높은 에너지로 음극에 충돌하게 되고, 이러한 원리를 이용한 공정이 바로 스퍼터링(Sputtering) 공정이다.
(4) 고주파 플라즈마(RF Plasma)
앞서 살펴본 직류(DC) 플라즈마는 전극이나 공정 대상 기판 또는 스퍼터링 시의 목표물(Target)이 전도체 금속일 때는 사용 가능하지만, 이 외에 사용이 제한되는 경우도 있다. 이는 실리콘 산화막이나 질화막과 같은 부도체의 식각 또는 부도체를 스퍼터링 공정으로 진행해야 할 경우에 해당한다. [그림 1-39]와 같이 반응 가스가 주입된 진공 챔버 내에 전압을 인가하면, 그 순간 음극에는 (-)전압, 양극에는 (+)전압이 유도되어 플라즈마가 생성되고, 양쪽 전극에는 쉬스가 형성된다. 이때 음극 쪽에 있는 양이온이 가속하여 절연체 표면에 충돌하면서, 절연체 표면에 존재하던 약간의 음전하를 중화시키고 대신 양전하를 축적한다. 이 양전하는 인가해 준 (-)전압을 막아(Shielding) 양 전극 간의 전압 차이가 없어지게 되고, 결국 플라즈마가 꺼져버리는 문제가 발생한다. 따라서 플라즈마를 지속적으로 유지하기 위해서는 절연체 표면에 축적된 양전하를 제거해 줘야 한다. 이에 대한 방법으로는, 직류(DC) 대신 교류(AC)를, 그것도 절연체 표면에 전하가 축적되는 시간보다 빠르게 극성을 바꿔 줄 수 있는 고주파(Radio Frequency, RF) 플라즈마를 사용하여 연속적으로 플라즈마 상태를 유지시키는 방법이 있다.
통상 반도체 공정에서 사용되는 RF 주파수는 13.56MHz이다. 일반적인 RF 플라즈마 회로도를 [그림 1-40(a)]에 도시하였다. RF 전원이 공급되는 한쪽 전극(Powered electrode, 전원 전극)에는 커패시터(Capacitor)가 직렬로 연결되어 있고, 다른 한쪽 전극(Grounded electrode, 접지 전극)은 접지되어 있다. 여기서 커패시터는 절연체 기판이나 목표물(Target) 또는 정전 척(Electrostatic Chuck, ESC)4을 등가5시킨 것이거나, 또는 목표물이 전도체일 경우 사용하는 직류 방지 커패시터(DC blocking capacitor)를 말한다. 이 직류 방지 커패시터가 없으면 후술할 자기 바이어스(Self-Bias)의 형성이 불가능하다.
정전 척4: 정전기를 이용하여 플라즈마 장비 내에서 웨이퍼를 고정시키는 장치
등가5: 같은 값이나 가치
[그림 1-40(b)]의 ⓐ와 같이 +Va와 -Va를 주기적으로 인가하는 구형파 RF 전원에 대해 고찰해 보자. 먼저, -Va가 커패시터의 한쪽 전극에 입력되면 용량성 결합(Capacitive coupling)6에 의해 다른 한쪽에는 -Vb 전압이 유기된다. 그럼 접지 전극과의 전압 차이로 플라즈마가 발생하게 되고, 양이온이 전원 전극 쪽으로 끌려오게 된다. 전원 전극은 커패시터에 의해 전기적으로 부유(Floating) 상태이므로 양이온의 입사에 의해 (+)로 전하가 축적되면서 점차 -Vb보다 높은 전압으로 올라가게 된다. 이때 RF 전원의 극성이 반대가 되어 +Va가 인가되면 이전의 이온 축적으로 인해 상승한 전압만큼 +Vb보다 높은 전압이 용량성 결합에 의해 부유 전극에 유도될 것이다. 이 상태가 되면 전원 전극은 양극의 역할을 하게 되어 플라즈마 내의 전자를 끌어오고, 이에 따라 전자가 축적되면서 유도된 전압보다 점차 낮아지게 된다.
용량성 결합6: 교류 형태로 커패시터의 한쪽 전극에 전압을 인가하면, 다른 한쪽 전극에도 동일한 수준의 전압이 유도되는 현상
전술한 바와 같이 이온보다 훨씬 가벼운 전자에 의한 전류는 이온에 의한 전류보다 크므로, 한 주기를 거치면서 음의 주기에서 이온의 축적으로 인해 전압이 상승하는 양보다, 양의 주기에서 전자의 축적으로 인해 감소하는 전압의 양이 더 크다. 따라서 주기를 거듭함에 따라 전원 전극의 전압은 [그림 1-40(b)]의 ⓑ와 같이 음으로 내려가게 된다. 이러한 현상은 계속 지속되지는 않는다. 이후 전원 전극이 음의 전압으로 되면서 전자의 전류가 감소하고 대신 이온의 전류가 증가하여 [그림 1-40(b)]의 ⓒ와 같이 전자의 전류와 이온의 전류가 균형을 이루게 되면, 일정한 음의 전압으로 설정되어 유지된다. 이러한 음의 전압을 직류 자기 바이어스(DC self bias)라 한다. 또한 RF 전원이 구형파가 아닌 정류파(Sinusoidal wave)7인 경우에는 [그림 1-40(c)]와 같이 한 주기 내에서 전원 전극이 (+)로 남아 있는 시간이 매우 짧아 대부분 (-) 전압이 걸리게 되고, 직류 플라즈마와 유사하게 이온이 지속적으로 충돌하는 음극의 역할을 하는 시간이 증가하게 된다.
정류파7: 파형이 삼각 함수의 사인 곡선으로 표시되는 파동
다음은 전극 면적에 따른 영향에 대해 살펴보자. [그림 1-41(a)]와 같이 RF 한 주기 내에서 좁은 면적(A1)의 전극이 음극이 되고, 넓은 면적(A2)의 전극이 양극이 되었다고 가정하면, 플라즈마 내의 전자들은 양극으로 달려가 넓은 A2 전극 표면에 고르게 퍼지게 될 것이다. 이때 RF 전원의 극성이 바뀌게 되어 A1전극이 양극이 되면 플라즈마 내의 전자들은 A1 전극에 도달하지만 면적이 너무 작기 때문에 전극 위에 전자가 축적된다. 이러한 주기가 반복되면 A1 전극에는 전자들이 넘쳐나므로 음(-)의 자기 바이어스가 높게 형성되고 결과적으로 쉬스 전압이 면적에 반비례하는 관계를 보이게 된다. 이때 양쪽 전극으로 빠져나가는 이온 전류의 밀도가 같다는 조건으로부터 다음의 수식을 유도해 낼 수 있다.
이에 따라 [그림 1-41(b)]와 같이 두 전극의 면적이 같은 경우에는 직류 자기 바이어스 전압이 형성되지 않는다. 따라서 이온에 의한 강한 충돌을 이용하는 스퍼터링이나 반응성 이온 식각과 같은 공정에서는 전극의 면적 차이를 크게 두어 면적이 작은 쪽에 이온이 충돌할 대상을 장착하는 방법을 사용한다. 하지만 [그림 1-41(c)]와 같이 면적이 다른 경우에도 대부분의 장비가 접지 전극이 매우 넓은 챔버 벽과 접지를 공유하고 있으므로, 의도적으로 면적을 작게 할 필요는 없다. 한편, 활성종(Radical)에 의한 화학 반응만이 목적인 PE-CVD나 플라즈마 식각과 같은 경우에는 [그림 1-42]와 같이 두 전극 간의 크기를 동일하게 하여 플라즈마만 생성되도록 한다.
이제 마지막으로 RF 플라즈마의 직류 플라즈마 대비 장·단점을 비교해보자. 먼저 장점으로는 절연체의 스퍼터링이나 식각이 가능하고, 금속 전극 노출 시 금속 식각에 의한 웨이퍼 오염 방지를 위해 실리카 등의 절연체에 의한 피복이 가능하다는 점이 있다. 가속된 전자가 전극 사이를 1회 지나가고 마는 직류 플라즈마와 비교했을 때, RF 플라즈마는 교류 전압의 극성에 따라 전자가 왕복 운동을 하게 되어 중성 기체와의 충돌 확률이 높아지고, 이로 인해 플라즈마 효율이 높아진다는 장점도 있다. 단점으로는 직류 플라즈마 대비 쉬스 전압을 크게 가져갈 수 없어, 스퍼터링의 경우 증착 속도가 느려진다는 점이 있다.
기출문제로 정리하기 ※기출문제를 읽고 스스로 답변해 본 후, 이와 관련된 ‘이론 페이지’의 내용을 확인하여 자신의 답안과 비교합니다. | 이론 페이지 |
최신 기출 1 반도체 공정에 대해 설명하시오. | p.233 |
최신 기출 2 웨이퍼 제조 공정 과정에 대해 설명하시오. | p.233 |
최신 기출 3 터보 분자 펌프(Turbo Molecular Pump, TMP)의 동작 원리에 대해 설명하시오. | p.250~251 |
최신 기출 4 플라즈마에 대해 설명하시오. | p.256 |
최신 기출 5 직류(DC) 플라즈마와 고주파(RF) 플라즈마의 차이에 대해 설명하시오. | p.261 |
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기