세정공정에서 건식세정과 습식세정의 장단점을 비교하여 설명하세요.
반도체 웨이퍼의 세정공정은 반도체 제조에 있어서 가장 자주 반복되는 공정이며 주로 세정능력이 뛰어난 습식세정이 주로 활용되어 왔으나, 최근에는 진공 플라즈마가 도입되면서 건식세정 방식이 빠르게 일반화되고 있다. 이는 액체 상태의 화학약품을 사용하는 습식세정방식은 공정의 편리성이나 저비용 측면에서 장점이 있으나, 미세한 회로의 세정에 다소 어려움이 있기 때문이다. 건식세정은 기술구현 측면에서 까다로운 면이 있으나 미세회로의 세정이 가능하다는 점에서 보다 효과적인 면이 있다. 특히 반도체 제조공정이 기존 미크론미터(㎛, 100만분의 1m) 공정에서 나노미터(㎚, 10억분의 1m) 공정으로 이행하면서, 나노 크기의 회로선폭을 기존 화학약품으로 세정하는데 한계점이 명확하다는 점이 건식세정의 장점을 극대화시키고 있다.
구체적으로 세정공정에서 건식 및 습식세정방식을 활용할 때의 특징을 살펴보면, 반도체나 TFT-LCD 등의 집적회로의 제조에 있어서, 폴리실리콘이나 단결정 실리콘 기판 상에 형성된 소자들을 상부 전도층 혹은 금속 배선에 연결하기 위해서는 증착 공정이나 금속 배선공정이 필요하며, 이를 위해서는 콘택 홀(반도체 배선 등을 위해 뚫는 구멍)의 생성이 필요하다. 콘택 홀은 플라즈마를 이용한 산화막 혹은 전열막의 건식 식각(Dry Etch)에 의해 일반적으로 구현된다. 그리고 콘택 홀을 형성하는 과정에서 하부의 실리콘 표면이 드러나게 된다.
건식 식각 공정이 진행되는 동안, 실리콘 표면은 플라즈마 내에 존재하는 높은 에너지를 갖는 이온(Ion)에 의한 충격 등으로 표면에 손상층(Damaged Layer)가 형성되며, 또한 식각을 위한 반응성 가스들로부터 해리된 물질과 식각된 물질들로 구성된 오염물질들이 실리콘 표면 및 측벽에 부착되게 된다. 이러한 손상층 및 오염물질은 콘택 접촉 저항(Contact Resistance)의 증가나 누설 전류(Leakage Current)의 증가 등의 원인이 되어 소자 특성을 열화시키는 치명적인 결함의 원인이 될 수 있기 때문에, 일반적으로 집적회로 제조 공정에서 세정공정을 통해 이와 같은 층들을 제거해주어야 한다. 또한 이러한 손상층 및 흡착된 불순물 이외에도 실리콘 표면에는 다음 공정을 위한 이동 시 대기 중의 산소와 반응하여 자연 산화막(Native Oxide layer)이 생성되므로, 콘택 홀 형성 이후 전도성 물질의 증착 이전에 건식세정 또는 습식세정 등의 표면 사전 처리 공정이 필요하게 된다.
하지만 기존의 화학적 표면 습식세정 과정에서 자체 생성되는 얇은 산화막 또는 절연막도 전기적 특성 열화의 원인이 된다. 실리콘 표면에 식각 후처리 공정에서 H202, H2S04, HF 및 순수한 물(DI)의 혼합용액을 사용하는데, 이때 화학적 산화막(Chemical Oxide)이 형성되기도 한다. 이렇게 형성된 산화막은 후속 공정에 영향을 주고 전기적 접촉 특성을 나쁘게 하는 등 제조된 반도체, TFT, LCD 소자의 특성을 저하시키는 원인이 된다.
최근에는 집적회로 선폭의 감소추세가 가속화됨에 따라 콘택 홀의 크기가 수 나노미터(nm) 정도로 미세화되어 있으며, 이 나노미터 크기의 홀에서 상기 여러 이유로 생성된 산화막을 포함한 절연막은 기존의 습식, 건식세정 방법으로는 제거가 용이하지 않음은 물론 기존에는 어느 정도 용납되던 아주 소량의 산화막으로도 치명적인 수율 저하를 일으킴으로 공정상 각별한 주의가 요망되고 있다. 식각 후 생성된 산화막등의 절연막을 제거하는 기존의 방법은 크게 습식 세정 방법과 플라즈마를 이용한 건식세정 2가지로 분류가 된다.
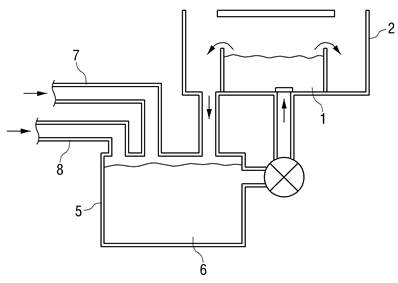
대표적인 습식세정 방식인 불산을 이용한 세정방식을 살펴보면 산화막 형성을 방지하기 위하여 실리콘 표면에 산소와 반응하는 불산 층을 형성하여 산소를 사전에 제거함으로써 자연 산화막의 형성을 방지하는 방법으로 미세한 공정변수들을 효과적으로 제어하기 어렵다는 문제가 있다. 상기한 그림의 번호들은 불산 액(1), 가열 챔버(2), 기판(3), 기판 적재부(4), 불산 용액 저장 탱크(5), 상기 탱크내의 불산 용액(6), 불산이 공급되는 유입 관(7, 8) 등을 구비한다.
아래의 그림은 플라즈마를 이용한 식각장치의 개략적인 구성도이다. 제1공정가스 유입부(9)로 H2와 N2를 유입시켜 플라즈마 발생부(10)에서 플라즈마를 발생시킨 후 제2가스 유입구(11)를 통해 NF3를 유입시키는 방법이다. 이렇게 하여 반응기(14) 내의 실리콘 기판(12)을 식각하고 배출구(13)를 통하여 가스가 배출된다. 이 방법은 NF3 가스를 공정 가스로 주로 사용하는데, 이 경우 플라즈마에 의한 해리 및 활성화가 활발하여 식각 과정에 직접 참여하는 불소 원자 및 이온의 발생이 과다하여 실리콘 표면이 손상 층을 넘어 과다 식각되거나 이 때 식각되지 말아야 할 산화막 또는 질화 막이 함께 식각되는 문제가 발생할 수 있다.
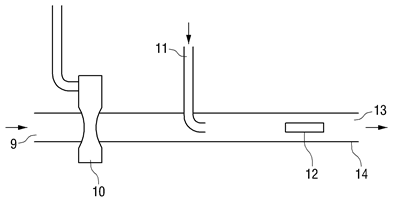
마지막으로, 아래의 그림은 마이크로웨이브 플라즈마를 이용한 건식 세정장치의 구성도이다.
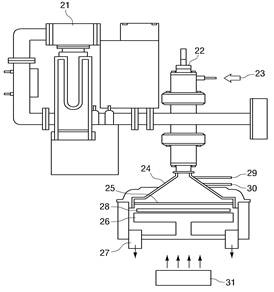
진공 챔버(24) 하단에 위치한 기판 적재부(26)에 실리콘 기판(28)를 올려놓고,N2 및 H2 가스를 제1 공정가스 유입부(23)와, 마이크로웨이브 소스 모듈(Microwave Source Module)(21)과 플라즈마 애플리케이터(22)를 가동하여 플라즈마를 발생시키고, 제2 공정가스 유입구(29)를 통해 HF가스를 유입시키도록 구성되어 있다. 이러한 과정에서 형성된 플라즈마는 기판 쪽으로 내려오는 도중에 라디칼만을 통과시키는 여과부(25)에 의해 실리콘 기판(28)에는 이온이 없는 순수 라디칼(Radical)만 내려오도록 되어 있으며, 반응기 벽면에는 적정 온도를 유지하도록 하는 히터(31)를 구비한다. 또한 컨디셔닝 가스 HF 가스를 제3 공정가스 유입 부(30)를 통해 유입한다. 컨디셔닝 가스(Conditional Gas)로는 H, F, O 또는 N를 포함하는 가스 또는 이들 가스의 혼합가스를 사용할 수 있도록 구성되어 있다.
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기