스퍼터링의 종류와 종류별 특성에 대해서 설명해 보세요.
스퍼터링에는 대체로 네 가지 종류가 있다. 첫 번째는 DC(Direct Current) 스퍼터링, 두 번째는 RF(Radio Frequency) 스퍼터링, 세 번째는 Magnetron 스퍼터링, 마지막은 Reactive 스퍼터링이다. 각각의 방식에 대한 세부적인 설명은 아래와 같다.
① DC(Direct Current) 스퍼터링
가스의 방전(Discharge)이란 용기(chamber)내에 가스를 주입한 상태에서 전류가 흐르는 것이다. 챔버의 양단(target 및 wafer)에 DC 전압을 인가하고 전압을 서서히 증가시키면, 전류가 서서히 증가하고 전압이 600 V를 넘어서는 순간 전류가 급속히 증가하여 전압이 증가하지 않아도 전류가 증가한다. Gas breakdown(Vb) 전류의 breakdown이 일어나기 전의 영역을 “Townsend discharge”라고 하는데, 10A 가량의 전류만 흐르며 Vb의 일정한 전압에서 전류가 계속 증가한다.
이 때 챔버의 양극에 가해진 전장을 따라 이동하는 전자가 챔버에 주입된 Ar 가스와 충돌하여 Ar을 양이온화시키고, 이 양이온이 타겟에 충돌하여 2차 전자를 방출시킨다. 급격히 증가하는 전자가 계속 이온을 만들어 이온이 급증(Avalanche)하는 상태를 만들고 방전이 자체적으로 유지된다. 이때, 보라색 빛을 발하는 플라즈마가 형성되고, 전압은 감소하고 전류는 급격히 증가하게 되는데 이를 “Normal Glow”라 한다. 이때 양이온의 충돌은 일정하지 않고 스퍼터링이 타겟(target)의 끝이나 돌출 부위에 집중 된다. 전원을 계속 증가시키면 스퍼터링이 타겟 전체에서 일정하게 일어나고 방전 전압 과 전류가 모두 증가하는 “Abnormal Glow”구간이 형성되는데, 이 영역이 스퍼터링에 사용하는 구간이다.
DC 스퍼터링 공법의 특징은 스퍼터링에 적용되는 글로우 방전(abnormal glow discharge)를 형성시키는 변수가 Breakdown 전압이다. 이 전압은 2차 전자의 평균 자유 행로를 결정하는 챔버내 가스 (Ar) 압력과, 음극과 양극 사이의 거리에 영향을 받는다. 만일 기체 압력이 너무 낮아서 2차 전자의 평균 자유 행로가 너무 커지거나 음극(target)과 양극(웨이퍼)사이의 거리가 너무 짧으면, 2차 전자가 Ar 원자와 충돌하여 충분한 이온을 만들기 전에 타겟에 충돌한다.
만일 반대로 압력이 너무 높거나 양극간 거리가 너무 먼 경우, Ar+ 이온이 다른 입자와 비탄성 충돌할 기회가 많아져서 속도가 느려지고 2차 전자가 감소한다. 방전 전류나 전압, Ar 압력에 따라 스퍼터링 효율이 큰 영향을 받고, 많은 금속 재료에 대해 넓은 면적의 균일한 막(target 직경의 50~60% 내외에서 ± 5% 이하) 을 얻을 수 있다. 문제점으로는 전자가 target에서 웨이퍼까지 먼 거리를 이동하며 Ar 가스를 이온화시키기 때문에, Ar 원자의 수% 정도만 이온화되는 비효율적인 방식이다.
② RF(Radio Frequency) 스퍼터링
RF 스퍼터링은 절연막에 비아(VIA) 홀을 형성한 후, Barrier Metal을 증착하기 전에 비아(VIA) 하부의 금속막 표면에 존재하는 자연 산화막을 제거해야만 비아(VIA) Rc를 낮출 수 있다. 즉, 절연막 상태의 웨이퍼 표면을 스퍼터링을 해야 한다. 그런데, 절연막 표면을 스퍼터링 하기 위해 절연막이 코팅(coating)된 웨이퍼에 음전압을 인가하면, A+의 양전하가 절연막 표면에 충전(charge-up)된다. 양전하로 충전된 웨이퍼 표면으로는 플라즈마 내의 Ar+ 이온이 지속적으로 날아올수 없다. 따라서, 양전하로 충전된 웨이퍼 표면에 전자를 공급하여 웨이퍼 표면과 플라즈마 내의 Ar+ 간의 전위차가를 높여야 스퍼터링이 계속될 수 있는데, 절연막이 존재할 경우 웨이퍼 쪽에 음전압을 가해도 절연막을 통과하여 절연막 표면으로 전자를 공급할 수 없기 때문에 스퍼터링이 중지된다. RF 스퍼터링 구조는 아래 그림과 같다.
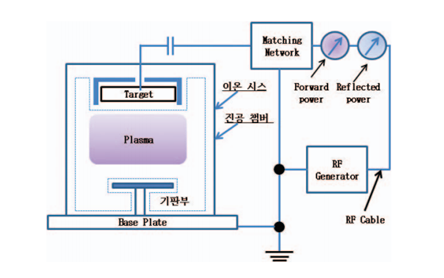
RF 스퍼터링은 웨이퍼 뒷면의 전극에 (+)와 (-) 전압을 교대로 인가하는데, 공업용 주파수인 13.56MHz를 사용한다. 이는 1초에 13,560,000번 (+)와 (-)가 교차한다. 이 고주파 전위를 웨이퍼쪽에 걸어주면, “-”주기 동안에는 Ar+를 끌려오게 하여, 웨이퍼 표면의 절연막을 스퍼터링하여 식각한다. 다음“+”주기 동안에는 플라즈마 내의 전자를 끌어와 절연막 표면에 충전된 Ar+를 중화시킨다. 따라서, 절연막 표면의 Ar+ 흡착(charge-up) 문제를 해결하면서, 절연막의 스퍼터링이 가능하다.
이 공법은 비아(VIA) 형성후, 장벽 금속막(Barrier Metal) 증착시 실시간(In-situ)으로 절연막을 식각 하는데 이용하고, 웨이퍼에 전압을 인가하는 방식을 Bias 스퍼터링이라 하므로, 일반적으로 장벽 금속막(Barrier Metal) 증착시의 절연막 식각을 RF bias sputter라고 한다.
③ Magnetron 스퍼터링
기본적인 원리와 메카니즘은 타겟(Target)에 인가된 “-”power는 타겟(Target) 면에 수직한 방향으로 전기장을 형성시킨다. 이때 타겟(Target) 면에 수평한 방향으로 자기장을 걸어주면, 전자는 타겟(Target) 표면 근처에서 나선 운동(Spiral motion)을 하게 된다. 전자가 타겟(Target) 부근에서만 운동하므로, 실제로 스퍼터링이 일어나는 타겟(Target) 표면 근처에서 Ar을 집중적으로 이온화시킬 수 있다. 또한, 전자의 나선 운동을 통해 전자가 Ar과 충돌할 확률을 크게 증가시킨다. 이와 같은 효과를 통해 스퍼터링 효율을 획기적으로 향상시킬 수 있다.
최근에는 막 두께의 균일도(uniformity), 증착율(deposition rate), 타겟 부식(target erosion)개선을 위해, 기존의 planer Magnetron 방식 대신 자장의 범위를 타겟 전면에 만들어 주는 영구 자석의 circular Magnetron 방식을 일반적으로 사용한다. 영구 자석이 타겟(Target) 주위를 회전 운동한다. Magnetron Sputtering의 기본 원리는 아래 그림과 같다.
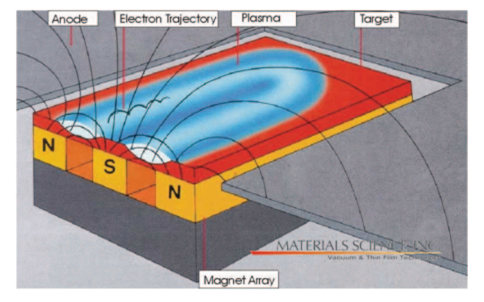
Magnetron Sputtering의 특징은 타겟 표면의 전류밀도가 기존 DC 다이오드(diode) 방식에 비해 10∼100배 향상되므로, 스퍼터 효율도 크게 개선된다는 점이다. 막 두께 균일도를 개선하기 위해, 타겟의 크기가 웨이퍼의 크기보다 크게 제작된다. 8인치(200mm) 웨이퍼의 경우, 타겟 크기는 보통 14인치를 사용한다. 현재의 스퍼터 시스템은 대부분 circular Magnetron 방식을 채택하고 있다.
스퍼터링 효율을 증진하기 위하여 이온 빔(beam)을 보조로 사용하는 마그네트론 스퍼터링 장치가 개발되고 있는데 이 스퍼터링 장치는 고가로 인해 생산현장에 많이 사용되고 있지 않지만 최근에는 마그네트론 스퍼터 장치에 부가적으로 장착하여 사용하고 있다. 또한 대면적의 타겟이 필요하여 이에 대응되는 대형 이온소스 개발도 진행 중이다. 플라즈마는 이온소스 안에서 발생하도록 구성되어 있다.
또 다른 장비 구성의 방향은 전자석의 배치를 대칭형으로 배치하지 않고 응용되는 unbalanced magnetron sputtering 방법도 있다. 이 장치의 특징은 내부 자석과 외부 자석의 자장의 세기가 다르다. 자장이 내부와 외부 사이를 벗어나 기판의 표면 쪽으로 향하는 유속이 생긴다. 이러한 자장은 전기장 방향과 가까워 자기장의 방향과 전기장의 방향이 비슷해져 전자가 자장을 따라 스프링 모양을 그리면서 나선운동을 하여 기판쪽으로 향하여 플라즈마가 음극 부근에 국한되지 않고 전체적으로 유지 가능하다. 증착 도중 이온의 충돌은 막에 있어서 nucleation behavior, morphology, composition, orientation, mechanical properties등을 변화시킨다. magnetron sputtering에서 기판에 1~500 V의 negative potential을 걸면 기판 주위의 discharge로부터 이온이 나온다. 그러나 일반적으로 막/기판 계면에 입사하는 전류밀도가 매우 낮다.
Magnetron sputtering으로 hard coating을 할 경우 내부식성, 내마모성을 최대화하기 위해 결정내의 damage를 최소화하고, 입계, 입내의 공공을 줄이고, 기판에 bias 전압을 걸어주어 기판으로의 이온 전류를 증가시킨다. bias 전압을 증가시키면 공공은 작게 되나 결함이 생기기 쉬우며, 응력 상태가 증가하여 adhesion이 나빠지고, 막의 품질이 나빠진다. 이온의 전류 밀도를 증가시키고, bias voltage를 낮게 유지하여 이온의 에너지를 낮게 유지해야 한다.
④ Reactive 스퍼터링
Reactive 스퍼터링은 타겟과 동일한 단일 성분의 금속막 대신에 TiN등의 혼합물(compound) 금속막을 형성하기 위한 방식이다. Ti 타겟을 사용하여 DC sputtering을 진행하는 챔버에 N2 가스를 주입한다. Ti 원자가 웨이퍼 표면에 도달한 후 질소(N) 가스 원자와 반응하여 TiN 막을 형성한다. N2 가스의 부분 압력에 따라 Ti와 N의 조성비(stoichiometry)가 달라지게 된다. 일반적인 N2:Ar 비율은 1:1이다. 막의 특성은 N2 부분압, 전체 가스 압력, 스퍼터링 전원, 웨이퍼 가열 온도에 영향을 받는다.
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기