이온 주입 공정
학습 포인트 |
이온 주입 공정은 원하는 전기적 특성을 갖도록 Ⅲ족 혹은 Ⅴ족 원소를 이온으로 가속하여 실리콘 웨이퍼에 주입하는 공정이다. 본 단원에서는 확산 공정과의 차이점을 비교하면서 이러한 이온 주입 공정의 원리와 장비, 그리고 다양한 문제점과 해결책에 대해 알아보자. |
개념 맵 |
이온 주입 장비를 이용해 입자를 가속시키고 실리콘 웨이퍼 내로 도펀트를 주입하는 공정을 이온 주입 공정(Ion implantation)이라 한다. 그 결과 도펀트로 도핑된 반도체는 전도성을 띠게 된다. 확산 공정 단원에서 설명했듯이, 과거의 웨이퍼 내 도펀트의 주입은 선확산 공정(Pre-deposition)을 통해 이루어졌지만, 1980년대 이후부터는 이온 주입 공정으로 대체되었다.
[표 8-1]과 같이, 확산 공정은 이온 주입 공정 대비 실리콘 웨이퍼의 손상이 적고, 일괄 처리 공정(Batch process)으로 생산성이 높다는 장점이 있다. 하지만 고온에서 공정이 진행되어, 확산 시 웨이퍼의 깊이 방향(수직 방향)만이 아닌 수평 방향으로도 확산이 일어나는 등방성(Isotropic) 확산이 일어나므로, 반도체 소자 미세화에는 부응하지 못하였다. 또 고체 용해도의 제약으로 농도와 접합 깊이의 독립적 제어가 어렵다는 단점도 있어, 이온 주입 공정에 그 자리를 내주게 된 것이다. 그에 반해 이온 주입 공정은 이온 주입 장비의 이온 가속 에너지와 이온 빔(Beam) 전류를 제어함으로써 정확한 접합 깊이(Junction depth, Xj)와 도핑량(Dose, 도즈)1을 독립적으로 제어할 수 있다. 뿐만 아니라 저온 공정 진행으로 이방성(Anisotropic)2의 이온 주입이 일어나, 소자의 미세화가 가능하다는 장점도 있다. 반면 높은 에너지의 이온 주입으로 실리콘 웨이퍼에 격자 결함 등의 손상이 생길 수 있고, 기대한 접합 깊이보다 더 깊은 곳까지 도펀트가 주입되는 채널링(Channeling) 문제, 장비가 확산 공정에 비해 고가라는 점 등의 단점이 있다. 이러한 문제에 대한 해결책은 다음 절에서 상세히 살펴보자.
도핑량(Dose, 도즈)1: 주입한 도펀트의 단위 면적당 총 개수
이방성2: 이온 주입이 웨이퍼의 깊이 방향(수직 방향)으로만 일어남.
표 8-1 확산 공정과 이온 주입 공정의 비교
구분 | 확산 공정 | 이온 주입 공정 |
구조 | ||
장점 | · 웨이퍼 손상이 적음 · 일괄처리 | · 정확한 도핑량과 깊이의 제어 · 농도와 접합 깊이의 독립적 제어 · 이방성(비등방성) |
단점 | · 고온 공정(산화막 등 하드 마스크) · 농도와 접합 깊이의 독립적 제어 불가 · 등방성 | · 이온 주입 손상 · 채널링 · 고가 장비 |
1 이온 주입 장비
이온 주입 공정은 입자를 가속시켜 실리콘 웨이퍼 내로 강제 주입하는 공정이므로, 전기장에 반응하는 (+) 전하의 양이온을 만들고 그 입자들에 강한 전기장을 인가해 가속시키는 과정이 필요하다. 이러한 과정을 수행하는 장치가 이온 주입 장비이다. 간략하게 말해, 이온을 만들어 추출하고, 추출한 이온을 가속시켜 웨이퍼에 주입하는 시스템이라고 볼 수 있다. [그림 8-1]의 모식도와 같은 ① 이온 소스부, ② 질량 분석기, ③ 가속기, ④ 중성 빔 포획 및 빔 게이트, ⑤ 이온 주사기, ⑥ 웨이퍼 챔버 등의 장치로 구성된다.
(1) 이온 소스(Ion source)부
플라즈마를 만들어 주입하고자 하는 이온을 생성하고, 이온 빔을 추출하는 역할을 하는 부분이다. 이온을 만들기 위한 반응 가스는 Ⅲ족 원소의 다이보레인(Diborane, B2H6), 삼불화붕소(Boron trifluoride, BF3) 가스 등과 Ⅴ족 원소의 포스핀(Phosphine, PH3), 아르신(Arsine, AsH3) 가스 등 다양하다.
이온 소스부에서는 [그림 8-2]와 같이 진공 챔버에 반응 가스를 주입하고 방전을 일으켜 플라즈마(Plasma)를 발생시킨다. 이때 플라즈마 내에는 중성 원자, 양이온, 전자, 라디칼 등 다양한 입자들이 생성되는데, 전압(Vextract, ~30kV)를 음으로 강하게 걸어주어 양이온들만 이 전기장에 의해 추출해낸다. 이것은 이온 전류(이온 빔)가 되고 도즈(Dose)를 결정짓는 요소이다.
(2) 질량 분석기(Mass spectrometry)
이온 소스부의 플라즈마에서 추출된 이온의 종류는 매우 다양하다(예를 들어 BF3 가스로부터 추출된 이온은 F++, B10+, B11+, F+, BF+, B10(F)2+, BF2+ 등). 여러 이온 중에서 도펀트로 사용하고자 하는 이온만을 선별해주는 장치가 바로 질량 분석기이다. 이온 빔은 v의 속도로 [그림 8-3]의 아래에서 위로 직진하고 있다가 전자석(Select magnet, 선택 자석)에 의한 자기장의 영향을 받아 방향이 꺾이게 된다. 이 현상은 로렌츠의 힘(Lorentz force)3과 관련되어 있는데, 잠깐 살펴보도록 하자.
로렌츠의 힘3: 하전 입자가 자기장 속에서 받는 힘
전자석에 의한 자기장(Magnetic field, B)은 본 서의 종이면을 뚫고 나오는 방향( )으로 작용하고, 전류의 방향(추출된 양 이온 빔의 방향과 동일)은 위쪽으로 작용한다. 이에 따라 로렌츠의 힘이 [그림 8-3]의 오른쪽으로 작용하여 구심력의 역할을 하고, 이온은 원운동을 하게 된다. 이때 [그림 8-3]의 로렌츠의 힘(
다시 본론으로 돌아와 이온 선별 과정을 마저 설명한다. 추출하려는 이온의 질량에 해당하는 자기장을 인가하면, 원하는 이온만이 적절한 운동 반경을 가져 작은 슬릿을 통과할 수 있다. 더 무거운 이온은 위쪽 벽에, 가벼운 이온은 아래쪽 벽에 부딪히므로, 결국 우리가 원하는 이온만을 선별해 낼 수 있는 것이다.
(3) 이온 가속기(Accelerator)
이온 소스부에서 걸어 준 추출 전압(Vextract)만으로는 질량 분석기에서 선별한 이온을 원하는 깊이(Xj)까지 주입하기에 아직 역부족이다. 따라서 마지막으로 더 강한 전압을 인가해 추가 가속시킬 필요가 있으며, 이렇게 직류 에너지를 증가시키는 역할을 하는 것이 [그림 8-4]의 이온 가속기(Accelerator)이다. 이온의 에너지(eV)와 전압(V) 간의 관계4에 따라 전압을 조절해 이온의 에너지를 높이는 원리이고, 예를 들어 가속기에서 150kV의 전압을 인가하면 이온은 150keV의 에너지를 갖게 된다.
eV(electron Volt)는 한 개의 전자(전하)가 1V의 전위를 거슬러 올라갈 때 드는 에너지이므로,U[eV] =-qV의 관계가 있음.4
(4) 중성 빔 포획 및 빔 게이트(Neutral beam trap and beam gate)
이온 주입 장치는 전체 시스템이 10-5~10-7Torr 정도의 고 진공으로 되어있지만, 실제로는 가속기 내부에서 이온들의 상호 또는 벽면과의 충돌 등으로 인해 중성화된 입자들이 존재한다. 이 중성 입자들은 가속기에서 에너지를 받아 강한 운동 에너지를 가지고 직진하고 있다.
후술하겠지만, 이온 빔을 웨이퍼에 고르게 주입하기 위해서는 이온 빔이 상하좌우로 움직여야 한다. 즉, [그림 8-5]의 X, Y 방향 편향 장치(Deflector)를 설치하여 이온 빔을 상하좌우로 스캐닝 함으로서, 웨이퍼 전면에 도펀트가 고르게 주입될 수 있게 하는 것이다. 그런데 중성화된 입자는 극성을 띠지 않아 편향 장치의 영향을 받지 않으므로, 그대로 뒀을 시 웨이퍼의 중앙부에만 주입되는 문제가 발생한다. 이러한 문제를 방지하기 위해, 이온 빔이 편향 장치에 도달하기 전에 중성 빔 포획(Neutral beam trap) 장치를 두어, 중성 빔만을 제거해야 한다. 이 장치에서는 전압을 걸어 이온 빔만 약간 휘도록 만들고, 그대로 직진한 중성 빔은 접지5된 콜렉터(Grounded collector)에 모아 접지 쪽으로 빠져 사라지게 한다.
접지5: 전기회로 또는 전기 장비의 한 부분을 전도체를 이용해 땅(Ground)에 연결하는 것. 접지하여 전위를 0으로 만듦.
(5) 이온 주사기(이온 빔 주입기, Ion beam scanning)
웨이퍼에 이온 빔을 고르게 주입하기 위해서는 이온 빔이 상하좌우로 주사되거나 웨이퍼가 움직여야 한다. 전자의 경우를 정전기적 주사(Electrostatic scanning) 방식이라 하고, 후자를 기계적 주사(Mechanical scanning) 방식이라 한다. 이 둘을 합쳐 이온 빔과 웨이퍼가 함께 움직여 주사하는 시스템도 있다. 먼저 [그림 8-6]의 정전기적 주사 방식은 이온 빔을 상하좌우로 주사하는 방식으로, 대체로 낮은 도즈의 이온 주입에 적합하다. 빠른 주사가 가능하고 파티클(Particle)6 발생이 적다는 장점이 있다. 단점은 이온 빔이 상하좌우로 움직일 때, 그림자 효과7에 의해 이온 주입이 되지 않는 지역이 생길 수 있다는 것인데, 이는 하드웨어적으로 해결하고 있다.
파티클6: 반도체 상의 오염물질
그림자 효과7: 이온이 비스듬하게 주입됨에 따라 구조물에 의해 주입이 방해받는 현상
이에 반하여 [그림 8-7]의 기계적 주사 방식은 이온 빔을 고정한 상태로 웨이퍼를 움직여 주사하는 방식이며, 고 에너지, 고 전류(고 도즈) 공정에 적합하다. 이 방식은 이온 빔을 효율적으로 사용할 수 있다는 장점이 있지만, 작은 처리량(Throughput)으로 인해 생산성이 떨어지고, 기계부 작동에 의한 파티클이 발생할 가능성이 높다.
(6) 웨이퍼 챔버(Wafer chamber)
마지막으로 웨이퍼 챔버는 이온 주입될 웨이퍼가 위치하는 곳이다. 이 곳에서 사용되는 웨이퍼 핸들링(Handling) 방식은 [그림 8-8]과 같이 웨이퍼 1장씩 진행되는 매엽식 주사(Single wafer scanning)방식과 여러 장의 웨이퍼를 휠 또는 디스크에 붙여 생산성을 향상시키고자 고안된 일괄 처리(Semibatch)방식으로 나눌 수 있다. 일괄 처리 방식에는 스핀 디스크 방식과 스핀 휠 방식이 있다.
웨이퍼 챔버부에는 [그림 8-9]와 같이 패러데이 컵(Faraday cup)이라는 장치가 있어, 원하는 도즈만큼 이온 주입이 완료된 후 이를 감지하여 주입을 제어할 수 있다.
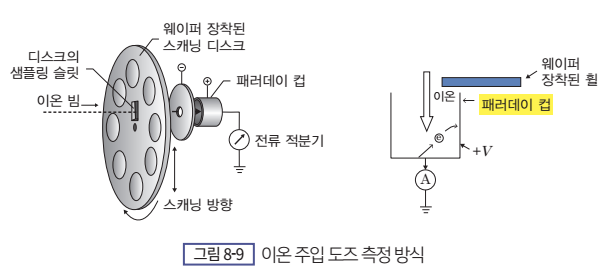
(t: 이온 주입 시간,As: 면적,I: 패러데이 컵이 측정한 전류)
2 이온 주입 공정의 응용
이온 주입 공정은 주로 저항, 다이오드 및 트랜지스터 제작에 사용되며, 일반적으로 단결정 또는 다결정 실리콘이 그 대상이다. 이온 주입 장비의 에너지에 따라 접합 깊이를 다르게 할 수 있고, 이온 빔의 전류에 따라 도즈를 결정할 수 있다.
[그림 8-10]은 용도별 이온 주입 공정의 응용을 도시한 것이다. 동일 트랜지스터에 모든 이온 주입이 행해지는 것은 아니며, 트랜지스터의 특성에 따라 취사 선택된다. 먼저, 웰(Well) 이온 주입은 CMOS 공정에서 트랜지스터의 기판이 되는 n 및 p-Well을 형성하는 공정이다. DRAM이나 낸드 플래시 소자에서 사용되는 3중 웰(Triple well) 이온 주입도 웰 이온 주입에 해당되며 접합 깊이가 가장 깊다. 다음으로는 소자 격리를 위한 채널 차단(Channel stop) 이온 주입과 문턱 전압(VTh) 조절용 이온 주입, 그리고 펀치 쓰루 방지(Punch-through stop), 후광(Halo), 저 농도 드레인(LDD) 이온 주입 등 단 채널 효과 개선을 위해 다양한 형태로 행해진다. 이 외에도 소스 및 드레인 형성을 위한 저 에너지, 고농도의 n+ 및 p+ 소스 및 드레인 이온 주입, 트랜지스터의 게이트 도핑을 위한 게이트 다결정 실리콘 이온 주입, 그리고 저항성 콘택 특성(Ohmic contact)을 위한 콘택 이온 주입 등이 있다.
이온 주입은 에너지 측면에서 봤을 때, 통상 2keV 이하를 초 저에너지(Ultra-low energy), 200keV이상을 고 에너지(High energy) 이온 주입이라 한다. 또 도즈 측면에서는 1015/cm2 이상을 고 도즈(High dose) 또는 고 전류(High current) 이온 주입이라 하고, 그 이하를 저 도즈(Low dose) 또는 중 전류(Medium current) 이온 주입이라 한다. 에너지나 도즈 및 전류의 크기가 달라짐에 따라, 이온 주입 장비의 종류가 다른 경우도 있다.
3 이온 주입 공정상의 문제
(1) 채널링(Channeling)
[그림 8-11]의 단결정 실리콘 웨이퍼와 같이 규칙적인 원자 배열일 경우, 주입되는 이온이 원자 간 빈 공간을 따라 예상한 깊이보다 더 깊이 들어가는 채널링 현상(Channeling)이 일어난다. 이는 웨이퍼의 결정 방향, 이온의 주입 입사 각도, 에너지 등에 영향을 받으며, 원하는 농도 프로파일(Dose profile)을 얻는 것을 방해한다. [그림 8-11]의 좌측 그림은 가장 많이 사용되는 [100] 방향 웨이퍼의 결정 구조와 채널링 현상을 나타낸 것이다.
이에 대한 해결책으로는 3가지 정도가 있다. 가장 간편한 방법은 [그림 8-12(a)]와 같이 웨이퍼의 방향을 약간 틀어(Twist) 이온 주입 입사 각도에 변화를 줌으로써, 원자 간 빈 공간을 최대한 줄이는 것이다. 일반적으로 [그림 8-12(b)]와 같이 웨이퍼를 Z축 방향으로 7° 기울이고(Tilt), XY 방향으로는 20° 정도 돌려(Twist) 이온을 주입한다. 일부 업체는 웨이퍼 제작 시에 웨이퍼 자체를 기울여 슬라이싱한 형태(Tilted liced wafer)로 만들어 사용하기도 한다.
두 번째는 [그림 8-13(a)]와 같이 이온 주입 전에 희생 산화막을 얇게 성장시켜, 입사되는 이온의 방향을 무작위(Random)하게 만드는 방법이다. 그리고 마지막은 [그림 8-13(b)]와 같이 실제 도펀트 이온 주입 전에 실리콘(Si) 또는 게르마늄(Ge) 등을 미리 이온 주입하여, 실리콘 표면을 비정질화시키는 선 비정질화(Pre-Amorphizing Implant, PAI) 방법이다.
(2) 그림자 효과(Shadowing effect)
[그림 8-14]와 같이 채널링 방지 혹은 후광(Halo) 이온 주입 등을 위해 경사(Tilt)지게 이온을 주입하는 경우, 포토레지스트(PR)나 게이트와 같은 구조물 때문에 이온 주입이 제대로 되지 않는 지역이 발생한다. 이 현상을 그림자 효과(Shadowing effect)라고 한다. 이 경우는 웨이퍼를 4회 회전하면서 이온 주입함으로써 해결이 가능하며, 각 이온 주입마다 도즈는
4 이온 주입 공정의 모델링
어떤 공정을 모델링하는 이유는 공정의 원리를 이해하고 영향을 주는 인자가 무엇인지를 파악함으로써, 주어진 인자를 통한 공정 결과의 예측이 가능하기 때문이다.
(1) 이온 주입 공정의 주요 용어
여기서는 이온 주입 공정의 몇 가지 중요한 용어에 대해 설명한다. [그림 8-15]와 같이, 이온 빔 형태로 실리콘에 주입된 도펀트 입자는 실리콘 격자와 충돌하면서 실리콘 내부를 무작위(Random)하게 이동하다가 가지고 있는 운동 에너지를 다 잃으면 일정 지점에서 정지하게 된다.
[그림 8-16]에 나타낸 바와 같이, 주입된 이온이 이동한 평균 거리를 투영 거리(Range, R)라 하고, 웨이퍼 표면에서 도펀트가 수직으로 이동한 거리(최대 농도를 가지는 지점)를 투사 거리(Projection range, RP)라 한다. 이온 주입에 의해 실리콘 내로 주입된 도펀트는 무작위(Random)하게 움직이므로 가우스(Gaussian) 분포8를 따르고, 이에 따라 투사 거리(RP)에 대한 표준 편차(σ)에 해당하는 거리를 ΔRP로 정의한다. 따라서 RP ± ΔRP를 알면 이온 주입 후의 대강의 도핑 형상(Profile, 프로파일)을 정의할 수 있다.
가우스 분포8: 주입된 도펀트의 분포가 정규분포 형태를 가지는 것
(2) 이온 주입 공정의 모델링
이온 주입에 의해 실리콘 내로 주입된 도펀트는 가우스 분포를 가지므로, 다음 식과 같이 실리콘 내 도펀트 농도를 표현할 수 있다.
여기서 잠깐 도펀트의 도즈(Dose) 개념에 대해 알아 볼 필요가 있다. [그림 8-17]을 보면 농도는 특정 위치의 단위 체적에 들어 있는 입자의 수[1/cm3]로 정의되는 반면, 도즈는 표면에 일정 단위 면적을 정의하고 표면에서 깊이 방향으로 끝(∞)까지 고려했을 때 그 단위 면적 내에 들어 있는 입자의 수[cm2]의 합으로 정의된다. 따라서 도즈는 농도를 전체 깊이에 대해 적분한 값, 즉 농도 곡선(Profile)의 아래 면적에 해당한다.
단위 면적당 도펀트의 총 개수
일정 확산원(선확산)에서 도펀트의 총 개수
이에 따라 도즈(Q)를 다음 식으로 표현할 수 있으며, 최대 농도(CP)와 ΔRP의 크기에 비례함을 알 수 있다. 이 식을 통해 RP 지점에서의 최대 농도(CP)를 구할 수 있고, 농도 C(x)를 기판 농도(CB)와 같게 놓으면 접합 깊이(Xj)를 계산할 수 있다. 이를 그림으로 표현하면 [그림 8-18]과 같다. 또한 ∆RP에서의 농도는 x = RP ± ∆RP가 되는 지점이므로 e-0.5가 되어 CP의 61%가 된다.
[그림 8-19]는 도펀트 종류별 이온 주입 에너지에 따른 RP와 ΔRP를 도시한 것이다. 가벼운 붕소(B) 이온이 상대적으로 무거운 비소(As)나 안티모니(Sb)보다 훨씬 더 깊이(RP) 들어가고 넓은 농도 분포(ΔRP)를 가짐을 알 수 있다.
[그림 8-20(a)]의 시뮬레이션 결과를 보면, 붕소(B)나 안티모니(Sb) 모두 이온 주입 후 RP에 대해 비대칭적인 분포를 하고 있음을 알 수 있는데, 붕소의 경우는 앞쪽으로, 안티모니는 뒤쪽으로 농도 분포가 늘어져 있다. 이는 가벼운 붕소가 상대적으로 무거운 실리콘 원자와 부딪혀 뒤쪽으로 밀리는 백-스캐터링(Back-scattering) 현상이 일어났기 때문이다. 또 [그림 8-20(b)]를 보면, 에너지가 높아질수록 이러한 현상이 심화되어 가우스 분포와 많은 차이를 보이므로, 시뮬레이션 시 이를 고려해야 한다.
심화개념 |
(1) 이온 주입에 의한 실리콘 단결정의 손상(Damage) 실리콘 원자 간의 결합력(~20eV)보다 훨씬 큰 에너지를 가진 이온이 웨이퍼에 주입되면, 실리콘 격자 내 원자와 충돌한 후 점차적으로 에너지를 잃다가 어느 지점에서 정지하게 된다. 이로 인해 실리콘 원자들은 격자 내의 원래 자리에서 이탈하고, 결정 결함을 발생시킨다. 이러한 정지 메커니즘(Stopping mechanism)에는 [그림 8-21]과 같이 핵 정지(Nuclear stopping)와 전자 정지(Electronic topping)의 2가지가 있다. 먼저 [그림 8-21(a)]의 핵 정지는 도펀트 이온이 격자 내 실리콘 원자의 핵과 충돌하는 것으로, 양이온(도펀트)과 양전하를 띤 핵 간의 척력에 의해 산란이 일어나 결정 구조 손상이 발생한다. 이에 반해 [그림 8-21(b)]의 전자 정지는 격자 내 실리콘의 전자에 의한 인력(Drag)에 기인한 것으로, 에너지 전달이 작아 결정 구조 손상이 거의 없다. 따라서 핵 정지 및 전자 정지 메커니즘에서 이온의 이동 거리에 따른 에너지 손실률은 다음 식으로 정의할 수 있으며, 주입된 에너지 손실의 총 변화량(Total rate of energy loss, dE/dx)은 두 값을 더한 만큼이 된다.
[그림 8-22]에 나타난 바와 같이, Sn(E)는 매우 낮은 에너지에서 이온의 입사 에너지에 대해 선형적으로 증가하지만, 최고치에 도달한 후 점차적으로 감소하는 특성을 보인다. 이는 에너지가 높을수록 속도가 너무 빨라 에너지 전달이 없기 때문이다. 또 다른 특성은 이온의 질량이 클수록 동일 입사 에너지에 대해 에너지 손실률이 크다는 것이다(즉, 그래프상에서 에너지 손실률은 As > P > B이다). 한편, Se(E)는 입사 에너지에 따라 계속해서 선형적으로 증가하므로, 높은 에너지에서의 에너지 손실률은 Sn(E)보다 Se(E)가 주도적이다. 여기에서 핵 정지에 의한 이온의 에너지 변화(ΔEN)와 격자 내의 실리콘(Si) 원자를 이동시키는 데 필요한 에너지(ED) 개념을 추가로 도입해 보자. ΔEN은 수~수백 keV 정도이고, ED는 20eV 정도이다. 두 에너지의 크기를 비교하여, 다음과 같이 결정 격자 손상의 생성 여부를 알 수 있다.
이상의 고찰을 통해 결정 결함에 대한 모델링을 할 수 있다. [그림 8-23(a)]와 같이 가벼운 이온이면서 입사 에너지가 높은 경우는 상술한 바와 같이 전자 정지(Se(E))가 주도적 메커니즘이므로 주입된 표면 근처에서 결정 결함을 거의 일으키지 않지만, 깊이 들어감에 따라 이온 에너지가 감소하여 핵 정지(Sn(E))에 의해 이온이 멈추는 거리(투영 거리(R))의 끝에서 결함이 발생한다. 반면, [그림 8-23(b)]와 같이 무거운 이온은 입사 에너지가 아주 높은 경우를 제외하면, 대부분의 영역에서 핵 정지가 주도적 메커니즘이 된다. 그래서 이온 주입된 전체 영역에 걸쳐 결정 결함이 발생하고 고 농도의 경우 비정질화가 심해진다. (2) 결정 결함의 대책: 열처리(Annealing, 아닐링) 열처리는 결정 결함 제거의 목적도 있지만, 실리콘 원자를 도펀트로 치환하여 전기적으로 활성화되도록 하는 목적으로도 행해진다. 주로 고온에서 짧은 시간(> 1,000℃, 수μ~수sec) 동안 진행하는 급속 열처리(Rapid Thermal Annealing, RTA)를 사용한다. [그림 8-24(a)] 및 [그림 8-24(b)]에는 열처리 전후의 원자 배열을 도시하였다. 결정성을 회복하는 원리는 고체 상태 에피택시(Solid Phase Epitaxy, SPE) 현상에 의한 것으로, [그림 8-24(c)]의 이온 주입에 의해 손상을 입지 않은 단결정 실리콘을 씨앗층(Seed)으로 하여 비정질화되어 있는 손상층의 결정성을 회복시켜주는 원리이다. 대부분의 도펀트는 성장하는 격자에 통합되어 실리콘 원자를 치환한다. 한편 저온에서 장시간으로 열처리하는 고전적인 확산로(저온 , 장시간)에서는, [그림 8-24(c)]의 비정질/결정질 계면 너머의 꼬리 부분 결함(End of range defect)에 의해 2차 점 결함9이 만들어지고, 과도 증속 확산 현상(Transient Enhanced Diffusion, TED)을 야기할 수 있다. 이 현상은 2차 점 결함으로 인해 아주 짧은 순간 내에 도펀트 확산이 가속되는 현상을 의미한다. 1차 점 결함은 이온 주입에 의한 결함을 의미하고, 2차 점 결함은 1차 점 결함으로 인한 결함을 의미함.9 [그림 8-25(a)]와 같이 동일한 열 처리량(Thermal budget)의 D·t(확산 계수 × 시간)에 대해, 고온보다 저온에서 더 많이 확산되는 비정상적인 확산 현상을 볼 수 있다. 이 현상은 [그림 8-25(b)]와 같이 낮은 온도에서는 확산이 빨리 일어나고, 높은 온도에서는 아닐링(Annealing) 속도가 더 빠르다는 결과로도 설명이 가능하다. 과도 증속 확산 현상(TED)은 얕은 접합을 얻는 데 어려움이 있기 때문에, 이온 주입 공정의 큰 문제 중 하나이다. 본 서의 MOSFET 단원에서 역 단 채널 효과(Reverse Shot Channel Effect, RSCE)의 원인 또한 이 과도 증속 확산 현상(TED)에 기인한다는 것을 설명한 바 있다. 따라서 이러한 과도 증속 확산 현상(TED) 문제를 해결하기 위해서는 고온에서의 급속 열처리(Rapid Thermalm Annealing, RTA)가 필요하다. 6 급속 열처리(Rapid Thermal Annealing, RTA) 방식 급속 열처리 공정(Rapid Thermal Annealing)에는 다양한 방식이 있으나, [그림 8-26]과 같이 열처리 온도와 시간에 따라 3가지 정도로 분류할 수 있다. 먼저 [그림 8-26(b)]의 MLA(Melting Laser Annealing)는 엑시머 레이저(Excimer laser)10를 사용해 1,400℃ 정도의 온도와 <0.1µsec의 짧은 시간 조건에서 실리콘 표면을 순간적으로 살짝 녹이는 액체 상태 에피택시(Liquid phase epitaxy) 방식이다. 주로 LCD 업체의 OLED에 사용되고 있고, 반도체에서는 14nm 이하에 사용되는 것으로 알려져 있다. 다음 [그림 8-26(c)]의 레이저 스파이크 열처리(Laser Spike Anneal, LSA)는 1,200℃ 정도의 온도와 < 수µsec의 짧은 시간 조건에서 진행된다. 이산화탄소(CO2) 레이저를 이용해 표면의 수nm 내에 에너지를 전달하고, 65~14nm 제품에 적용하는 것으로 알려져 있다. 마지막으로, [그림 8-26(d)]의 RTP 방식은 가장 널리 사용되는 방식으로, 텅스텐(W) 할로겐 램프를 사용해 ~1,100℃ 정도의 온도에서 수~수십초 동안 열처리한다. 엑시머 레이저10: 여기 상태에 있는 원자와 바닥 상태에 있는 원자가 만드는 ‘엑시머’라는 여기 상태의 분자가 빛을 내어 해리 상태로 돌아가는 것을 이용한 레이저 |
기출문제로 정리하기 ※ 기출문제를 읽고 스스로 답변해 본 후, 이와 관련된 ‘이론 페이지’의 내용을 확인하여 자신의 답안과 비교합니다. | 이론 페이지 |
최신 기출 1 이온 주입 공정이 도입된 이유에 대해 설명하시오. | p.421 |
최신 기출 2 이온 주입 장비 중 질량 분석기의 원리에 대해 설명하시오. | p.423~424 |
최신 기출 3 이온 주입 공정이 어떤 공정에 적용되는지 아는 대로 말해 보시오. | p.428~429 |
최신 기출 4 채널링(Channeling) 효과의 증상과 그 해결책에 대해 설명하시오. | p.429~430 |
최신 기출 5 이온 주입 후의 열처리 공정에 대해 설명하시오. | p.437 |
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기