확산 공정
학습 포인트 |
본 단원에서 다룰 확산 공정은 Ⅲ족 또는 Ⅴ족 불순물을 실리콘 웨이퍼에 도핑하는 고전적 방법으로, 현재는 거의 사용되지 않는 방식이다. 그러나 다음 단원의 이온 주입 공정을 이해하기 위해서는 공부가 필요한 내용이며, 도핑 후의 공정 평가 방법은 이온 주입 및 박막 공정에서도 사용되는 방법이니 확실히 이해하도록 하자. |
개념 맵 |
1 개요
실리콘에 Ⅲ족(B) 또는 Ⅴ족(P, As) 원소를 주입하여 p형 또는 n형 반도체를 만드는 과정을 도핑 공정이라 한다. 실리콘에 도핑된 불순물(도펀트) 양에 따라 다수 캐리어인 전자와 정공의 농도가 달라지고, 이에 따라 반도체의 전기 전도도(Conductivity)가 변화되는 것이다. 도핑 공정은 [그림 7-1]과 같이 실리콘에 ① 도펀트를 주입시키는 공정과, 주입된 도펀트를 원하는 접합 깊이(Junction depth,Xj)까지 밀어 넣어 재분포시키는 ② 도펀트의 확산 및 재분포 공정의 2단계로 구분된다.
먼저 도펀트 주입 방식에 있어서는, 1980년대까지 고온의 확산로에서 도펀트를 실리콘 표면에 침전시키는 선확산(Pre-deposition) 공정이 사용되어 왔다. 확산로 이외에도 도펀트를 함유한 다양한 물질을 웨이퍼 표면에 증착(CVD)하거나 코팅(Sol-gel)하는 방식이 사용되었지만 1980년대 이후부터는 이온 주입(Ion implantation) 공정이 등장하여, 현재 주된 공정으로 자리잡게 되었다. 다음으로 도펀트의 확산 및 재분포 공정에서는, 기존 선확산 공정과 함께 조합되어 드라이브-인(Drive-in) 방식이 사용되었다. 이 방식은 실리콘 표면에 증착된 도펀트를 고온 확산로에서 장시간 열처리하여 원하는 깊이(Xj)까지 밀어 넣는 원리이다. 현재는 고온 조건은 동일하지만 확산 시간이 매우 짧아 열 처리량(Thermal budget)이 적은 급속 열처리(Rapid Thermal Processing, RTP) 방식으로 변화하게 되었다. 본 단원에서는 확산의 기본 원리와 다양한 문제점에 대해 설명한 후, 고전적 도핑 기술인 확산 공정에 대해 다루도록 하겠다.
2 확산의 기본 원리
확산은 농도 차이에 의해 입자들이 이동하여 평형 상태에 이르는 과정이다. 원자가 이동하기 위해서는 다음과 같은 기본 조건이 전제되어야 하며, 이러한 에너지는 주로 원자의 진동 에너지로부터 얻을 수 있다. 진동 에너지는 온도가 올라갈수록 증가하는 특성이 있다.
인접한 자리에 빈 자리가 있어야 한다.
주위 원자와의 결합력을 끊을 수 있을 만큼의 충분한 에너지가 있어야 한다.
액체, 기체와 달리 고체 내에서의 확산은 높은 에너지를 필요로 한다.
불순물이 고체 내에서 확산해 나가는 방법에는 [그림 7-2]와 같이 크게 침입(Interstitial)형과 공공(Vacancy)형의 두 가지가 있다. 먼저 침입형 확산은 원자 크기가 작거나 기판과 강한 결합을 하지 않는 입자에서 주로 일어난다. 격자 구조를 바꾸지 않고서 격자 내 원자와 원자 사이를 상대적으로 자유롭게 이동해 확산할 수 있다. 다음으로 격자 내 원자들은 어느 수준 이상의 에너지를 받으면 진동하면서 몇몇 원자 자리에 공공(빈 자리)이 생기게 되는데, 이러한 공공에 불순물이 들어가 확산하는 것을 공공형 확산이라고 한다. 침입형의 경우는 불순물이 격자와 격자 사이를 이동해 나가는 반면, 공공형의 경우는 기존 격자 내의 원자가 존재하던 자리를 치환해 들어간다고 하여 치환형(Substitutional) 확산이라고도 부른다. 반도체는 도펀트와 실리콘이 공유 결합한 후 남은 전자와 정공을 캐리어로 사용하므로, 반드시 치환형 확산이 일어나야 한다.
다음은 고체 용해도라는 개념에 대해 설명한다. 고체 용해도(Solid-solubility limits)란 어떤 도펀트가 임의의 고체 내로 녹아 들어갈 때 해당 온도에서 최대로 녹아 들어갈 수 있는 정도를 말하며, 이는 도펀트의 종류에 따라 다르고, 온도에는 비례하는 특성을 보인다. 확산 공정의 1단계인 선확산(Predeposition)공정에서는 도펀트 주입 후 실리콘(Si) 표면의 농도가 해당 온도에서의 고체 용해도에 제한을 받는다. [그림 7-3]과 같이 매우 고농도에서는 도펀트들이 모두 전기적으로 활성화되지 않을 수 있다.
다음은 확산 계수 또는 상수(Diffusion coefficient, Diffusion constant, D)라는 용어에 대한 설명이다. 확산 계수는 확산 입자의 유속(Flux, F)1이 농도 기울기 ∂C/∂x에 비례한다는 Fick의 제1 법칙에서의 비례 상수로 정의된다. 따라서 확산 계수는 입자 농도 기울기에 따른 이동 용이성을 의미하며, 단위로는 [m2/sec]을 사용한다. 일반적으로 어떤 물질의 확산 계수는 실험적으로 결정되며, 격자 구조, 온도, 확산 입자 크기 등에 의존한다. 또 온도의 함수로서 아레니우스 식을 따라 온도에 지수 함수적으로 비례한다.
확산 입자의 유속(Flux)1: 단위 시간 동안 확산 방향에 수직인 단위 면적으로 확산하는 입자의 개수
(Do: 온도 무관 계수(m2/s), Ea: 확산에 필요한 활성화 에너지(J/mol, eV/atom), k: 볼츠만 상수(8.617 × 10-5eV·K-1),T: 절대온도(K))
3 확산 공정 구체 방식 및 원리
다음은 도펀트 주입을 위한 선확산 및 후확산 공정에 대해 좀 더 구체적으로 설명한다. 선확산 및 후확산 공정에서 사용되고 있는 확산로는 완전 밀폐된 반응로가 아니므로 미량의 유독 가스 누출에도 치명적일 수 있다. 따라서 [표 7-1]의 여러 상태의 확산원 중에서 통상 가스보다는 액체 및 고체 확산원(Source)을 사용하고, 액체 중에서는 브롬(Br)이나 염소(Cl)와 같은 반응성이 높은 할로겐 화합물을 사용한다. 선확산 공정에서의 도펀트 주입은 해당 온도의 고체 용해도 내에서만 가능하다.
표 7-1 선확산(Pre-deposition)에 사용되는 물질
도펀트 | 가스 | 액체 | 고체 |
As | AsH3, AsF3 | ArsenosilicaS | As2O3 |
P | PH3, PF3 | PoCl3(Phosphoroxy Chloride) | P2O5 |
B | B2H6, BF3, BCl3 | BBr3(Boron Tribromide) | B2O3, BND |
Sb | Sb3Cl5(AntimonysilicaS) | Sb2O3, Sb2O4 |
※ S = Spin on source,D=Disc source
선확산 및 후확산 공정에서의 설비는 산화 공정 단원에서 설명한 확산로를 사용하는데, BBr3 또는 POCl3의 액체 확산원에 질소(N2) 등의 불활성 캐리어 가스를 넣어 버블링(Bubbling)시킴으로써, 확산로 내에 붕소(B) 혹은 인(P)을 주입한다.
그럼 구체적으로 도핑 과정에서 어떤 화학 반응이 일어나는지, BBr3 액체 확산원을 사용하는 p형 반도체를 예로 들어 상세히 들여다보자. 먼저, 선확산 과정에서 버블링을 하여 BBr3를 확산로에 흘려보내면, 산소 분위기 속에서 [그림 7-4]와 같이 실리콘 웨이퍼 상에 삼산화붕소(B2O3)가 만들어지고 브롬(Br2)은 반응 부산물로 배기된다. 이때 생성된 삼산화붕소는 실리콘 웨이퍼 위에 유리막처럼 덮혀 있는 상태이며, 산소 분위기에서 삼산화붕소보다 SiO2가 더 안정적이므로 삼산화붕소와 실리콘이 반응해 SiO2가 생성된다. 그 결과 붕소가 실리콘 내로 확산(주입)된다. 이후 H2O 분위기에서 산화시켜, 붕소가 빠져나가는 것을 방지하는 밀봉 산화막(Capping oxide)을 형성시킨다. n형 반도체의 인(P) 주입도 p형 반도체와 유사하게 이루어진다. 두 경우 모두 선확산이 진행된 이후, 고온에서 추가 도펀트 주입 없이 후확산(Drive-in)이 진행되고, 고체 용해도만큼의 도펀트가 실리콘 내로 확산되어 원하는 농도 분포(Profile)를 이루게 된다.
4 다결정 실리콘 내의 도펀트 확산
지금까지는 단결정 실리콘 내의 도펀트 확산에 대해서만 설명하였다. 하지만 MOSFET의 게이트나 DRAM, 낸드 플래시와 같은 메모리 소자에는 다결정 실리콘에 인(P)이나 붕소(B) 등을 도핑하여 사용하고 있으므로, 이 같은 다결정 실리콘 내의 도펀트 확산에 대해 알아보는 것은 의미 있는 일이다. 결론부터 말하자면, 단결정 실리콘보다 10~10,000배 이상 확산이 빠르다. 이는 단결정의 경우처럼 공공에 의한 확산이 아닌 [그림 7-5]와 같이 다결정 실리콘의 결정 입계(Grain boundary)를 통한 확산이기 때문이다. 즉, [그림 7-5(b)]와 같이 한 방향으로의 확산만이 아닌, 결정 입계를 따라 결정의 좌우 방향으로도 확산이 된다는 것이다. 따라서 결정의 크기(Grain size)나 다결정 실리콘의 증착 조건에 따라서도 전도도에 차이가 생길수 있다. 게이트 전극의 경우에는 게이트 산화막 내로 도펀트가 침투하여 MOSFET의 특성에 악영향을 줄 수 있고 이는 확산 계수가 상대적으로 큰 붕소(B)의 경우에 더 문제가 된다.
5 확산 공정의 평가 방법
(1) 면 저항(Sheet resistance, RS) 측정
지금부터는 확산 공정 후 공정상의 문제 여부를 확인하는 평가 방법에 관하여 설명한다. 먼저 면 저항(Sheet resistance) 측정에 관한 내용이다. 면 저항의 정의부터 알아 보자.
우리가 익히 잘 알고 있는 옴(Ohm)의 법칙에 나오는 저항(R)은 그 물질이 갖는 고유의 비저항(ρ)과 저항체의 길이(L)에 비례하고, 면적(A)과는 반비례 관계를 갖는다. 여기서 면적(A) 대신 폭(W)과 두께(t)의 곱으로 표현했을 때, ρ/t를 면 저항(RS)으로 정의할 수 있다. 이렇게 정의된 RS를 근거로 회로 및 레이아웃(Layout) 설계자는 레이아웃상의 길이(L)/폭(W)만 설정하면 공정 변수와 관계없이 저항(R)을 정의할 수 있게 된다. 면 저항의 단위는 비저항(ρ)의 단위 [Ω·cm]를 두께(t)의 단위 [cm]로 나눈 [Ω]으로 써야 하지만, 앞서 얘기한 저항(R)과의 혼동을 피하기 위해 Ω/sq(또는 Ω/□)로 표시한다.
① 도그-본(Dog-bone, Dumbbell) 면 저항 측정
도그-본 측정 방법은 공정 진행 후 바로 측정하는 것이 아닌 모든 공정이 완료된 후 진행되며, 스크라이브 레인(Scribe lane)2에 있는 공정 확인용 테스트 패턴(Test pattern)으로부터 면 저항을 측정하는 방식이다. 공정 평가와 함께 설계자에게 저항치에 대한 정보를 주고자 하는 목적이 크다. 측정 방법은 이렇다. 먼저 [그림 7-7]의 도그-본 패턴의 좌우 패드(Pad)에 전압을 인가하고 흐르는 전류를 측정한 후, 전압을 전류로 나누어 주면 전체 저항이 나온다. 이 값을 레이아웃상 정사각형(Square) 수, 즉 L/W수로 나누어 주면 면 저항(RS)을 구할 수 있다. 이 측정 방법은 수평 확산(Lateral diffusion) 및 금속 콘택(Contact)이 형성될 부분의 넓은 패턴이나 구부러진 패턴 등에 의한 기생 성분이 개입하게 되므로, 순수 확산 도핑 공정 평가용으로는 적합하지 않다.
스크라이브 레인2: 웨이퍼를 자르기(Sawing) 위해 만든 웨이퍼의 제품 다이(Die)와 다이 사이의 여유 공간
② 반 데르 포(Van der Pauw) 저항 측정
반 데르 포(Van der Pauw) 측정 방법으로도 면 저항을 측정할 수 있다. Dog-bone 측정법과 같이 모든 공정 완료 후 테스트 패턴(Test pattern)에서 측정되는 항목이며, [그림 7-8]과 같이 4개의 콘택(Contact)부를 대칭적으로 설계하여 앞의 도그-본 패턴에서의 여러 가지 기생 성분을 소거할 수 있다. 이 덕분에 상대적으로 정확한 면 저항의 측정이 가능하다. 4개의 패드가 대칭적이기 때문에 어디에 전압, 전류를 인가하여도 결과는 같게 나오며, 이 결괏값을 기하학적 보정 상수가 고려된 [그림 7-8]의 식에 넣으면 면 저항(RS)을 구할 수 있다.
③ 4점 탐침(4 Point Probe, 4PP) 저항 측정
다음은 면 저항을 측정하는 마지막 방법으로, 공정 진행 후 바로 면 저항을 측정하여 공정 이상 여부를 확인할 수 있는 방법이다. 이 방법은 패턴 없이 도핑만 되어 있는 공 웨이퍼(Blank wafer)를 가지고 [그림 7-9]와 같이 4점 탐침(4 Point Probe)이라고 하는 장비에서 면 저항을 측정한다. 단, 이온 주입 공정 직후에는 측정할 수 없고 열처리(Annealing)에 의한 도펀트 활성화(Dopant activation) 후에 측정이 가능하다. 측정 원리는 이렇다. 약 1mm의 간격을 가진 외부의 2단자에 전류를 흘려 보내고 내부의 2단자에서 전압을 측정한 후, 전압(V)을 전류(I)로 나눈 값에 기하학적 보정 상수(k = π/ln2)를 곱하여 측정한다. 측정이 쉽고 간편하여 웨이퍼 팹(Fab)3에서 널리 사용되고 있는 방법이다.
Fab3: 반도체를 만드는 공장, Fabrication
(2) 농도 분포 측정(Concentration profile measurement)
① 2차 이온 질량 분석(Secondary Ion Mass Spectroscopy, SIMS) - 화학적 분석
2차 이온 질량 분석(Secondary Ion Mass Spectroscopy, SIMS) 방법은 확산이나 이온 주입 공정 후 웨이퍼 내에 주입된 도펀트의 농도 분포를 전기적이 아닌 물리·화학적으로 측정하는 방법이다. [그림 7-10(a)]와 같이 1~20keV의 낮은 에너지로 세슘(Cs)이나 산소 이온 빔(Beam)을 만들어 샘플에 주사하게 되면, 샘플에서는 [그림 7-10(b)]처럼 이온의 운동량 때문에 스퍼터링(Sputtering) 현상이 발생해 표면의 입자(중성 입자 및 이온)들이 떨어져 나오게 된다. 이 중 이온의 질량(Mass)을 질량 분석기(Massanalyzer)에서 분석하게 되는데, 만약 실리콘(Si)에 인(P)이 도핑된 상태라면 실리콘과 인 입자가 떨어져 나올 때, 그중 인 이온 수를 측정하여 붕소의 농도를 측정한다. 이렇게 계속해서 이온을 때려 깊이 방향으로 한 층씩 벗겨내고, 그 과정에서 스퍼터링되어 튀어 나오는 입자를 모두 분석하면 [그림 7-10(c)]와 같은 깊이 방향으로의 농도 프로파일 분포를 얻을 수 있다. x축이 깊이로 되어 있긴 하지만, 실제 측정 시에는 시간 축이 되고, 후에 스퍼터링 속도를 깊이로 환산하여 그래프를 그리게 된다.
② 확산 저항 탐침법(Spreading Resistance Probe, SRP) - 전기적 분석
도펀트의 농도 분포를 측정하는 두 번째 방법은 확산 저항 탐침법(Spreading Resistance Probe, SRP)이라는 방법으로, SIMS와 달리 전기적 측정에 의한 농도 분포 측정 방법이다.
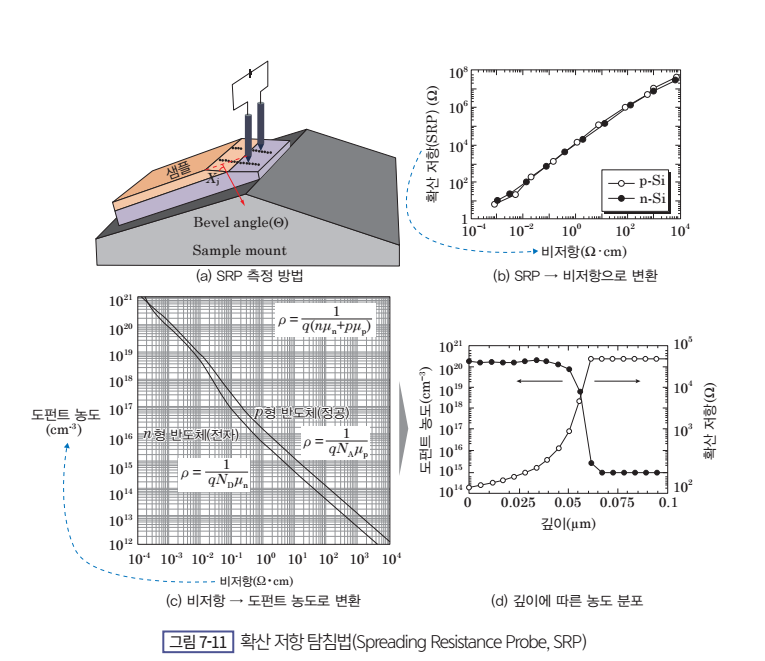
[그림 7-11(a)]와 같이 아주 작은 각도(1~2°)를 가진 샘플 지지대 위에 샘플을 접착·연마한 후, 그 경사면을 2점 탐침(2 point probe)으로 일정 거리만큼 이동하면서 계속 저항을 측정하는 원리이다. SIMS는 전기적으로 활성화되지 못한 도펀트까지 카운팅되는 반면, 이 SRP는 전기적으로 활성화된 도펀트만을 셀 수 있다는 점이 장점이다. 이러한 원리 때문에 매우 얕은(Shallow) 접합 깊이(Xj)를 갖는 경우에는 측정상의 어려움이 있다. 이렇게 측정된 SRP 값은 먼저 [그림 7-11(b)]와 같이 비저항(Resistivity)으로 변환되고 [그림 7-11(c)]의 비저항-도펀트 농도 그래프를 통해 농도로 변환된다. 그 후 [그림 7-11(d)]의 깊이에 따른 도펀트의 농도 그래프로 나타내어진다.
※ 확산 공정은 현재 사용하지 않는 공정이며, 다음 단원인 이온 주입 공정의 도입 배경을 설명하기 위한 단원입니다. 직무/전공면접에서 출제될 가능성이 낮은 공정이므로 ‘기출문제로 정리하기’ 코너는 생략되었습니다.
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기