세정 공정
학습 포인트 |
본 단원에서는 반도체 수율에 악영향을 미치는 이물질이나 오염물을 효과적으로 제거할 수 있는 세정 공정에 대해 설명한다. 습식과 건식 세정의 차이점과 각 세부 방식들을 알아봄으로써 세정 공정의 중요성과 원리에 대해 이해하도록 하자. |
개념 맵 |
반도체 소자의 고집적화에 따라 공정 스텝 수도 더불어 증가하게 되었다. 이에 따라 각 공정 후에 발생되는 표면의 잔류물 또는 오염물의 문제가 더욱 심각해졌고, 이들을 제거하는 세정 공정(Cleaning)의 중요성이 강조되고 있다. 세정 공정은 웨이퍼 표면의 파티클(Particle)1을 비롯하여, 유기 또는 무기 오염물과 자연 산화막 등의 원치 않는 모든 불순물을 제거하는 공정으로 정의할 수 있다. 오염원은 장비, 화공 약품(케미칼), 공정 자체, 인적 오염, 청정실 내 공기 등 다양하다. 세정 공정은 해당 공정 진행 전에 진행되는 전세정(Pre-cleaning)과 공정 완료 후에 진행되는 후세정(Post-cleaning)으로 나눌 수 있으며, [그림 10-1]과 같이 금속배선 공정을 기준으로 하거나 용액 사용 여부에 따라 습식 세정과 건식 세정으로 분류할 수도 있다.
파티클1: 고체형 입자와 액체형 입자의 불순물
전단계 공정(Front-End)인 트랜지스터 제작 공정에서는 60여년 전부터 사용되어 온 RCA 세정법2, 즉 세정 효과가 뛰어난 산이나 알칼리 케미칼 세정을 사용한다. 반면 금속배선 이후 공정(Back-End)에서는 금속의 용해나 부식의 위험성 때문에 산 또는 알칼리 케미칼을 사용하지 못하고, 대신 기계적 세정을 사용한다.
RCA 세정법2: 미국의 RCA사에서 개발한 실리콘 세정법으로, 화학적 방법을 이용해 유기물과 금속 불순물을 제거함
고전적 습식 세정은 반도체 소자의 미세화에 따른 한계가 있어, 최근에는 건식 세정이 그 범위를 넓혀가고 있다. 효과적인 세정 공정의 조건은 다음과 같으며, 이 조건을 충족하지 못할 시에는 패턴 간의 전기적 단락(Short)3 또는 오픈(Open) 불량의 문제, 게이트 산화막과 같은 박막의 품질 저하가 생겨 수율 하락으로 이어질 수 있다.
단락3: 전기 회로의 두 점 사이에 절연이 잘 되지 않아 두 점 사이가 접속되는 현상. 합선과 유의어
세정에 사용되는 케미칼 및 가스 등의 자체 오염이 없어야 한다.
모든 종류의 오염원을 효과적으로 제거할 수 있어야 한다.
하부 구조 또는 박막을 식각하거나 손상을 주지 않아야 한다.
안전하고 경제적이며 친환경적이어야 한다.
1 화학적 습식 세정(Front-end wet cleaning)
이 절에서는 대표적인 습식 세정법인 RCA 세정과 몇 가지 주요 세정 방법에 대해 설명하겠다. [그림 10-2]와 같이 습식 세정 장비에는 일괄 처리 방식(Batch type)과 매엽식(Single type) 방식이 있다. 일괄 처리 방식은 복수의 웨이퍼를 동시에 처리하는 방법이며, 웨이퍼 간 교차 오염(Cross contamination) 및 세정액의 사용량 저감, 그리고 이에 따른 폐수 처리 비용을 감소할 목적으로 세정액이 재순환된다. 다음 매엽식 방식은 세정액을 재사용하지 않고 낱장씩 처리하는 방법이다. 최근에는 일괄 처리 방식에서 매엽식 방식으로 바뀌는 추세이다.
(1) RCA 세정
RCA 세정은 1960년대 미국 RCA사에서 개발된 세정법으로, 그 탁월한 세정 효과로 인해 현재 습식 세정 공정의 근간이 되었다. RCA 세정은 이후 RCA 세정의 단계를 줄이고 클러스터 챔버(Cluster chamber)를 이용한 IMEC 및 Ohmic 세정 방식 등으로 발전해 왔다. 이 방식은 세정 후 공기 노출을 최소화하여, 산화막 성장 및 오염물 재부착을 방지할 수 있다는 장점이 있다. 본 서에서는 기본 공정인 RCA 세정에 대해서만 다루도록 하겠다. RCA 세정은 염기성 케미칼인 암모니아를 사용하는 SC-1 (Standard Clean-1)과 산성 케미칼인 염산을 사용하는 SC-2(Standard Clean-2) 세정으로 구성되며, [그림 10-3]과 같은 순서로 진행된다. 후술할 기계적 세정 방식인 메가소닉(Megasonic) 세정4 방식을 접목시켜 세정 효과를 극대화하기도 한다.
메가소닉 세정4: 기계적 세정 방법 중 ~1MHz 정도 주파수의 초음파를 사용하는 방법으로, 입자 가속도를 이용해 정밀 세척 가능
① SC-1 세정
SC-1 세정은 APM(Ammonium Peroxide Mixture) 세정이라고도 하는데, 암모니아 수(NH4OH), 과산화수소(H2O2), 물(H2O)을 1 : 1 : 5로 혼합하여 75~90℃의 온도에서 10~20분 동안 세정하는 방법이다. 세정 온도를 특정 온도 범위로 설정하는 이유는 세정액의 충분한 활성화와 함께 과산화수소(H2O2)의 급속한 분해를 방지하기 위함이며, 반도체 소자의 미세화에 따라 세정 용액의 온도와 농도(1 :1 :5 → 1 :1 :10~50)는 점차 낮아지고 있는 추세이다. SC-1은 과산화수소의 강한 산화작용을 이용한 단계로, [그림 10-4]와 같이 표면 파티클 및 유기 물질 그리고 일부 금(Au), 은(Ag), 구리(Cu), 니켈(Ni) 등의 금속들을 산화시켜 제거하거나 산화된 오염물들을 암모니아(NH4OH)로 식각하여 박리(Lift-off)5시키는 원리이다. 박리된 오염물은 염기성 케미칼(NH4OH)의 높은 제타 전위(Zeta potential, ζ) 때문에 웨이퍼에 재부착되지 않는다.
박리5: 들어 올려서 떼어냄.
심화개념 |
제타 전위란 입자 사이의 반발력이나 인력의 크기를 나타내는 단위로, 제타 전위의 절댓값이 크면 입자들 간의 반발력이 크고, 작으면 응집력이 큰 것으로 볼 수 있다. [그림 10-5(b)]에서처럼, pH는 제타 전위의 주요 인자이다. 만약 음전하의 입자가 있는 용액에 pH가 높은(OH-가 많은) 알칼리 용액을 투입하면, 더 강한 음전하를 띠게 된다. 따라서 제타 전위는 음의 방향으로 커져 반발력이 증가하므로, 오염물이 웨이퍼 표면에 재부착되지 않는 것이다. 여기서 제타 전위에 대해 좀 더 알아보자. [그림 10-5(a)]와 같이 입자의 표면이 전하를 띠게 되면 반대 극성의 전하를 가진 이온들이 입자 표면에 끌려오게 된다. 이 이온들은 정전기적 힘과 분자 간의 힘에 의해 움직이지 않게 되는데, 이를 고정층(Stern layer)이라고 한다. 만약 이러한 입자가 들어 있는 전해질 용액에 전류를 통과시키면, 표면 전하에 의하여 입자가 어느 한쪽 전극으로 끌려가게 된다. 이때 어느 지점에서 끌려가지 않는 면과 미끄러지는 전단면이 생기게 되는데, 이 면을 슬리핑면(Slipping plane)이라고 하고, 이 면의 전위를 제타 전위라고 한다. |
② QDR(Quick Dump Rinse)
SC-1과 SC-2 세정 사이에 있는 QDR단계는 초순수(De-Ionized Water, DIW)6를 사용해 헹구는 단계이다. [그림 10-6]과 같이 웨이퍼에 스프레이 방식으로 초순수를 분사하고, 초순수가 수조에 가득 차면 빠른 속도로 배수해 헹궈준다. 웨이퍼는 이러한 과정을 2~3회 반복한 후 SC-2 세정으로 넘어간다.
초순수6: 수중에 이온 성분을 거의 완벽히 제거한 증류수
③ SC-2 세정
SC-2는 HPM(Hydro-chloric Peroxide Mixture) 세정이라고도 하는데, 염산(HCl), 과산화수소(H2O2), 물(H2O)을 1 :1 :5로 혼합하여 75~85℃의 온도에서 세정하는 방법이다. [그림 10-7]과 같이 SC-1 세정에서 제거되지 못한 금속 불순물(중금속 및 알칼리 금속)을 과산화수소로 먼저 산화시킨 후, 이를 염산으로 제거하는 원리이다.
SC-1과 마찬가지로 반도체 소자의 미세화에 따라 세정 용액의 온도와 농도(1 :1 :5 → 1 :1 :10~50)가 점차 낮아지고 있는 추세이다. 세정 후에는 과산화수소에 의해 기판 표면에 ~30Å 전후의 화학적 산화막(Chemical oxide)이 자라고, 그 표면은 [그림 10-8(a)]와 같은 OH- 종단(Termination)을 갖게 되어 친수성(Hydrophilic)을 띠게 된다. 이후 웨이퍼는 QDR를 거쳐 DHF(Diluted HF) 처리로 이송된다.
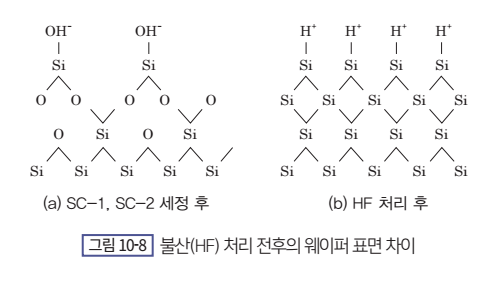
자연 산화막과 화학적 산화막(SC-1, 2의 세정 과정을 거쳐 성장)은 배선의 접촉(Contact) 저항 증가와 산화막 내 불순물에 의한 게이트 산화막 누설 전류 등의 불량을 발생시킬 수 있으므로 반드시 제거해야 한다. 이는 DHF(Diluted HF) 단계에서 이루어지며, 주로 불산(HF) 원액을 초순수에 1 :10~100 비율로 희석하여 사용한다. 이렇게 DHF 단계를 끝으로 세정을 완료하면, [그림 10-8(b)]와 같은 H+ 종단(Termination)을 갖게 되어 소수성(Hydrophobic)을 띠게 되고 이는 파티클의 재부착을 용이하게 하므로, 바로 다음 공정을 진행하여야 한다. 이 때문에 웨이퍼를 장기간 보관할 때에는 [그림 10-8(a)]와 같이 표면이 친수성을 띠는 SC-1 또는 SC-2 세정 및 QDR 단계 이후 보관한다.
2 기계적 습식 세정(Back-end wet cleaning)
서론에서 설명한 것처럼, 금속배선 이후 공정에서는 강한 산 또는 염기성 케미칼의 화학적 세정 대신 기계적 세정 방법을 적용해야 한다. 기계적 세정 방법은 ~1MHz 정도 주파수의 초음파를 사용하는 메가소닉(Megasonics) 방식과 직접 웨이퍼 표면과 접촉하는 PVA 브러시 스크러버(Poly-Vinyl Acetate brush scrubber) 방식으로 나눌 수 있다.
(1) 메가소닉(Megasonics) 세정
초음파 세정은 20~400kHz의 저주파 영역을 사용하는 울트라소닉(Ultrasonic) 세정과 900kHz~1.2MHz의 고주파 영역을 사용하는 메가소닉(Megasonic) 세정으로 나눌 수 있다. 일반적으로 초음파 세정은 미세한 구조에 침투하여 정밀 세정이 가능한 것이 특징이다.
[그림 10-9(a)]와 같이 세정 용액에 저주파 영역의 초음파가 전파될 때 (+), (-)의 압력 변화가 생기는데, 이로 인해 수십 ms(밀리초) 순간에 공동(Cavity)7이 붕괴된다. 이 과정에서 수백 기압에 이를 만큼의 강력한 충격을 전달하는 캐비테이션(Cavitation) 현상이 생기고, 이를 이용한 세정이 바로 울트라소닉 세정이다. 반면, 메가소닉 세정은 [그림 10-9(b)]와 같이 음파의 힘에 의해 물리적으로 세정하는 비 접촉식 세정 방법으로, 피 세정물의 손상이 적고 침투력이 우수하여 정밀 세척에 유리하.
공동7: 공기층
(2) PVA 브러시 스크러버(Poly-Vinyl Acetate brush scrubber)
스크러버의 회전력과 브러시의 접촉력을 이용해 CMP 오염물 등의 상대적으로 큰 파티클을 세정하는 방법이다. 예전에는 나일론과 같은 재료로 된 브러시를 사용했으나, 웨이퍼 표면의 긁힘 불량이 생길 수 있어 부드럽고 유연한 PVA(Poly-Viniyl Alcohol) 재질의 브러시를 사용하고 있다. [그림 10-10]에 단면형과 양면형 PVA 브러시 스크러버 장비의 개념도를 나타내었다.
3 웨이퍼 건조(Wafer dry) 공정
웨이퍼 건조 공정은 습식 세정 후에 진행되는 공정이다. 수분이 완전히 건조되어야 함은 물론, 공정 과정에서 물리적인 충격, 파티클의 재부착, 물반점(Water-mark) 발생 등의 불량이 없어야 한다. 전통적으로 웨이퍼 건조 공정에는 [그림 10-11]의 스핀 건조기(Spin dryer) 방식이 사용되었다. 이는 회전(~5,000rpm)에 의한 원심력을 이용해 기판을 건조시키는 원리이며, 장비가 단순하다. [그림 10-11]에서와 같이 매엽식과 일괄 처리식이 있으며, 그중 일괄 처리식(Batch-type)은 다수의 웨이퍼를 한 번에 처리할 수 있고 저 비용이라는 장점이 있다. 하지만 원심력에 의해 웨이퍼 상 미세 패턴의 손상 및 파티클의 재부착이 생길 수 있고, 건조 중 웨이퍼가 깨지면 동시에 진행되던 다른 웨이퍼에도 영향을 줄 수 있다는 문제가 있어 최근에는 사용 빈도가 낮아지게 되었다.
스핀 건조기의 단점을 해결한 것이 [그림 10-12]의 마랑고니(Marangoni) 건조 방식이다. 이는 표면 장력의 차이로 인해 유체가 이동한다는 마랑고니(Marangoni) 효과를 이용한 건조 방식으로, 먼저 초순수(DIW)가 담긴 수조에서 웨이퍼 린즈(Rinse)를 완료한 후, 웨이퍼를 서서히(~1mm/sec) 끌어 올려 챔버 속 질소(N2) 및 이소프로필알코올(Isopropyl alcohol, IPA) 증기(Vapor)와 마주치게 한다. 이후 웨이퍼를 끝까지 끌어 올리는 과정으로 전체 웨이퍼의 건조가 이루어진다. 상세 원리는 [그림 10-12]의 우측 그래프를 통해 설명하겠다. 웨이퍼를 챔버 속 증기와 마주치게 하면, IPA가 초순수에 녹아 들게 된다. 이때 그래프의 P1 지역(웨이퍼와 가까운 지역)은 체적8이 작아 IPA의 농도가 P2 지역보다 높아지고, P1 지역의 표면 장력이 P2 지역보다 낮아지게 된다. 그 결과 초순수는 P1 지역에서 표면 장력이 높은 P2 지역을 향해 흘러내려가고, 웨이퍼를 끝까지 끌어 올리면 웨이퍼가 전체적으로 건조된다. 이러한 방식은 DIW 린즈와 건조가 진행되는 동안 웨이퍼가 공기에 노출되지 않아 물반점의 발생을 방지할 수 있고, 다른 많은 스핀 건조기의 문제점도 해결할 수 있어 널리 사용하는 공정 방식이다. 물반점이란 웨이퍼 상에 친수성인 SiO2와 소수성인 실리콘(Si)이 동시 노출된 경우, 초순수 린즈(Rinse) 동안 실리콘(Si)의 일부 영역이 물속에 녹아 있던 산소(O2)에 의해 산화되고 이 산화막이 다시 물속에 녹아있다가 웨이퍼의 이동 또는 스핀 건조와 같이 웨이퍼 상의 수막 또는 물방울이 얇아지면 그 속에 녹아 있던 실리카 및 규산염이 웨이퍼 상에 반점 모양으로 침전되어 국부적으로 산화막의 두께가 두꺼워지는 현상으로 나타나는 불량을 말한다.
체적8: 부피
4 건식 세정(Dry cleaning) 공정
소자의 미세화에 따라, DRAM의 커패시터 및 3D NAND 등의 고 종횡비(High Aspect Ratio, HAR) 패턴 구조로 발전하였고, 이러한 구조의 습식 세정에서 모세관 현상(Capillary phenomenon)9 및 표면 장력에 의해 패턴이 서로 들러붙거나(Bridge) 무너지는(Collapse) 불량이 발생하게 되었다. 이 외에 케미칼 내의 불순물에 의한 역 오염, 케미칼과 초순수의 대량 사용 및 폐수 처리로 인한 비용 증가 등 다양한 문제점들로 인해 건식 세정에 대한 필요성이 대두되었다. 건식 세정은 액체 상태의 화학약품 대신 기상(Vapor)이나 가스 상태에서 세정하는 방식이기 때문에, 습식 세정의 문제점 해결은 물론 미세한 구멍 등의 고 종횡비(HAR) 패턴 세정도 가능하다. 또한 증착, 식각, 산화 등 후속 공정 장비와 클러스터 툴(Cluster tool)로 연결되어, 세정 후 웨이퍼의 외부 노출을 막아 오염을 최소화할 수 있다는 장점도 있다. 건식 세정의 종류에는 유기물 제거 목적의 UV/O3 및 플라즈마 세정, 금속 오염 세정을 위한 UV/Cl2, 자연 산화막 제거 목적의 불산 기상 세정(HF vapor cleaning) 등이 있으며 [표 10-1]에 각 건식 세정 공정을 정리하였다.
모세관 현상9: 매우 가는 관을 액체에 넣었을 때, 관 속의 액면이 관 밖의 액면보다 높아지는 현상
표 10-1 대표적인 건식 세정 방법
구분 | 유기물 | 금속 | 자연 산화막 | |
대량 | 소량 | |||
기상 세정 | ||||
자외선 세정 | ||||
플라즈마 세정 | ||||
심화개념 |
(1) 자외선/오존 세정(UV/O3 cleaning) 자외선/오존(UV/O3) 건식 세정은 유기물(Polymer)을 제거하는 공정이다. 150~600nm 파장의 자외선(UV)은 다양한 종류의 고분자를 해중합화(De-polymerization)10 할 수 있어, 수천 Å의 두꺼운 고분자막을 [그림 10-13]과 같이 H2O, CO2, N2 등의 휘발성 분자로 증발시켜 제거할 수 있다. 그래서 포토레지스트의 제거 및 반응성 이온 식각(RIE) 후의 폴리머 제거에도 응용된다. 이 방법은 유기물 제거 외에도, 세정 후 기판 표면에 산화막을 형성시켜 표면 보호의 역할을 하기도 한다. 제거가 필요할 경우에는 HF/H2O 기상 세정 등으로 제거할 수 있다. 해중합화10: 중합의 반대 현상을 의미하며, 중합체를 가열하여 역반응을 일으키면 중합체가 단위체(Monomer)로 분해되는 화학 반응을 말함. (2) 플라즈마 세정(Plasma cleaning) 플라즈마 세정은 플라즈마를 이용하여 표면의 오염물을 제거하는 방식으로, 화학적인 방법과 물리적인 방법으로 양분된다. 화학적인 방법은 [그림 10-14(a)]와 같이 오염 물질을 플라즈마 내에 존재하는 활성종11(주로 산소 라디칼, O*)과 반응시켜 제거하는 방식이다. 유기물의 경우 산소 라디칼(O*)과 반응하여 수분(H2O)와 이산화탄소(CO2) 가스 형태로 제거된다. 이는 식각 공정에서 설명했던 플라즈마 식각과 동일한 메커니즘이다. 다음, 물리적인 방법은 [그림 10-14(b)]와 같이 웨이퍼 표면에 플라즈마 내 고 에너지의 이온(주로 Ar+)을 충돌시켜 표면의 오염 물질을 제거하는 것이다. 이는 식각 공정에서 설명한 스퍼터링 식각 방식과 동일한 원리이며, 이온의 입사 에너지가 과다하면 표면에 손상을 줄 수 있다. 실제 플라즈마 세정 공정에서는 두 가지 방법이 동시에 작용하고, 적용 대상에 따라 적절한 방법을 사용하여야 한다. 활성종10: 화학적으로 반응성이 있는 분자 플라즈마 세정의 한 예로 자연 산화막 제거(Native Oxide Remaval, NOR)의 최근 기술인 플라즈마 조력 세정(Plasma assisted cleaning)이 있다. 이 세정 방식은 [표 10-1]의 H2 원거리 플라즈마를 이용하고 있다. 자연 산화막 제거는 소자의 미세화에 따라 대두된 문제이며, 자연 산화막으로 인해 배선 접촉 저항 증가, 게이트 산화막 누설 전류 발생, 실리사이드(Silicide) 형성 불량 등의 문제가 야기될 수 있으므로 반드시 제거해야 한다. NOR 공정은 화학 반응(Chemical reaction)과 기화(Vaporization)의 2단계 공정으로 진행된다. 자연 산화막 제거(NOR)에서 사용하는 세정가스에는 [그림 10-15(b)]와 같이 암모니아(NH3) 플라즈마로부터 발생하는 수소 라디칼(H*)과 삼불화질소(NF3)가 있다. 이 둘이 [그림 10-15(a)]와 같이 반응하여 NH4F와 NHxFy가 생성되고 표면에 흡착12이 이루어진다(1단계). 생성된 NHxFy는 실리콘 산화막(SiO2)과 반응하여 반응 부산물로 (NH4)2SiF6가 만들어진다(2단계). 그리고 산소 라디칼은 반응 챔버 내에서 물 분자를 형성하여 반응 부산물이 되고, (NH4)2SiF6는 온도 증가와 함께 기화되면서(3단계) 자연 산화막의 제거가 이루어진다(4단계). 흡착12: 물속에 존재하던 용질이 고체의 표면에 달라붙는 상호작용 (3) 불산 기상 세정(HF vapor cleaning) 기상 세정법은 세정액을 증발시켜 발생된 증기를 이용해 오염 물질을 분리해내는 세정 방법이다. 대표적으로 불산 기상 세정(HF vapor cleaning)이 있다. 이는 무수(Anhydrous)13 HF 기체와 수증기를 적정 비율로 혼합하여, 운반 기체(Carrier gas)인 질소(N2) 또는 아르곤(Ar)과 함께 진공 장비 내로 주입하여 수행된다. 건식 세정임에도 수증기를 첨가하는 이유는 기판 표면을 수화시킨 후 표면과 무수 HF기체를 응축시켜 HF의 자연 산화막 제거 효율을 향상시키기 위함이고, 또 기판이나 다른 박막을 식각시키지 않는 HF의 임계 농도를 낮추어 선택비를 개선하기 위함도 있다. 무수13: 수분을 함유하지 않거나 제거시킨 상태의 화합물 |
기출문제로 정리하기 ※ 기출문제를 읽고 스스로 답변해 본 후, 이와 관련된 ‘이론 페이지’의 내용을 확인하여 자신의 답안과 비교합니다. | 이론 페이지 |
최신 기출 1 세정 공정에 대해 설명하시오. | p.459 |
최신 기출 2 RCA 세정에 대해 설명하시오 | p.460~461 |
최신 기출 3 기계적 세정에 대해 설명하시오. | p.464 |
최신 기출 4 습식 세정 후 웨이퍼 건조 공정에 대해 설명하시오 | p.465~466 |
최신 기출 5 건식 세정에 대해 설명하시오. | p.467 |
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기