식각 종류와 장단점에 대해 설명해보세요. 어떤 식각 방식이 좋을지 의견을 제시하세요.
식각(Etching) 공정은 웨이퍼에서 액체 또는 기체의 etchant를 이용해 불필요한 부분을 선택적으로 제거해 반도체 회로 패턴을 만드는 것이다. 반도체를 구성하는 여러 층의 얇은 막에 원하는 회로 패턴을 형성하는 과정을 반복함으로써, 반도체의 구조가 형성된다. 식각 공정을 그림으로 나타내면 아래와 같다.
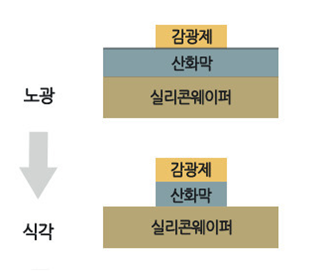
식각공정은 포토공정 다음에 이루어지며, 식각 종류에는 습식 식각과 건식 식각이 있다. 습식 식각이란 목표 금속만을 부식 용해하는 성질을 가지는 액체의 약품을 사용하는 식각이다. 주로 프린트 배선판제조, 금속 명판제조, 반도체 소자제조 같은 분야에서 사용된다. 습식 식각의 장점은 한 번에 대량의 기판을 처리할 수 있고, 장비나 약품의 가격이 저렴하다는 점이다.
하지만 습식 식각의 단점은 에칭 깊이가 깊을수록 단면 방향도 부식이 진행되기 때문에 정밀도가 높은 미세 가공이 어렵고, 약품의 온도에 따라서 에칭 속도가 변화된다는 점이다. 이와 같은 단점 때문에, 나노스케일로 집적화되는 반도체 기술의 변화에 따라 회로선폭이 미세해지는 현재의 상황에서는 습식 식각보다는 건식 식각이 보다 확대되고 있다. 건식 식각은 식각 방향 제어가 가능하여 선폭 10nm 이하의 미세 패턴 형성에 필수적이며, 현재 반도체 공정의 주류 식각 방식으로 자리 잡고 있다.
건식 식각은 플라즈마 식각이라고도 하는데, 대기압보다 낮은 압력인 진공 챔버(Chamber)에 Gas를 주입한 후, 전기 에너지를 공급하여 플라즈마를 발생시킨다. 여기서 플라즈마란, 고체-액체-기체를 넘어선 물질의 제 4 상태로 많은 수의 자유전자, 이온 및 중성의 원자 또는 분자로 구성된 이온화된 기체이다. 플라즈마는 전기에너지에 의해 형성된 충분한 크기의 자기장이 기체에 가해질 때, 기체가 충돌하고 이온화됨으로써 발생하는데, 이는 자기장이 자유전자를 가속화시켜 높은 에너지를 가진 자유전자가 중성의 원자나 분자와 충돌하여 이온화를 일으키게 되는 것이다.
이 때 이온화에 의해 생성된 추가 전자도 연쇄 반응(Avalanche)에 의해 또 다른 이온화를 일으키면서 이온의 수가 기하 급수적으로 늘어나게 되는데, 이 상태를 바로 '플라즈마 상태'라고 한다. 플라즈마 상태에서 해리된 반응성 원자(Radical Atom)가 웨이퍼 위를 덮고 있는 막질 원자와 만나 강한 휘발성을 띠면서 표면에서 떨어져 나가게 되는 것이다. 이러한 반응을 통해 감광액(PR, Photo Resist) 보호막으로 가려져 있지 않은 막질이 제거되는 원리를 활용하는 것이 건식 식각이다. 건식 식각 과정에서는 다음과 같은 유의사항들이 있다.
첫 번째는 균일도(Uniformity)를 유지하는 것이다. 여기서 균일도란 식각이 이루어지는 속도가 웨이퍼 상의 여러 지점에서 얼마나 동일한가를 의미한다. 균일도가 중요한 이유는 일정한 시간 동안 공정을 진행한 상태에서 웨이퍼의 부위에 따라 식각 속도가 다를 경우, 형성된 모양이 부위별로 다르게 되어 특정 부위에 위치한 칩의 경우 동작하지 않아 불량이 발생하거나 특성이 달라지는 문제가 발생할 수 있기 때문이다.
두 번째는 식각속도(Etch Rate)이다. 이는 일정시간 동안 막질을 얼마나 제거할 수 있는지를 의미하는데, 식각속도는 주로 표면 반응에 필요한 반응성 원자와 이온의 양, 이온이 가진 에너지에 의해서 변화하기 때문이다. 즉, 원자와 이온의 양, 이온이 가진 에너지 등에 따라 식각속도가 달라지는데, 이러한 인자의 컨트롤어빌리티를 증가시켜 전체적인 수율을 향상시키기 위한 노력이다. 이 밖에도 선택비(Selectivity), 형상(Profile) 등이 건식 식각의 주요인자로 중요하게 여겨진다.
[ALE(Atomic Layer Etching)]
ALD(원자층 증착)의 역방향 개념으로, 반응 가스 흡착(표면 개질) → 물리적 이온 제거(식각)를 반복하여 원자층 1개 단위로 정밀하게 식각하는 기술이다. 3nm 이하 GAA FET의 채널 형성, 3D NAND의 HAR(High Aspect Ratio) 식각 등 원자 수준의 정밀도가 필요한 첨단 공정에 적용이 확대되고 있다. Lam Research·Applied Materials가 관련 장비를 공급하고 있다.
10nm 이하의 첨단 공정에서는 이방성과 원자층 수준의 제어가 필수적이므로 RIE 및 ALE의 조합이 가장 적합하다. 다만 ALE는 처리량(Throughput)이 낮아 공정 비용이 높으므로, 원자층 정밀도가 요구되지 않는 단계에서는 RIE를, 게이트 절연막 형성·채널 정밀 식각 등의 핵심 공정에서는 ALE를 선택적으로 적용하는 것이 현실적이다.
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기