포토 공정
학습 포인트 |
포토 공정은 반도체 회로 정보를 웨이퍼로 전사시키는 패턴 형성 공정으로, 반도체 8대 공정의 근간이 되는 핵심 공정이다. 본 단원을 학습함으로써 각 세부 공정의 흐름에 대한 이해는 물론, 액침 노광, 극자외선(EUV) 기술 등의 최신 기술도 접할 수 있을 것이다. |
개념 맵 |
1 개요
리소그래피(Lithography)는 그리스어에서 파생된 말로서, 돌(Litho)과 인쇄(Graphy)의 합성어인 석판 인쇄술을 의미한다. 여기에 빛을 이용한다는 의미에서 ‘Photo’라는 단어가 붙어, 포토리소그래피(Photolithography)라는 용어가 나오게 되었고 이를 간략히 포토 공정이라 부른다. 포토 공정은 집적회로 제조 과정에서 감광성 고분자 물질(Photoresist, 포토레지스트, PR)을 이용해, 마스크(Mask) 상의 회로 패턴을 웨이퍼(Wafer) 상에 전사1시키는 공정으로 정의할 수 있다. 이렇게 형성된 PR 패턴은 후속으로 진행될 식각 공정 및 이온 주입 공정에서 선택적 보호막(Blocking layer)의 역할을 하게 된다.
전사하다1: 글이나 그림 따위를 옮기어 베낌.
2 마스크 제작
토 공정의 기본 원자재 중 하나인 마스크는 반도체의 회로 정보를 담고 있으며, 석영(Quartz) 기판 위에 크롬(Cr) 증착된 차광막을 이용하여 전기적 회로를 형상화한 판을 의미한다. 이렇게 석영 기판 위에 크롬이 증착된 마스크 원판을 블랭크(Blank) 마스크라 한다. 포토 마스크(Photo mask)는 [그림 2-1]과 같은 과정을 거쳐 만들어진다. 먼저 회로 설계자가 반도체 제품 제작을 위해 다양한 특성의 능동 및 수동 소자, 즉 트랜지스터, 다이오드, 저항, 커패시터(Capacitor) 등의 개별 소자를 조합하여 회로도(Schematic)를 설계한다. 이 회로도는 다시 CAD(Computer Aided Design) 소프트웨어 툴(Tool)을 사용하여 웨이퍼 상에 전사할 수 있는 평면도(Layout)로 변환되고, 이렇게 설계 정보가 담긴 평면도 데이터를 가지고 포토 마스크를 제작하게 된다.
포토 마스크의 종류는 사용 목적과 포토레지스트 타입, 노광2 설비, 구조, 두께 및 크기에 따라 다양하게 분류할 수 있다. 용어적인 측면에서 볼 때, 마스크 내 패턴 크기와 실제 웨이퍼에 전사되는 패턴 크기가 1 :1로 동일한 경우를 마스크(Mask)라 하고, 마스크 내 패턴 크기를 실제 패턴 크기보다 4~10배 크게 하여 축소 노광하는 경우를 레티클(Reticle)이라고 한다. 하지만 현재는 구분 없이 사용하고 있다.
노광2: 노광 장비를 이용해 빛을 선택적으로 조사하는 과정
최근 노광 장비 중 하나인 스캐너(Scanner)에서는 4 : 1 마스크가 주류를 이루고 있다. 축소 노광되는 마스크는 [그림 2-2]와 같이 1개의 마스크 안에 여러 개의 다이(Die) 또는 칩(Chip)으로 구성되는데, 이런 다수의 칩으로 구성된 하나의 묶음을 샷(Shot) 또는 필드(Field)라고 한다. 한 개의 필드 내에 몇 개의 칩을 넣을 것인가는 칩의 크기와 노광 장비의 능력, 웨이퍼 내에서 얻을 수 있는 최대 칩 수, 즉 순 다이 수(Net die) 등을 고려하여 결정한다. 필드 내 칩과 칩 사이의 비어 있는 라인은 스크라이브 레인(Scribe lane)이라고 하는데, 여기에는 트랜지스터, 다이오드, 저항, 커패시터 등의 단위 소자 특성을 평가할 수 있는 테스트 패턴(Test pattern)과 단위 공정 진행 후 측정하는 잔막 두께 측정 패턴, 그리고 마스크 정렬 상태 모니터링 패턴 등의 전기적, 공정적 평가를 위한 다양한 패턴들이 배치되어 있다. 마스크 특성에 대한 주요 요구 사항으로는 첫째, 낮은 열 팽창 계수를 가질 것, 둘째, 석영 기판 영역에서는 빛에 대해 높은 투과율을 보이고 차광막에서는 낮은 투과율을 보일 것, 셋째, 기계적·화학적 내구성(Durability)이 클 것 등을 들 수 있다.
다음은 마스크 제작 과정을 설명한다. 마스크 제작 과정은 이후에 설명할 포토 및 식각 공정과 동일하게 포토레지스트 도포, 노광, 현상, 식각 및 포토레지스트 제거의 순으로 진행된다. 먼저 [그림 2-3]과 같이 블랭크 마스크에 포토레지스트(Photoresist, PR)를 도포하고, 앞서 언급한 평면도 데이터를 전자 빔 라이터(Electron beam writer) 장비에 로딩하여 라이팅(Writing)한다. 이때, 불필요한 영역의 노광을 막아줄(차단막) 또 다른 마스크가 없으므로, 노광이 한 번에 이루어질 수 없다. 대신 전자 빔으로 일일이 포토레지스트에 조사하는3 작업이 필요하다. 다음은 현상4 과정을 통해, 전자 빔과의 반응 여부에 따라 포토레지스트를 선택적으로 제거하고, 남은 포토레지스트를 차단막으로 하여 하단의 크롬 박막을 식각하게 된다. 이후 포토레지스트를 제거함으로써 제작이 완료되고, 품질을 확인하기 위한 측정, 검사, 불량 부분에 대한 수리(Repair) 및 펠리클(Pellicle) 부착 공정 등을 진행한 다음 출하시킨다. 통상 고 해상도 마스크는 전문 마스크 업체에 의뢰하여 제작한다.
조사하다3: 햇빛 따위가 내리쬠.
현상4: 현상액을 처리하여 상이 나타나도록 함
펠리클(Pellicle)은 마스크의 표면을 대기 중의 오염으로부터 보호해 주는 목적으로 사용되고 있으며, 알루미늄 프레임에 셀룰로오스 등의 박막이 부착되어 있는 구조이다. 만약 포토 마스크 표면에 어떤 입자(Particle)가 떨어져 있거나 광화학 반응에 의해 이물질이 생성되면, 포토 마스크 표면의 패턴이 웨이퍼에 정상적으로 노광되지 못하고 불순물과 함께 노광되어 불량이 발생한다. 하지만 펠리클을 사용하게 되면 펠리클 상에 이물질이 묻더라도 [그림 2-4]와 같이 초점거리에서 벗어나게 되므로, 포토 공정에 악영향을 미치지 않아 공정 수율을 개선할 수 있다.
3 포토 공정의 전반적인 흐름
[그림 2-5]는 통상의 포토 공정 과정을 나타낸 것으로, 산화막이 증착된 웨이퍼에 포토 공정을 통해 마스크의 패턴을 전사하고, 이후 산화막의 식각으로 패터닝을 마무리하는 공정을 예로 들었다. 그림에는 표시하지 않았으나, HMDS5 처리, 소프트 베이크, 노광, PEB 및 하드 베이크 등과 같이 웨이퍼가 가열되는 단계에서는 반드시 웨이퍼를 냉각하는 단계가 필요하다. 특히 노광 전에는 열팽창에 의한 정렬 오차의 발생을 막기 위해, 반드시 웨이퍼를 식혀주어야 한다. 이에 대해서는 후술하도록 하겠다.
HMDS(Hexamethyldisilazane)5: 포토레지스트는 소수성의 유기물로, 친수성인 웨이퍼 표면과 접착력이 약하므로 웨이퍼 표면을 소수성으로 만들어 포토레지스트와의 접착력을 강화시켜 주는 화학 물질임.
(1) 전 세정(Pre cleaning) 및 건조
웨이퍼 표면의 유기물이나 이온, 금속 불순물 등으로 인한 오염 문제를 막기 위해 웨이퍼를 화학적으로 세척하는 공정으로, 심각도 및 필요성에 따라 진행 여부는 유동적일 수 있다.
(2) 표면처리: HMDS(Hexa-Methyl-Di-Silazane) 처리
통상 포토 공정 전의 웨이퍼는 표면에 있는 실리콘 및 실리콘 산화막 등이 노출되어 수산기(Hydroxyl, OH-)가 형성되면서 친수성을 띠게 된다. 다음 단계에서 웨이퍼에 도포될 포토레지스트는 소수성의 물질로서, 친수성의 웨이퍼와는 접착성(Adhesion)이 좋지 않다. 이에 [그림 2-6(a)]와 같이 HMDS (Hexamethyldisilazane)를 기화·분사하여, [그림 2-6(b)]와 같이 웨이퍼 표면을 유기물인 트리메틸실릴(Trimethylsilyl, Si(CH3)3)) 작용기로 치환시키면, 웨이퍼를 소수성으로 만들어 포토레지스트와의 접착성을 향상시킬 수 있다.
(3) 감광액(Photoresist, PR) 도포(Coating)
다음으로 노광에 의해 화학적 구조가 변화하는 감광성 고분자 물질인 포토레지스트를 도포한다. 포토레지스트는 통상 몸체가 되는 고분자 수지(Resin)와 빛에 반응하는 광 감응물질(Sensitizer), 이 둘을 용해시켜 일정한 점성을 갖게 하는 유기용매(Solvent), 그리고 일부 첨가제(Additive)로 구성된다. 포토레지스트의 종류는 다양한 방법으로 분류할 수 있으나, 통상 2가지 방법으로 구분한다. 먼저 용해도에 따라 양성(Positive) PR과 음성(Negative) PR로 구분하는 방법이 있고, 노광 시 사용하는 광원의 종류에 따라 자외선(Ultra Violet, UV)용, 원자외선(Deep UV, DUV)용, 극자외선(Extreme UV, EUV)용으로 구분하는 방법이 있다. 종류별 상세 설명은 후술한다.
액화된 포토레지스트를 웨이퍼에 도포하기 위해서는 먼저 [그림 2-7(a)]의 회전 도포기(Spin coater) 장치에 있는 진공척(Chuck) 위에 웨이퍼를 고정시킨다. 다음 포토레지스트(PR)를 웨이퍼 중심에 분사한 후 고속으로 회전시켜 원심력에 의해 균일하게 도포한다. 통상 3,000~7,000rpm에서 수십 초 동안 회전시키며, 포토레지스트의 두께는 [그림 2-7(b)]와 같이 회전 속도와 포토레지스트의 점도(Viscosity)에 의해 결정된다. 이때 포토레지스트 내 용매의 70~80%가 제거된다. 특히 점도는 온도에 민감하므로 온도 편차를 정밀히 제어해야 하며, 회전하는 동안 용매(Solvent)의 증발로 인해 웨이퍼 온도 하강뿐 아니라 습기 흡수도 발생할 수 있으므로, 이를 방지하기 위해 습도 또한 일정 수준 이하로 유지해야 한다. 포토레지스트 두께의 균일도는 통상 도포 두께의 ±10% 이내로 제어한다.
회전 도포를 하면 포토레지스트의 표면 장력 효과 및 원심력에 의해, 포토레지스트가 웨이퍼 가장자리에 뭉치거나 웨이퍼 뒷면(Back-side)까지 퍼지는 문제가 생긴다. 이는 후속 공정에서 웨이퍼를 고정시키는 클램프(Clamp)나 웨이퍼 척(Chuck)을 오염시킬 수 있기 때문에 반드시 제거해야 한다. 제거 방법에는 [그림 2-7(a)]와 같이 웨이퍼 가장자리에서 웨이퍼 상하부 면에 용매를 분사해 제거하는 EBR(Edge Bead Removal) 방법 또는 웨이퍼 가장자리만 별도로 노광하여 현상 시 제거하는 WEE(Wafer Edge Expose) 방법 등이 있다.
(4) 소프트 베이크(Soft bake)
다음은 프리 베이크(Pre-bake)라고도 불리는 소프트 베이크 단계이다. 약 90~100℃ 정도에서 웨이퍼를 가열함으로써, 포토레지스트 내에 남은 20~30% 정도의 유기용매(Solvent)를 4~7%까지 제거하는 단계이다. 이로써 접착력을 향상시키고 유기용매로 인한 마스크의 오염을 방지할 수 있으며 포토레지스트의 밀도를 높여, 회전하는 동안 형성된 응력을 완화해 접착력을 강화시킬 수 있다.
(5) 정렬(Align) 및 노광(Exposure)
반도체 제조 공정은 20회 이상의 포토 공정이 반복되므로, 각각의 공정에 있어 마스크과 웨이퍼의 정밀한 정렬이 요구된다. 또한 반도체의 집적도가 올라가 패턴이 미세화됨에 따라 그 정도를 향상시킬 필요가 있다. 정렬이란 노광을 진행하기 전에, 노광 장비 내의 마스크를 이전 공정에서 형성한 패턴에 정확하게 배열하는 단계이다. 이렇게 정렬이 완료된 후에는 빛을 웨이퍼에 조사하는 노광 공정이 진행된다. 이 공정에서는 조사하는 빛의 양(Dose)을 조절하여 포토레지스트의 반응 정도를 제어한다.
일반적으로 초기의 노광 장비는 [그림 2-8]의 접촉 노광법(Contact exposure)을 적용하였고, 웨이퍼 위에 바로 마스크를 접촉시켜 육안으로 정렬(Align)해 노광하는 방식이었다. 이 경우 회절 효과가 최소화되어 고 해상도의 패턴을 얻을 수 있었으나, 마스크와 웨이퍼가 직접 접촉함으로써 이물질 문제를 비롯한 웨이퍼 및 마스크 손상 문제도 있었다. 그 후 기술이 조금 더 발전하여 마스크와 웨이퍼 간 간격을 약간 띄워 노광하는 근접 노광법(Proximity exposure)이 개발되어 사용되었다. 이로써 접촉 노광법의 문제점은 거의 해결되었지만, 노광 중 포토레지스트에서 발생한 가스로 인해 해상도 저하 및 오염 문제가 생겼고, 더불어 회절 현상 심화로 인해 해상도의 한계에 봉착하게 되었다. 이후 반사와 굴절을 이용한 투사 노광법(Projection exposure)의 노광 장비가 개발되어, 해상도는 물론 마스크의 수명 연장과 웨이퍼 사이즈의 대구경화가 본격적으로 시작될 수 있었다.
스테퍼(Stepper)는 ‘Step and Repeater’의 약어로서, 투사 노광법을 적용한 장비이다. 1970년대 중반부터 도입되기 시작하여 해상도는 물론 정렬 정밀도(Alignment accuracy)도 많이 향상되었고, 전술한 4~10 배율 마스크도 바로 이 스테퍼에서부터 사용되었다. 현재는 이를 더 개선한 스캐닝(Scanning) 방식의 스캐너(Scanner) 장비가 1990년 중반부터 사용되기 시작하였다. 스캐너는 ‘Step and Scan’ 식으로, [그림 2-9]와 같이 빛을 선의 형태로 노광시켜 마스크와 다이를 동시에 이동시키면서 패턴을 노광하는 방식이다. 이러한 원리로 렌즈의 크기를 바꾸지 않은 채 노광 영역을 확대할 수 있으며, 렌즈의 노출 영역을 조정하여 렌즈 수차6 중 작은 영역을 선택할 수 있기 때문에 스테퍼에 비해 더 정교한 회로 패턴을 확보할 수 있다.
수차6: 빛이 렌즈를 통과한 후 한 점에 모이지 않고 일그러지는 현상
(6) 노광 후 열처리(Post Exposure Bake, PEB)
노광 진행 전에 소프트 베이크가 이루어지지만, 노광 이후에 다시 베이크(Bake)를 수행하는 경우도 있다. 이를 노광 후 열처리(Post Exposure Bake, PEB)라고 하며, 노광 시의 정상파 효과(Standing wave effect)의 감소 및 노광에 의한 포토레지스트의 응력 완화, 화학 증폭형 PR(Chemical Amplification Resist, CAR)의 화학 반응 활성화 등이 목적이다. 이에 대한 상세 설명은 후술한다. 베이크 온도(< 100℃) 및 시간은 포토레지스트의 종류와 두께에 따라 다르다.
(7) 현상(Develop)
현상액(Developer) 및 세척제를 이용하여 후속 공정(식각 또는 이온 주입 공정)이 진행될 부분의 감광막(포토레지스트)을 제거하는 단계이다. 이 단계에서는 빛 에너지를 흡수한 포토레지스트가 화학 변화를 일으킴으로써 제거되고, 현상액과 포토레지스트의 상호 작용에 의해 포토레지스트의 형상과 선폭이 제어되므로 매우 중요한 단계이다. 먼저 양성 PR의 경우에는 테트라메틸 수산화암모늄(Tetramethyl Ammonium Hydroxide, TMAH), 수산화나트륨(NaOH), 수산화칼륨(KOH) 등의 염기성 수용액으로 현상 후, 초순수(De-Ionized Water, DIW)로 헹군다. 음성 PR은 현상액으로 유기용매를 사용하고, 아세트산뷰틸(N-butylacetate, C6H12) 등으로 헹궈낸다.
[그림 2-10(a)]와 같이 양성 PR은 빛이 조사된 부분(노광된 부분)에서 화학 반응이 일어나 현상을 거쳐 제거되고, 음성 PR은 그 반대이다. 이러한 음성 PR은 저렴하고, 양성 PR 대비 광 감응도가 높아 처리량(Throughput)이 높다. 또한, 현상 조건에 대한 공정 여유도가 높고, 양성 PR 대비 강도가 높아 식각 공정 등의 화학 반응에 내성이 강하다는 장점이 있다. 그러나 [그림 2-10(b)]와 같이 현상 도중 노광된 부분에 용매가 녹아 들어가 부푸는 팽윤(Swelling) 현상이 나타나, 패턴의 가장자리가 고르지 못하고 해상도에 문제가 발생한다. 따라서 2μm 이하의 패턴은 음성 PR로는 구현이 어려우므로, 현재 모든 미세 패턴의 포토 공정에서 양성 PR을 사용하고 있다.
(8) 하드 베이크(Hard bake)
현상 완료 후 고온인 100~150℃에서 열처리를 하는 공정이다. 이 과정에서 잔여 현상액 및 유기용매(Solvent)를 제거함과 동시에, 포토레지스트의 접착력을 올리고, 고분자 수지 간의 가교 결합(Crosslink)7을 증가시켜 내화학성 및 내열성을 향상시킨다. 이로 인해 식각에 대한 내성을 증가시킬 수 있다. 또한 포토레지스트의 환류(Reflow)8를 통해 포토레지스트 내 기포를 제거해 주는 역할도 한다.
가교 결합7: 이웃하는 서로 다른 선형 고분자 사슬 간의 비공유 결합으로 고분자 사슬에 연결하는 결합
환류8: 액체 또는 공기의 흐름이 방향을 바꾸어 되돌아 흐름.
(9) 현상 후 검사(After Develop Inspection, ADI)
포토 공정 후 진행되는 검사 과정으로, 주로 가장 작은 크기의 회로 선폭과 회로선 사이의 간격인 임계 치수(Critical Dimension, CD)와 층간 정렬 오차(Overlay)의 측정, 그리고 취약 패턴 형성 문제 여부, 이물질, 결함 등을 검사한다. 임계 치수(CD)의 측정은 주로 전자 주사 현미경(Scanning Electron Microscope, SEM) 장비로 진행되는데, 이때 매우 약한 전자 빔 에너지(< 1keV)로 웨이퍼 손상을 최소화할 수 있는 평면 관찰용 CD-SEM(in-Line SEM이라고도 한다) 장비를 사용한다. 포토 공정에서 측정하는 CD는 DI(Develop Inspection, 현상 검사) CD라 하고, 식각 공정 후 측정하는 CD는 FI(Final Inspection, 최종 검사) CD라 한다.
층간 정렬 오차(Overlay)는 정렬 오차 전용 장비를 사용하여 측정하고, 결함이나 이물질은 이물질 카운터(Particle counter), 광학 현미경 등을 사용하여 검사한다. 이러한 검사를 통해 나온 결과가 설정된 목표 값에 도달하지 못하면, 포토레지스트를 제거한 후 다시 포토 공정의 처음부터 작업하는 재작업(Rework)이 진행된다. 지금까지 살펴본 웨이퍼 표면 처리부터 포토 공정 후 검사까지는 연속적인 작업을 통해 진행되며, [그림 2-11]과 같이 노광 장비와 그 외 장비를 트랙(Track)화한 트랙-스테퍼-시스템(Track stepper system)을 통해 이루어진다.
4 포토레지스트(Photoresist, PR)
전술한 바와 같이 포토레지스트는 빛을 받았을 때 화학적 구조가 변화(화학 반응)하는 감광성 고분자 물질이다. 용해도에 따라 양성과 음성 PR로 분류하고, 사용하는 광원의 파장에 따라 자외선(UV)용, 원자외선(DUV)용, 극자외선(EUV)용으로 구분된다고 말한 바 있다. 주요 포토레지스트의 특성은 다음과 같다.
(1) 기본 특성
① 대조비(Contrast, γ) ([그림 2-12] 참조)
문턱 에너지(ETh): 현상 후에 포토레지스트의 잔류 여부가 결정되는 노광 에너지
- 양성 PR: 노광된 부분에 포토레지스트가 전혀 남지 않는 노광 에너지
- 음성 PR: 노광된 부분이지만, 포토레지스트가 완전히 용해될 수 있는 최소 노광 에너지
시작 에너지(E1): 문턱 에너지(ETh)에서 접선을 그어 현상 전 포토레지스트 두께의 100%와 만나는 지점에서의 노광 에너지(포토레지스트는 빛이 조사되지 않아도 일정 부분 현상액에 용해되는 특성이 있음)
대조비(Contrast, γ): 노광 에너지에 대한 노광부와 비 노광부의 용해성 차이(명암비)를 말하며, [그림 2-12] 그래프(x축 로그 스케일)의 기울기로 표현된다. 대조비가 클수록 패턴 모양이 우수하고 공정 마진도 좋다.
② 광 민감성(Sensitivity): 양성 PR의 경우는 문턱 에너지(ETh) 자체가 민감도가 되고, 음성 PR의 경우는 현상 전 포토레지스트 두께의 50%가 남는 데 필요한 노광 에너지를 말한다.
③ 식각 내성: 식각 조건을 견디는 정도를 말하며 포토레지스트의 열적 성질과 접착력, 공정 조건에 의존한다.
④ 제거의 용이성: 재작업 후나 후속 공정(식각 및 이온 주입) 진행 후 포토레지스트 제거 단계에서, 포토레지스트가 쉽게 제거될 수 있어야 한다.
⑤ 열적 안정성: 고온의 하드 베이크 시 포토레지스트의 열적 안정성이 떨어지면 포토레지스트가 흘러내리는 문제가 발생할 수 있다.
⑥ 현상 속도: 생산성에 영향을 주는 인자이나, 너무 빠를 경우 CD 바이어스9(DI CD-목표 CD)가 커져 공정 안정성이 떨어지는 등 공정 여유도가 감소한다.
CD 바이어스9: 마스크 패턴의 크기(목표 CD)에 비해 형성된 포토레지스트 패턴의 크기(DI CD)가 작은 정도를 나타냄.
⑦ 기판과의 접착력: 포토레지스트는 다양한 종류의 막에 대한 접착력이 좋아야 하며, 포토레지스트의 성분 중 고분자 수지(Resin)의 분자량이 클수록 접착력이 좋아진다.
(2) 자외선(Ultra Violet, UV)용 포토레지스트
자외선용 포토레지스트(PR)에는 전술한 바와 같이 양성 PR과 음성 PR이 있다. 각각에 대해 자세히 설명하겠지만, [그림 2-13]과 같이 양성 PR은 빛을 받으면 폴리머의 연결(Chain)이 끊겨 현상액에 잘 녹고, 음성 PR은 빛을 받으면 가교(Cross-link)에 의해 연결이 더 강해져 현상액에 용해되지 않는다. 이러한 대략의 원리를 알면, 다음 이어지는 세부 내용을 이해하는 데 도움이 될 것이다.
① 양성 PR(Positive photoresist)
g-line(λ = 436nm)과 i-line(λ = 365nm)으로 대표되는 자외선용 양성 PR은 노볼락(Novolac) 기반의 포토레지스트이다. [그림 2-14]와 같이 고분자 수지(Resin)에는 플라즈마 등에 내성이 강한 페놀계 노볼락 수지를 사용하고, 감광제(Sensitizer)로는 DNQ(Diazo-Naphtho-Quinone) 광 활성 화합물(Photo Active Compound, PAC)을 사용한다. 아세테이트형(Acetate type) 유기용매(Solvent)에 이 둘을 혼합하여 점도를 조절해 사용한다. 노볼락 수지는 빠르지는 않지만 염기성 현상액에 대체로 잘 용해되고, 광 활성 화합물인 DNQ는 노볼락 수지와 결합함으로써 염기성 현상액에 대해 용해 억제제의 역할을 한다.
그런데 이 DNQ가 [그림 2-15(a)]와 같이 자외선 빛을 받게 되면, 광화학 반응을 통해 [그림 2-14]의 광 활성부에 있는 질소(N2)가 분리되게 된다. 그리고 그 자리는 반응성이 매우 높은 사이트가 되어 주위의 카보닐기(C = O) 사이에 들어가면서 오각형의 탄소 고리로 바뀌는 Wolff 재배열을 한다. 그 후 H2O와 반응하여 COOH의 카르복실산(Carboxylic acid)으로 바뀌게 되는데, 이는 산성이므로 염기성인 현상액(TMAH10 등)에 잘 용해된다. 이러한 반응 과정을 이해하기 쉽게 [그림 2-15(b)]에 도시하였다. 노볼락 수지는 전술한 바와 같이 염기성 현상액에 비교적 양호하게 용해되지만, DNQ와 혼합되면 용해도가 매우 낮아진다. 하지만 빛에 의해 광분해되어 카르복실산으로 바뀌면, 용해도가 매우 높아져 현상이 잘 되게 된다.
TMAH10: 테트라메틸 수산화암모늄(Tetramethyl Ammonium Hydroxide)
앞서 설명한 현상 후 열처리(PEB) 단계의 목적 중에 정상파 현상(Standing wave)의 감소가 있다고 언급한 바 있다. 정상파 현상이란 [그림 2-16(a)]와 같이 ‘포토레지스트를 통해 아래로 이동하는 빛의 평면파’와 ‘기판으로부터 반사되는 파동’ 사이의 간섭으로 인해, 포토레지스트의 깊이 방향으로 노광 과다(Over exposure) 및 노광 부족(Under exposure) 현상이 반복되면서 발생한다. 그 결과 포토레지스트 측벽에 주기적인 물결 무늬를 보이는 정상파 현상을 보이는 것이다. 노볼락-DNQ 포토레지스트의 경우는 노광 후 열처리(PEB) 단계에서 유리 전이 온도(Glass transition temperature, Tg) 이상의 열처리를 해주었을 때, [그림 2-16(b)]와 같이 포토레지스트 내 광 활성 화합물(Photo Active Compound, PAC)의 확산이 일어나 정상파 현상을 완화시키고, 노광 경계면에서의 물결 무늬가 개선된다. 이러한 정상파 효과는 후술할 반사 방지 코팅(Anti-Reflective Coating, ARC)으로도 완화가 가능하다.
② 음성 PR(Negative photoresist)
음성 PR은 매우 큰 분자량을 갖는 고분자 폴리머로, 가교 PR(Cross-linking PR)이라고도 한다. 양성 PR과 마찬가지로, 고분자 수지(Resin)와 광 감응 가교제(Photosensitive cross-linking agent), 방향족 유기용매(Aromatic solvent)로 구성된다. 고분자 수지에는 Cyclized synthetic rubber resin과 같은 폴리이소플렌 레진을 사용하고, 광 활성 화합물(PAC)에는 Bis-arylzide 등이 사용된다. 자외선을 받으면 인접한 중합체 간의 결합 또는 가교 결합에 의해 3차원적 분자 결합을 하게 되므로, 분자량이 커지게 된다. 이러한 가교 결합에 의한 중합체는 화학적 내성이 우수하여 양성 PR 대비 내식각성이 높은 PR이다.
(3) 원자외선(Deep Ultra Violet, DUV)용 포토레지스트
KrF(λ = 248nm) 혹은 ArF(λ = 193nm)와 같은 단파장의 원적외선(DUV) 광은 i-line과 같은 자외선(UV)광의 광원인 수은램프의 빛의 감도보다 낮고, 자외선용 PR에 흡수되어 버린다. 그 결과 빛 감응도가 저하되는 문제가 발생하였고, 새로운 물질의 포토레지스트인 화학 증폭형 PR(Chemical Amplification Resist, CAR)이 등장하게 되었다. 화학 증폭형 PR(CAR)은 [그림 2-17(a)]와 같이 고분자 수지 사슬(Polymer chain)과 산 변성 방지 기능 그룹(Functional group), 광-산 발생제(Photo-Acid Generator, PAG), 용매로 구성되어 있다. 각각의 역할은 다음과 같다.
산 변성 방지 기능 그룹(Functional group): 포토레지스트가 염기성 현상액에 용해되지 못하게 보호하는 역할을 한다.
광-산 발생제(Photo-Acid Generator, PAG): 빛에 의해 산을 만들어 내는 역할을 한다.
용매(Solvent): 산 변성 방지 기능 그룹과 광-산 발생제(PAG)를 용해시켜 액상으로 만드는 역할을 한다.
화학 증폭형 PR(CAR)에 일차적으로 노광이 되면 광-산 발생제(PAG)가 소수의 산(Proton, H+)을 발생시킨다. 그 후 노광 후 열처리(Post Exposure Bake, PEB) 단계에서 노광에 의해 발생한 산(H+)이 불용성인 산 변성 방지 기능 그룹을 용해성(Soluble)으로 바꾸면서 다시 산(H+)이 발생한다. 발생한 산(H+)은 계속해서 산 변성 방지 기능 그룹을 용해성으로 바꾸게 되는 연쇄 반응을 일으키고, 산(H+) 발생의 증폭 작용이 일어나 일정 시간 후에 불용성 그룹이 전체적으로 용해성 그룹으로 바뀌게 된다. 그 결과 염기성 현상액에 용해되어 현상 공정이 가능해지는 원리이다. [그림 2-17(b)]에는 이러한 화학 증폭형 PR(CAR)의 반응 원리를 도시하였다. 원리적으로 단지 한 개의 산(H+)이 산 촉매 씨앗(Seed for acid catalyst)으로서 필요하고, 이것이 노광 후 열처리(PEB) 과정에서 나머지 모든 반응을 일으키는 촉매 연쇄 반응이라 할 수 있다. 재현성 있는 결과를 얻기 위해서는 노광 후 열처리(PEB) 공정의 정확한 온도 제어가 필요하다.
지금까지 설명한 화학 증폭형 PR(CAR)은 파장이 248nm인 KrF 광원에서는 사용이 가능하지만, ArF(λ = 193nm)의 포토레지스트로는 사용할 수 없다. 이는 화학 증폭형 PR(CAR)의 방향성 고리 구조가 식각 내성은 우수한 반면, 193nm에서 - 전이를 하여 빛을 흡수하기 때문이다. 따라서 193nm용 포토레지스트의 고분자 유형은 KrF용과 다르게, Polymethacrylates, Polycyclic olefin, Polycyclicolefin-co-maleic anhydride(COMA), Polyvinylether-co-maleic anhydride(VEMA) 등을 이용하고 있다. 지금까지 설명한 화학 증폭형 PR(CAR)은 양성 PR에 관한 것이지만, 자외선용과 마찬가지로 음성 PR도 존재한다. 하지만 사용 빈도가 낮아 설명은 생략하겠다.
5 노광(Exposure) 공정
노광 공정은 빛의 회절, 굴절, 간섭 등의 특성을 이용하여 마스크 상의 정보를 웨이퍼의 포토레지스트에 전사하는 과정이다. 회절은 대표적인 파동 현상 중의 하나로, 음파나 전파, 광파 등이 장애물이나 좁은 틈을 통과할 때 파동이 그 뒤편까지 전파되는 현상을 말한다.
이러한 현상은 [그림 2-18(a)]와 같이 파장이 길수록 또는 틈(Slit)의 폭이 좁을수록, 회절 각도가 커져 회절이 심하게 나타난다. 기초 물리학의 영(Young)의 이중 슬릿 실험 결과를 노광 원리에 적용해 보면, 마스크 상의 두 개의 슬릿에서 회절된 빛은 경로차(Psinθ1)가 발생하고 이 값이 파장의 정수배(nλ)가 되면 보강간섭이 일어나 빛의 세기가 강한 이미지를 얻을 수 있다. 이는 다음 식과 같이 나타낼 수 있으며, 빛이 퍼지는 회절각이 마스크 패턴의 피치에 반비례하고 파장에 비례함을 알 수 있고, 이로써 앞서 언급한 회절각과 슬릿의 크기, 광원의 파장과의 관계를 다시 한 번 확인할 수 있다.
(P: 마스크 내 패턴의 피치(크기)11, θ1: 1차 회절각)
피치11: 폭과 간격
[그림 2-18(b)]와 같이 슬릿의 중심부를 통과하는 0차광과 비스듬하게 입사하는 1차광은 상호 간섭에 의해 보강간섭을 일으켜 이미지가 형성된다. 따라서 [그림 2-18(c)]와 같이 슬릿의 피치, 즉 슬릿이 클 경우는 높은 차수의 회절광이 간섭에 참여하여 마스크 상의 패턴에 가까운 양호한 결과를 얻을 수 있지만, 슬릿의 크기가 감소할수록 회절된 광이 렌즈 바깥으로 모두 빠져나가는 경우가 많아진다. 즉, 반 피치가 되면 0차광만이 입사되어 웨이퍼 상에 아무런 상도 맺지 못하게 된다. 반도체 소자의 미세화가 진행됨에 따라 마스크 상 슬릿의 피치는 계속 감소하고 있고, 회절 현상은 더욱 심화되고 있다. 이에 대응하기 위해서 [그림 2-18(d)]와 같이 ① 광원의 파장(λ)을 감소시키거나 ② 회절각(θ)을 줄이고, 또는 ③ 퍼져 나가는 회절광을 통과시킬 수 있는 대구경의 렌즈(NA)가 필요하게 되었다. 후술하겠지만, 렌즈의 크기에 해당하는 것은 렌즈의 개구수(Numerical Aperture, NA)이다. 한편, 노광 공정에서 가장 중요한 파라미터는 해상도(Resolution)와 초점 심도(Depth Of Focus, DOF)이므로, 지금부터는 이 내용에 대해 다뤄보도록 하겠다.
(1) 해상도(Resolution, R)
해상도란 웨이퍼 상에 전사 가능한 최소 패턴 크기로 정의할 수 있고, 분해능이라고도 한다. 따라서 해상도는 그 값이 작을수록 해상도가 양호하다는 의미이다. 전술한 바와 같이 해상도를 개선하기 위해서는 회절 현상을 감소시키거나 회절되어 흩어지는 빛을 렌즈에 담을 수 있도록 대구경의 렌즈를 사용하여야 한다. 이때 렌즈의 크기에 해당하는 개구수(NA)는 [그림 2-19]와 같이 렌즈를 통과하여 θ 각도로 웨이퍼로 입사되는 빛에 대해 nsinθ로 정의된다. 슬릿의 크기에 비해 렌즈와 웨이퍼 간의 거리가 멀어 θ가 매우 작을 경우에는 sinθ = tanθ가 되어 개구수(NA)가 r/F로 근사하게 된다. 개구수(NA)는 렌즈의 반경(r)에 비례하므로 개구수(NA)와 렌즈 크기의 관련성을 확인할 수 있다. 여기서 n은 렌즈와 웨이퍼 사이의 매질의 굴절율로, 공기일 경우는 1, 초순수(DIW)를 매질로 하는 불화아르곤(ArF) 액침 노광(Immersion)의 경우는 1.44이다. 이러한 차이는 매질에 따라 웨이퍼로의 입사각 θ가 달라지기 때문이다.
이상의 결과를 종합해보면 해상도는 파장에 비례하고, 개구수(NA = nsinθ)에 반비례하며, 그 비례 상수를 k1으로 하는 해상도에 대한 레일레이(Rayleigh) 공식으로 정리할 수 있다. 여기서 k1은 공정 인자(Factor)로, 광원의 파장이나 개구수(NA) 외에 해상도에 영향을 줄 수 있는 공정 방식 또는 각 반도체 업체의 공정 기술 수준에 따라 달라지는 공정 상수를 말한다.
(2) 초점 심도(Depth Of Focus, DOF)
초점 심도는 렌즈의 초점으로부터 몇 nm의 단차(Focus) 범위까지 유효한 상을 얻을 수 있는가를 나타내는 척도이다. 좀 더 상세히 설명하면, 상이 뚜렷하게 보이는 최적 초점 위치를 기준으로 +/-의 초점 변화를 주었을 때, 임계 치수(CD)나 패턴의 형상, 포토레지스트의 측면 프로파일 등의 포토 공정 평가 인자들이 우리가 허용할 수 있는 수준 이내에 있을 때의 범위를 초점 심도라고 한다. 이를 수식으로 나타내면 [그림 2-20]의 공식과 같이 나타낼 수 있으며, 이는 허용 해상도(R)와 이에 따른 초점 심도(DOF)의 절반인 Δz의 관계로부터 쉽게 유도된다.
초점 심도(DOF)는 그 값이 크면 클수록 초점 심도의 여유가 있다는 의미이다. 그런데 앞의 해상도에 대한 레일레이(Rayleigh) 공식과 초점 심도(DOF) 공식을 비교해 보면, 서로 트레이드 오프 관계에 있음을 알 수 있다. 다시 말해 파장을 줄이면 해상도가 감소하여 유리하지만, 초점 심도(DOF)의 여유도가 줄어 불리해진다. 마찬가지로 개구수(NA), 즉 렌즈의 크기를 크게 하면 해상도는 좋아지지만 초점 심도(DOF)는 나빠진다. 특히, 개구수(NA)는 초점 심도(DOF)의 경우, 제곱에 반비례하므로 해상도의 개선 시 많이 고려해야 할 사항이다. [그림 2-21]에 개구수(NA)의 차이, 즉 렌즈의 크기에 따른 초점 심도(DOF) 여유도의 차이를 도시하였다. 후술할 해상도 개선 기술 절에서 설명하겠지만 초점 심도(DOF)와 해상도를 동시에 개선할 수 있는 기술이 있기는 하나, 소자가 미세화됨에 따라 포토 공정 또는 장비에서 해상도와 초점 심도(DOF)를 모두 개선하기에는 많은 어려움이 따른다. 이에 포토 공정 전 웨이퍼의 단차를 최소화하여 초점 심도(DOF) 여유도를 개선하는 방법이 사용되고 있는데, 이것이 바로 화학적 기계적 연마(Chemical Mechanical Polishing, CMP) 공정이다.
6 해상도 개선 기술(Resolution Enhancement Technology, RET)
해상도는 사용하는 광원의 파장이 짧을수록, 그리고 개구수(NA)가 클수록(즉, 렌즈의 크기가 클수록) 개선되며, 공정 상수인 k1의 감소 또한 중요한 인자라 할 수 있다.
(1) 광원의 단파장화
노광 공정과 장비의 발전은 노광 광원의 단파장화의 역사라 해도 과언이 아니다. [그림 2-22]와 같이 1980~1990년대에는 수은램프(자외선)인 g-line(λ = 436nm)과 i-line(λ = 365nm)을 사용하여, ~250nm 수준의 패터닝이 가능했다. 하지만 수은램프는 빛의 세기가 매우 강하여 균일도 문제가 있었고, 다파장을 가져 특정 파장의 빛을 선별하는 과정이 필요하다. 그 후 1990년 중반에서 현재까지는 248nm의 KrF와 193nm의 ArF 엑시머 레이저(Excimer laser)에 의한 원자외선(Deep UV) 광원을 사용하고 있으며, 여기에 다양한 해상도 개선 기술(Resolution Enhancement Technology)을 병행하여 20nm 기술 노드 영역까지 발전하게 되었다. 엑시머(Excimer)란 Excited dimer의 줄임 말이며, 레이저로 사용 중인 엑시머에는 KrF, ArF, XeCl 등이 있다. 이 엑시머는 불활성(Nobel) 가스와 반응성이 강한 할로겐(Halogen) 가스로 구성되어 있어 정상 상태에서는 분자를 이룰 수 없지만, 순간적으로 많은 에너지를 가해 여기된 상태의 엑시머는 급속히 분리되어 안정된 상태로 되돌아가려고 한다. 이 과정에서 가지고 있던 에너지를 빛 형태로 방출하고, 연속적이 아닌 펄스 형태로 특정 파장의 빛이 방출된다. 한편, 앞서 언급한 내용이지만, 일부 첨단 7nm 이하의 로직(Logic) 공정에서는 13.5nm의 파장을 가진 극자외선(Extreme UV, EUV) 광원을 적용하고 있다. EUV에 대해서는 별도로 상세 설명한다.
(2) 불화 아르곤 액침 노광(ArF Immersion Lithography)
해상도에 대한 레일레이 공식(R = k1·(λ/NA))에서 개구수(NA)와 관련된 내용이다. 전술한 바와 같이 개구수(NA)를 증가시키는 것은 물리적으로 렌즈의 크기를 키워 회절각이 큰 빛을 렌즈 안으로 받아들이기 위함이다. 액침 노광은 [그림 2-23]과 같이 프로젝션 렌즈와 웨이퍼 사이에, 공기가 아닌 초순수(DIW)를 넣어 ArF 광의 공기 대비 높은 굴절율을 이용한 것이다. 렌즈와 웨이퍼 사이에 들어갈 매질의 요건에는 첫째, 굴절률이 공기의 굴절율인 1보다 클 것, 둘째, 193nm ArF 광원에서 낮은 광 흡수율을 보일 것, 셋째, 포토레지스트 및 렌즈 재료와 호환 가능할 것, 넷째, 균일하고 오염이 없을 것 등이 있다. 이와 같은 요건에 잘 부합하는 것이 바로 초순수(DIW)이다.
고순도의 물, 즉 초순수는 굴절률이 ArF 광원에 대해 ~1.44 정도이고 광 흡수율이 5% 아래이며, 포토레지스트나 렌즈와 잘 호환된다. 순수이기 때문에 상대적으로 오염이 적은 물질이기도 하다. 그러나 웨이퍼와 렌즈 사이에 물이 지속적으로 순환되어야 하고, 굴절률이 온도에 따라 변할 수 있으므로 일정한 온도 유지가 필요하다. 또 기포가 없어야 하며, 포토레지스트로부터의 용출이 최소화되도록 주의해야 한다. 한편, 개구수에 대한 식(NA = nsinθ)에서 굴절율이 1에서 1.44로 높아진다고 하여 개구수(NA)가 증가하는 것은 아니다. 스넬의 법칙(Snell’s law)에 의하면 굴절율이 증가했을 때 θ가 감소하여 개구수(NA)에는 차이가 없기 때문이다. 따라서 동일 광학 시스템에서는 해상도의 개선이 없고, [그림 2-24(a)]와 같이 θ 감소에 따른 DOF 여유도 개선만 있을 뿐이다.
[그림 2-24(b)]와 같이 입사 물질(렌즈, n~1.56)에서 매질(공기 n~1 or 물 n~1.44)로 빛이 이동할 때에는 렌즈와의 굴절율 차이가 작은 물의 전반사가 일어나는 임계각이 더 커지므로, 더욱 큰 구경(HighNA)의렌즈를 사용할 수 있다. 공기를 사용할 때는 같은 임계각에서 전반사가 일어나 렌즈 가장자리로 들어오는 빛이 들어오지 못하게 되기 때문이다. 결국 이러한 높은 개구수(NA)의 사용으로 38nm 정도의 미세 패턴을 확보할 수 있게 되었다. 물론 동일한 원리로 물 이외 오일(Oil)과 같은 물질을 사용하면 굴절율이 물보다 더 커져 효과가 좋을 수 있으나, 렌즈나 웨이퍼의 오염 문제와 같이 다른 여러 매질의 요건에 맞지 않기 때문에 사용하지 않는다.
심화개념 |
액침 노광에 있어 문제점은 물이 포토레지스트와 렌즈에 물리적으로 직접 접촉한다는 것이다. 최근 렌즈는 CaF2 등의 유리 재질로 만들어지므로, 아주 짧은 시간 동안 노출이 되지만 그 사이에 표면이 식각되어 거칠어질 수가 있다. 이 때문에 렌즈에 투명한 물질을 코팅(Coating)하기도 한다. 또한 [그림 2-25(a)]와 같이 포토레지스트 내의 광-산 발생제(PAG) 또는 첨가제 일부가 용매에 용해되어 렌즈 및 패턴의 오염 또는 포토레지스트 표면에 물방울 결함 등을 일으킬 우려가 있다. 이에 대한 대응책으로는 [그림 2-25(b)]와 같이 물과의 반응을 억제하기 위해, 포토레지스트 위에 ArF 광원에 투광도가 좋은 Cyclic fluorine 및 Acrylate 계열을 사용하여 박막을 코팅하는 Topcoat 방법이 도입되어 사용 중에 있다. 이때 Topcoat층의 제거를 위한 불소치환 시너(Thinner)가 필요하게 되었고, 이로 인해 상승된 원가의 절감 및 공정 시간 단축을 위한 Topcoat-less PR도 제안되어 사용 중에 있는 것으로 알려져 있다. Topcoat-less PR은 ArF용 포토레지스트와 구조상 유사하나, 포토레지스트 용제에 소수성 첨가제(플루오린 폴리머 등)를 추가한 차이가 있다. |
(3) 공정 상수(k1-parameter) 감소
다음은 해상도 개선을 위해, 레일레이 공식(R = k1·(λ/NA))의 공정 상수(k1 -parameter)를 감소시키는 기술에 대해 소개한다. [그림 2-26]과 같이 노광 시스템과 마스크, 웨이퍼 및 포토레지스트에 따라 다양한 방식이 사용되고 있다.
① 비 등축 조명 노광(Off Axis Illumination, OAI)
마스크의 패턴을 웨이퍼에 전사하기 위해서는 패턴의 정보를 담고 있는 최소 ±1차광이라도 가능한 한 렌즈 내부에 많이 들어가도록 해야 한다. 기존 조명계에서는 패턴이 미세화됨에 따라 마스크에 의한 회절각이 커져 ±1차광이 렌즈 밖으로 빠져 나가는 문제가 있었다. 이를 개선하기 위해서는 광축을 마스크에 대해 경사지게 입사시켜 회절각이 커지더라도 1차광이 렌즈 내로 들어갈 수 있도록 하는 비 등축 조명이 필요하다. 이는 변형조명 혹은 사입사 조명이라고도 한다.
구체적으로, 빛을 경사지게 입사시키는 방법은 [그림 2-27]과 같이 광축이 수직인 기존의 원형 조명 조리개(Illumination aperture)에서 윤대(Annular) 또는 4공(Quadruple) 조리개로 교체하여 광축을 경사지게 하는 방법이다. 이때 +1차광은 렌즈의 범위를 벗어나지만, 0차광과 -1차광이 렌즈 내로 들어와 이미지가 형성되므로, 이론상 개구수(NA)를 거의 2배 키울 수 있는 효과를 낸다. 또 웨이퍼 쪽으로 입사되는 광의 각도가 감소하면서 초점 심도(DOF) 여유도 또한 개선되는 방식이다. 이에 대한 부작용으로는 45° 패턴의 형성이 어렵고, 패턴의 변형, 렌즈 가장자리의 수차 문제, 패턴 이동(Shift) 문제가 발생될 소지가 있어 주의를 요한다.
② 위상 반전 마스크(Phase Shift Mask, PSM)
[그림 2-28(a)]와 같이 특별한 처리를 하지 않은 석영(Quartz)과 크롬(Cr)으로만 구성된 일반적인 마스크를 이진 마스크(Binary mask)라 한다. 이진 마스크는 패턴이 미세화됨에 따라 차광막으로서의 역할을 못하게 된다. 즉, 크롬 패턴 양쪽의 석영을 통해 들어온 빛이 상호간섭을 일으켜, 서로 보강간섭을 하고, 이에 따라 차광되어야 할 부분까지 노광되어 [그림 2-28(a)]의 최종 패턴과 같아진다. 즉, 마스크를 지난 전기장(E)이 웨이퍼에 도달했을 때 회절과 보강간섭에 의해 그 최저 세기가 0이 되지 못하고, 마스크 상의 패턴이 웨이퍼에 그대로 전사되지 못하는 해상도의 한계라는 결과를 가져온다.
이러한 문제를 마스크 차원에서 개선한 기술이 바로 [그림 2-28(b)]와 같은 위상 반전 마스크(Phase Shift Mask, PSM)이다. 위상 반전 마스크(PSM)는 기존의 일반 마스크 기판에 위상 반전층을 형성하여, 이 부분을 투과한 빛의 위상(Phase)을 반전 혹은 변이시킴으로써 해상도를 높이고자 한 것이다. 이 마스크를 통과할 때 위상 반전층을 투과한 빛과 위상 반전층이 없는 부위를 투과한 빛은 서로 다른 광학 경로를 거치게 되고, 이때 180°의 위상차가 나도록 하면 패턴의 경계부에서는 상쇄간섭이 일어나 이진 마스크에서의 문제를 개선할 수 있다. 단, 제조 공정이 다소 복잡하고 이진 마스크 대비 불량율이 높아 단가가 높다는 단점이 있다.
③ 광 근접 보정(Optical Proximity Correction)
광 근접 보정은 포토 공정 후에 왜곡이 일어날 것으로 예상되는 취약 부분에 대해, 경험이나 컴퓨터 시뮬레이션(Simulation)을 이용하여 보강 패턴을 추가시킨 마스크를 사용하는 기법을 말한다. 예를 들어 [그림 2-29]와 같이 광 근접 보정(OPC)을 하지 않은 경우, 패턴의 밀도나 주위 패턴의 영향을 받아 빛의 집중 및 산란이 일어나고, 원하는 모양대로 패터닝이 이루어지지 않는다. 이러한 주변 영향들을 고려하여 의도한 설계 평면도와 유사한 패턴이 만들어지도록 설계 평면도를 보정하는 것이 광 근접 보정(OPC) 기법이다. 광 근접 보정(OPC) 기법은 정확한 패턴을 구현할 수 있다는 장점은 있지만, 작업 자체 및 마스크 제작에 필요한 시간과 비용에 의해 원가 상승의 요인이 될 수도 있다.
④반사 방지층 코팅(Anti-Reflective Coating, ARC)
[그림 2-30(a)] 및 [그림 2-30(b)]와 같이, 노광 시에는 다양한 층(Layer)에서 빛의 반사가 일어나 빛의 산란과 집중이 일어난다. 이로서 노칭(Notching)12 등에 의해 임계 치수(CD) 불균일과 해상도, 초점 심도(DOF), PR 프로파일 등의 문제가 생기거나, 앞서 설명한 입사광과 반사광이 서로 결합해 정상파를 형성함으로써 PR 프로파일 이상을 초래하는 정상파 효과(Standing wave effect)가 발생한다. 특히 높은 반사 특성을 보이는 원자외선(DUV) 포토레지스트의 경우는 더욱 문제가 될 수 있다. 그래서 지금부터는 이러한 문제를 개선하기 위해 적용하는 반사 방지층 코팅(Anti-Reflection Coating, ARC)에 대해 알아보도록 한다.
[그림 2-30(a)]와 같이, 노광에 의한 입사광은 포토레지스트/기판의 계면(IR2)뿐만 아니라 공기/포토레지스트의 계면(IR1) 모두에서 부분적으로 반사된다. 이렇게 두 개의 반사된 빛의 경로 차이가 광원 파장의 정수배인 경우에는, 보강간섭이 일어나 최대 강도로 반사시키게 된다. 이때 만약 반 파장(λ/2)만 경로 차이를 변경하면 상쇄간섭에 의한 전체 반사율을 최소화시킬 수 있다. 이러한 문제를 완화시키는 방법에는 포토레지스트의 하단에 반사 방지층 코팅(ARC)을 위치시키는 BARC(Bottom ARC)와 포토레지스트의 상단에 반사 방지층 코팅(ARC)을 위치시키는 TARC(Top ARC)의 두 가지가 있다. 먼저 BARC의 목적은 [그림 2-31]과 같이 웨이퍼 표면으로부터 반사되는 노광 광원의 반사광을 제거하기 위한 것이며, 무기 재료 BARC와 유기 재료 BARC로 나눌 수 있다. 무기 재료 BARC는 SiON:H 성분의 무기 재료를 사용하여 계면에서의 반사파를 상쇄간섭에 의해 제거하고 반사광을 최소화하는 방식인 반면, 유기 재료 BARC는 유기 재료를 사용해 계면에서 반사파를 흡수한다. 무기 재료 BARC의 경우 화학 기상 증착(Chemical Vapor Deposition, CVD)을 통해 증착이 이루어지므로, 피복성이 우수하고 일부 식각 시 마스킹 역할도 할 수 있다는 장점이 있지만, 공정 진행 후 제거가 어렵다는 단점이 있다. 반대로 유기 재료 BARC는 회전 도포(Spin coating) 및 가교 형성을 위한 열처리(Bake)에 의해 생성되므로 피복성에 다소 문제가 있으나, 산소 플라즈마를 통한 애싱(Ashing)13 과정에서 제거가 용이하다는 특징이 있다. 유기 재료 BARC는 포토레지스트 제거 시 하부 패턴의 골진 부분에 있는 BARC를 제거해야 하므로, 포토레지스트보다 식각 속도가 빨라야 하고, 포토레지스트와의 상호 혼합(Inter-mixing)도 없어야 한다.
애싱13: 포토레지스트를 제거하는 과정
다음은 TARC에 대해 설명한다. TARC의 기본 개념은 [그림 2-32]와 같이 적정한 굴절율을 갖는 재료를 포토레지스트 위에 코팅함으로써, TARC와 포토레지스트 사이에서 반사된 빛(IR1)과, 포토레지스트와 웨이퍼 계면에서 반사되어 나오는 빛(IR2)을 간섭시켜 반사광을 소멸시키는 것을 목적으로 한다.
일반적으로 TARC는 굴절율이 낮은 불소계 고분자(Polymer)가 주종을 이루고 있으나, TARC 역시 BARC와 동일하게 포토레지스트와의 상호 혼합이 없어야 하므로 수용성 고분자를 기본으로 하고 있다. TARC는 현상 공정에서 포토레지스트와 함께 제거된다. 이 외에도 금속, 특히 알루미늄(Al)의 포토 공정 시, 알루미늄 기판에서의 산란 및 반사 문제가 커 반사율이 낮은 티타늄 질화막(TiN)을 TARC 기능으로 이용하는 경우도 있다.
(4) 다중 패터닝(Multi-patterning)
앞서 살펴본 포토 공정에서의 해상도 개선 기술을 사용하면 노광 장비 및 광원의 파장에 따라 50~100nm 정도의 해상도 개선 효과를 볼 수 있다. 현재는 ~30nm 이하의 미세 패턴을 확보하기 위해, 포토 공정 외 식각이나 증착 및 화학적 기계적 연마(CMP) 공정의 도움을 받는 다양한 다중 패터닝 기술이 개발되어 사용 중에 있다.
① 이중 패터닝(Double patterning)
메모리 소자의 일부 패턴에도 적용되지만, 이중 패터닝 공정은 주로 패턴이 불규칙한 로직(Logic)제품에 사용된다. [그림 2-33(a)]와 같이 한 층(Layer)의 패터닝을 위해 두 개의 마스크를 2회에 걸쳐 사용함으로써, 미세 패터닝의 부담을 경감시키는 방식이다.
이중 패터닝 기술의 방법은 [그림 2-33(b)]와 같이 첫 번째 마스크로 노광 및 현상한 후, 포토레지스트를 블로킹(Blocking)막으로 하여 하드 마스크14를 식각한다. 그리고 두 번째 마스크를 이용해 2차 노광 및 현상 후 하드 마스크를 식각하고 포토레지스트를 제거해낸다. 그 후 1, 2차 포토 공정을 통해 형성된 하드 마스크를 블로킹(Blocking)막으로 하여, 식각하고자 하는 피 식각층(소자층)을 제거함으로써 패터닝이 종료된다. 이와 같이 포토 및 식각 공정을 각각 2회씩 진행하는 공정을 이중 패터닝(Double patterning) 또는 Litho-Etch-Litho-Etch(LELE) 방식이라 한다. 이는 노광 시 정밀한 정렬 오차 제어가 필수적이고, 노광 또는 식각 공정을 2회 진행하여야 하므로, 장비 투자 및 공정 시간, 원료 등 원가 상승의 큰 요인이 된다. 매우 미세한 패턴의 경우에는 LE를 3~4회까지 진행하기도 한다.
하드 마스크(Hard Mask, HM)14: 반도체의 미세 공정에서 패턴 붕괴를 방지하기 위한 재료로서, 포토 마스크의 패턴을 전사하는 데 쓰이는 보조 재료임. 식각 공정 단원을 참고
② 자기 정렬 2중/4중 패터닝(SADP, SAQP)
메모리 소자, 특히 메모리 셀 어레이(Cell array)와 같이 패턴이 규칙적인 경우에는 자기 정렬 2중 패터닝(Self-Aligned Double Patterning, SADP) 또는 자기 정렬 4중 패터닝(Self-Aligned Quadruple Patterning, SAQP) 기법을 사용한다. 자기 정렬 2중 패터닝(SADP)을 진행하면 처음 포토 공정에서 패터닝한 1피치(Pitch) 패턴에서
공정 순서는 [그림 2-34]의 예를 기준으로 설명하겠다. 우선 기판 위에 피 식각막인 다결정 실리콘(Poly-Si)이 증착되어 있고, 그 위에는 하드 마스크(Hard Mask)로서 실리콘 질화막(SiN)층이 덮여 있는 상태이다. ① 먼저 마스크의 패턴 피치를 정해야 한다. 만약 최종 목표로 하는 패터닝이 자기 정렬 2중 패터닝(SADP)에 의해 최종 피치를 얻는다면 최종 패턴 피치의 2배, 자기 정렬 4중 패터닝(SAQP)이라면 4배의 피치를 갖는 마스크를 이용하여 포토 공정을 진행해 포토레지스트 패턴을 얻는다(본 예에서는 SAQP이므로 4배의 피치). 다음 ② 원자층 증착(Atomic Layer Depostion, ALD), 특히 저온 플라즈마 증속 원자층 증착(Plasma Enhamced ALD, PE-ALD) 공정을 통해, 얇고 피복성이 좋은 실리콘 산화막(SiO2)을 증착한다. 그리고 ③ 반응성 이온 식각(Reactive ion etch) 공정 등을 이용해 ALD SiO2를 비등방성 식각하여 포토레지스트 측벽에 SiO2 스페이서(Spacer)를 형성한다. 이때 포토레지스트의 폭과 포토레지스트 측벽에 증착된 ALD SiO2 스페이서의 한 쪽 측면 두께의 합이 자기 정렬 2중 패터닝(SADP) 후의 피치(=
7 최신 포토 공정 기술 - 극자외선(EUV) 포토 공정
전술한 다중 패터닝 공정을 이용해 포토 공정 해상도의 한계를 넘어 미세 패턴의 공정을 진행하고는 있으나, 다중 패터닝 공정을 적용해야 하는 층(Layer)수가 지속적으로 증가함에 따라 [그림 2-35]와 같이 증착, 식각 등의 추가 공정에 대한 원가 상승 및 공정 시간 증가 문제가 발생하였다. 이에, 다시 포토 공정에서 해상도를 개선하는 포토 단일 스텝(Single step)에 대한 요구가 점차 증가하게 되었고, 최근 7nm 이하 로직 공정에서 극자외선(Extreme Ultra Violet, EUV) 포토 공정을 적용하기 시작하였다. 현재는 로직 공정에만 적용 중이나, 향후 DRAM(1z 또는 1a 이후)을 비롯한 메모리 분야에도 적용 검토 중에 있다. 하지만 EUV 노광 장비는 아직까지 네덜란드의 A사만이 생산, 판매가 가능한 매우 고가의 장비이며, 비단 본 장비뿐만 아니라 EUV 관련 포토레지스트, 마스크, 검사 등 관련 전후방의 소재, 부품 기술도 아직까지 100% 성숙된 기술은 아니다. 따라서 지속적인 개발과 개선이 필요한 분야이다.
그림 2-35 노광 광원의 발전 및 EUV 도입 이유
(a) 노광 광원의 발전

EUV 대비 | LELE | SADP | SAQP |
공정 스텝 수 | X2 | X4 | X5 |
공정 원가 | +10% | +30~50% | > +50% |
TAT | X2 | X4 | X5 |
※TAT(Turn around time): 웨이퍼의 투입부터 최종 공정 완료까지 걸리는 공정 시간
(b) EUV 도입에 의한 생산 단가 저감
(1) EUV 광원
[그림 2-35]와 같이 극자외선(EUV)의 파장은 13.5nm로, 193nm의 ArF 대비 매우 파격적으로 파장이 감소된 것이다. 157nm의 F2 레이저 광원이 ArF 후속 광원으로 연구되었으나, 렌즈나 공기에 잘 흡수되고, 액침 노광을 쓸 경우에는 PFPE라는 오일 성분의 물질을 사용해야 하는 등 단점이 많았다. 게다가 ArF 대비 큰 성능의 개선점이 없어 바로 EUV로 전환되었던 것이다. 한편 엑시머 레이저를 사용하는 원자외선(DUV)과는 달리, 13.5nm 파장의 극자외선은 [그림 2-36(a)]와 같이 고밀도 플라즈마 상태에서의 원자 내 전자(Sn20+)의 여기(Excitation) 및 이완(Relaxation)에 의해서만 생성될 수 있다. 고출력의 CO2 레이저가 주석(Sn) 액적(주석 방울)에 충돌하여 고온, 고밀도의 플라즈마가 형성되어 극 자외선(EUV)이 발생하는 것이다. 극자외선(EUV)은 타원형의 다층 코팅 컬렉터에 의해 수집되어 스캐너의 반사 광학 장치로 전달된다. 이러한 EUV 광원의 발생 방식을 플라즈마 생성 레이저(Laser Produced Plasma, LPP) 방식이라 한다.
[그림 2-36(b)]와 같이 극자외선(EUV)은 짧은 파장으로 인해 ~93eV의 높은 광자(Photon) 에너지를 갖게 되므로, 공기를 포함한 모든 물질에 잘 흡수된다. 따라서 극자외선(EUV) 시스템의 챔버는 고 진공 상태로 유지되어야 한다.
(2) EUV 광학계
전술한 바와 같이 극자외선(EUV)의 높은 광자(Photon) 에너지 때문에 지금까지 사용되던 투과 또는 굴절형 광학계는 극자외선(EUV)광을 흡수하므로, 사용할 수가 없다. 따라서 모든 광학 렌즈는 [그림 2-37]과 같은 반사형 렌즈를 사용하는데, 이 경우에도 극자외선(EUV)광은 개별 물질에 있어 수직에 가까운 입사광에 대한 반사율(Reflectivity)이 낮다. 그러므로 일반적으로 [그림 2-38(a)]와 같은 수십 주기의 다른 굴절률로 구성된 다층 반사경인 분산 브레그 반사경(Distributed Bragg Reflector, DBR)을 사용하여야 한다.
그림 2-37 EUV 노광 장치 및 광학계
EUV(13.5nm) |
다층 반사경(브레그 반사경) |
레이저 생성 플라즈마(LPP) |
진공(NA = 0.33) |
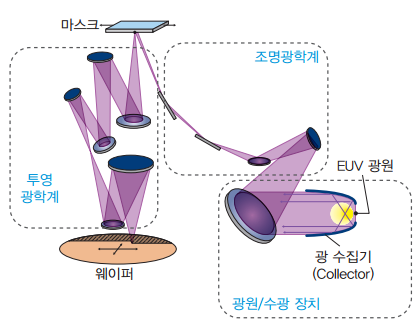
EUV 파장 영역에서 반사율을 높이기 위해서는 [그림 2-38(b)]와 같이 가능한 높은 굴절율(n)과 낮은 소멸 계수(k)를 갖는 간격물질(Spacer)과, 낮은 굴절율과 간격물질에 비해 높은 소멸 계수를 지닌 흡수물질(Absorber)을 주기적 구조로 설계하여야 한다. 이때 소멸 계수 차이를 주기 위해 높은 소멸 계수를 갖는 물질을 찾더라도, EUV광이 해당 물질에 흡수되어버리면 안되므로 10-3 오더(Order) 이하의 소멸 계수를 가짐과 동시에 간격물질과는 소멸 계수 차이가 큰 물질을 흡수물질로 사용하여야 한다. 이러한 조건에 맞는 물질을 [그림 2-38(b)]에서 찾아보면, 간격물질로는 실리콘(Si), 흡수물질로는 몰리브덴(Mo)이 가장 적절하다. 적층 구조인 분산 브레그 반사경(DBR)은 많은 계면들로 구성되어 있으므로, 반사된 모든 빛이 보강간섭(Constructive interference)이 되도록 두 물질의 두께를 선택해야 한다. 이러한 조건은 수직 입사에 대해 두 개 물질의 두께가 빛의 1/4 파장(λ/4)일 때 만족한다.
실제 반사형 렌즈는 [그림 2-39(a)]와 같이 Si와 Mo 박막을 6~7nm의 주기로 40~70층 적층하여 제작된다. 렌즈는 표면에 있는 미세한 입자에 의해서도 포토레지스트의 패턴 왜곡을 초래하게 되므로, 표면이 거의 완벽에 가까워야 한다. 또한, 보강 간섭에 의한 최고의 반사율을 얻기 위해서는 다음의 브랙(Bragg) 조건을 만족해야 한다.
(d: 층 두께, θ: 입사각, λ: 파장, n: 정수)
통상 입사각은 ~6° 정도를 적용하지만 [그림 2-39(b)]와 같이 아무리 최대화시킨 반사율이라도 거울당 약 70% 정도가 최대이므로, 8개 거울을 사용한다고 했을 때 5.8%의 빛밖에 웨이퍼에 도달하지 못한다. 따라서 반사도 개선과 함께, 고출력의 광원 개발을 위한 연구가 계속되고 있다. 광원에서 나온 EUV 광선은 [그림 2-37]의 오른쪽과 같이 조명광학계(Illuminator)를 거쳐 중앙의 마스크에 도달하고, 마스크에서 반사된 패턴은 투영광학계(Projection optics)를 거쳐 웨이퍼에 전사된다. 한편, 현재 해상도를 개선하여 5nm 기술 이하에 대응할 수 있는 고개구수(High NA) 노광 장비의 개발도 진행 중이다.
(3) EUV용 마스크(Mask)
EUV용 마스크는 다른 반사형 렌즈와 마찬가지로, 기존 투과형 마스크 대신 반사형 마스크를 사용해야 한다. EUV용 마스크의 구조는 [그림 2-40(a)]와 같다. 노광의 원리는 [그림 2-40(b)]와 같이 EUV용 마스크(Reticle)가 반사형 마스크이므로, 빛을 비추면 흡수층에서는 빛이 흡수되어 웨이퍼로 전사되지 못하고 흡수층 이외의 Si/Mo 반사층에 닿은 빛은 반사되어 웨이퍼로 전사됨으로써, 포토레지스트가 선택적으로 감광된다.
다음은 EUV용 마스크가 안고 있는 문제점에 대해 알아보자. [그림 2-41(a)]와 같이 현재 마스크 결함(Defect)의 밀도는 양산 가능한 정도의 수준까지 와있는 것으로 알려졌다. 그러나 [그림 2-41(b)]와 같이 Si/Mo 적층구조 안에 미세한 파티클과 같은 이물질이 발생하였을 경우, 매우 미세한 기술 노드(예를 들어 5nm 이하의 기술)에서는 육안이나 기존의 검사 기술로 검출되지 않는 문제가 있다. EUV용 마스크 외에 극자외선 펠리클의 성능도 노광 파장과 같은 파장으로만 정확한 검사가 가능하다. 이러한 검사를 화학선 검사기술(Actinic Pattern Mask Inspection, APMI)이라 하며, 다른 파장과 달리 침투 깊이가 깊기 때문에, 다층 박막 내의 결함 구조도 정확하게 검사할 수 있다.
기출문제로 정리하기 ※ 기출문제를 읽고 스스로 답변해 본 후, 이와 관련된 ‘이론 페이지’의 내용을 확인하여 자신의 답안과 비교합니다. | 이론 페이지 |
최신 기출 1 음성과 양성 PR에 대해 설명하시오. | p.275 |
최신 기출 2 노광 공정에서 사용하는 광원에 대해 설명하시오. | p.285~286 |
최신 기출 3 포토 공정에서 중요한 파라미터에 대해 설명하시오. | p.283~284 |
최신 기출 4 해상도를 개선하는 방법에 대해 설명하시오. | p.285~296 |
최신 기출 5 EUVL에 대해 설명하시오. | p.296~300 |
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기