식각 공정
학습 포인트 |
본 단원에서는 먼저, 식각 공정을 비롯해 반도체 공정에 널리 사용되고 있는 플라즈마에 대해서 살펴본다. 이러한 플라즈마에 대한 이해를 기반으로 다양한 물질을 선택적으로 제거하는 식각 공정에 대해 알아보기로 한다. |
개념 맵 |
1 식각 공정의 개요
식각 공정이란 주로 반응성이 강한 할로겐 계열(F, Cl 등) 물질을 사용하여 다양한 박막의 전부 또는 일부를 물리·화학적 방법으로 제거하는 공정이다. [표 3-1]과 같이 크게 습식 식각(Wet etch)과 건식 식각(Dry etch)으로 나눌 수 있다.
표 3-1 식각 공정의 분류
구분 | 습식 식각 | 건식 식각 |
형상(Profile) | ||
식각제(Etchant) | 액상 화학약품 | 이온, 활성종 |
최소 선폭 (Minimum Feature Size) | > 2μm(등방성) | ~nm(비등방성) |
선택비(Selectivity) | 높음(> 100x) | 상대적으로 낮으나 제어 가능 |
생산성(Throughput) | 높음(일괄처리) | 낮음(매엽식) |
2 습식 식각(Wet etch)
습식 식각은 액체 상태의 화학 약품(케미칼)을 사용하여 다양한 박막을 식각하는 공정으로, 실리콘, 실리콘 산화막, 실리콘 질화막 및 포토레지스트 등을 제거하는 공정이다. 액체 상태의 케미칼을 사용하므로 [그림 3-1]의 등방성(Isotropic) 식각 특성을 가지며, 2μm 이하의 미세한 패턴의 형성이 불가능하다. 따라서 습식 식각은 미세한 구조물의 패터닝이 아닌 박막의 전면 식각(Blanket etch) 또는 완전 제거(Strip)의 용도로 사용된다.
습식 식각은 최근 들어 케미칼을 스프레이 방식으로 분사하여 웨이퍼를 낱장씩 처리하는 매엽식 장비를 사용하는 경우도 있지만, 일반적으로 일괄 처리(Batch)가 가능한 습식 식각 장비(Wet station)를 사용하므로 생산성이 높다. 습식 식각의 일반적인 원리는 먼저 피 식각 박막 표면으로 반응할 화학 물질이 공급되고, 표면에서 화학 반응이 일어난 후 반응 생성물(By-product)이 이탈하면서 식각이 완료된다. 본 절에서는 주로 이용되는 실리콘 산화막 습식 식각에 대해 자세히 설명한다. 포토레지스트 제거에 대해서는 세정 공정 단원을 참고하기 바란다.
(1) 실리콘 산화막(Silicon oxide) 습식 식각
실리콘 산화막은 불산(HF)에 의해 쉽게 식각된다. 이는 불소(F)가 산소(O)보다 이온 반경이 작고, Si-F의 결합 에너지도 Si-O보다 작아 SiO2의 산소와 쉽게 치환될 수 있기 때문이다. 그리고 불산(HF)은 다음과 같이 해리되는데, 그중 HF2-에 의해 SiO2가 식각되는 것으로 알려져 있다.
산화막 제거용 케미칼에는 초순수에 HF를 희석한 DHF(Diluted HF)와 NH4F를 혼합한 BOE(Buffered Oxide Etchant)1 두 가지를 사용한다. DHF는 업체에서 공급받은 49% HF를 물에 희석시켜 100 :1 정도로 사용한다. 그리고 BOE는 NH4F(Ammonium fluoride)와 HF(Hydrofluoric acid)가 혼합된 화학물질로, 통상 40% NH4F와 49% HF를 6 :1 정도 비율로 혼합하여 사용한다. 보다 정밀한 제어가 필요할 때 사용하는 케미칼이다. 식각 과정에서 HF는 식각에 직접 관여하지만, NH4F는 식각률을 조정하여 균일도를 개선하는 완충 용액의 역할을 한다. 웨이퍼 표면의 유기물 제거 등 세정 케미칼로 사용되기도 한다. 산화막 습식 식각은 주로 자연 산화막, 희생 산화막 등에 응용되며 이에 대한 상세 내용은 세정 공정 단원에서 다루기로 한다.
BOE1: BHF(Buffered HF)라고도 함.
심화개념 |
(2) 실리콘 질화막(Silicon nitride) 습식 식각 인산(Phosphoric acid, H3PO4)을 이용하여 실리콘 질화막(Silicon nitride, Si3N4)을 식각하는 공정은 전통적인 방법임에도 불구하고, 현재 반도체 생산에서 중요한 공정으로 관심받고 있다. 현재 FinFET공정과 3차원 낸드 플래시 등의 3차원 구조 때문에 고 선택비의 정밀한 식각 공정이 요구되는 상황이고, 이에 따라 습식 식각을 대체하기가 더욱 어려워지고 있기 때문이다. 한편 실리콘 질화막의 습식 식각에서 사용되는 케미칼은 고온(140~200℃)의 인산이며, 15~20%의 물(H2O)이 첨가되어 있다. 질화막의 식각 과정은 다음과 같은 반응으로 진행된다. 고온에서 물이 계속 증발됨에 따라 인산 용액 중 피로 인산(Pyro-phosphoric acid, H4P2O7)의 농도가 증가하고, 이는 곧 질화막의 식각률(Etch rate) 저하와 산화막의 식각률 증가를 야기한다. 따라서 안정적인 식각률을 유지하기 위해서는 지속적으로 물을 보충하여 농도를 제어해야 한다. 물을 보충함으로써 가역 반응에 의해 피로 인산의 농도가 감소하여 다시 인산 용액으로 원상 회복되기 때문이다. 질화막은 수조(Bath)에서 일괄 처리(Batch) 공정을 진행할 때, 진행 횟수가 증가함에 따라 식각률이 감소하는 부하 효과(Loading effect)를 보인다. 이는 상술한 식각 반응식에서 H2SiO3(Silicic acid, 규소산)의 생성에 인한 것으로 이해된다. 이러한 규소 부산물들이 계속 생겨 케미칼 내 실리콘의 농도가 용해도 이상이 되면 실리콘이 석출되기 시작하고, 석출된 실리콘은 SiO2 박막 위에 다시 새로운 SiO2 박막으로 생겨나게 된다. 이를 재성장(Regrowth)이라고 하며, [그림 3-2(a)]와 같은 모습이다. 그림 속 재성장(A)은 3차원 낸드 플래시 공정에서 매우 중요한 인자이며, 미세 패턴의 입구를 막아 이후의 게이트 절연막 및 텅스텐 등의 증착을 위한 패턴 매립 공정(B)을 불가능하게 만드는 불량을 일으킨다. 3차원 낸드 플래시 제품의 단수(Layer)가 증가함에 따라 질화막 식각 시 실리콘 산화막과의 선택비 증가가 요구되었고, [그림 3-2(b)]와 같이 규소산 등의 규소를 첨가한 고 선택비 인산(High Selectivity Nitride, HSN)을 만들어 사용하게 되었다. 하지만 이는 재성장이 더 쉽게 생길 수 있게 하는 악순환을 초래했다. 현재는 일괄 처리식 인산 공정에서 이러한 재성장을 막기 위해, 실시간으로 규소의 농도를 관리하거나, 순환하는 용액의 속도를 정체 없이 빠르게 하려는 대책을 실시하고 있는 것으로 알려져 있다. |
3 건식 식각(Dry etch)
건식 식각이란 진공 챔버 내에 반응에 필요한 가스를 공급하여 플라즈마를 발생시킨 후, 실리콘 기판이나 박막과의 화학·물리적 반응을 통해 휘발성이 강한 반응 부산물(By-product)을 생성시켜 박막을 제거하는 공정이다. 크게 화학적 식각, 스퍼터(Sputter) 식각, 반응성 이온 식각, 이온 증속 억제 식각의 4가지 방식으로 나눌 수 있다.
화학적 식각: 플라즈마 내의 활성종(라디칼)을 식각제(Etchant)로 하여 화학 반응을 통해 식각하는 방식
스퍼터(Sputter) 식각: 플라즈마 쉬스 전압에 의해 이온을 가속시키고, 가속시킨 이온이 피 식각 물질과 부딪혀 물리적으로 떼어내는 방식
반응성 이온 식각(Reactive ion etching): 화학적 식각과 스퍼터 식각을 혼합하여 식각률을 크게 개선한 방식으로, 가속한 이온의 표면 충돌을 통해 에너지를 전달한 후 화학적 식각으로 보다 쉽게 식각이 이루어질 수 있도록 함.
이온 증속 억제 식각(Ion enhanced inhibiting etching): 반응성 이온 식각을 개선한 방식으로, 억제제(Inhibitor)를 사용하여 라디칼과 피 식각 물질의 표면 간 반응을 억제함으로써 측벽을 보호할 수 있고, 비등방성 식각 특성을 개선함.
화학적 식각인 플라즈마 식각을 제외하고는 모두 수직 식각 특성이 강한 이방성(Anisotropic) 식각이며, nm 수준 미세 패턴의 식각이 가능하다. 이온에 의한 물리적 식각을 동반하므로 선택비가 상대적으로 낮다는 특성이 있다. 이러한 건식 식각이 갖춰야 할 요건은 다음과 같다.
웨이퍼 처리량(Throughput)이 높을 것
균일도가 우수할 것
비등방성일 것
기판에 손상이 적을 것
신뢰도가 높을 것
(1) 건식 식각 장비
① 일반적인 건식 식각 장비의 구성
일반적인 건식 식각은 [그림 3-3]과 같이 진공의 반응 챔버(Chamber) 내 플라즈마 상태에서 진행된다. 따라서 진공 장치, 플라즈마 장치, 가스 주입 장치 등 다양한 서브 시스템(Sub-system)으로 구성되어 있다. 플라즈마 소스(Source)에 대해서는 반도체 공정 기초 단원의 플라즈마 절을 참조하기 바라며 그 외 내부 장치별로 간략히 소개한다.
펌프(Pump): 박막을 식각하기 위해 고 진공 상태를 만들고 유지하는 기능을 한다.
고주파 발생기(RF generator): 공정 챔버 내로 주입된 가스에 전력을 인가하여 플라즈마를 형성해 주는 전력원이다.
매칭 박스: 플라즈마 내의 임피던스(Impedance) 매칭을 통해 RF 전력의 효율을 높이고자 설계된 회로이다. → 다음 절에서 MB(Matching Box)라 정의한다.
냉각기(Chiller): 식각 중에 발생하는 열을 냉각시켜 식각의 균일도 및 손상을 감소시키는 기능을 한다.
공정 챔버(Process chamber): 일반적으로 식각이 행해지는 반응실로, 일정 압력이 유지된다. 이 곳에서 플라즈마에 의한 가스들의 반응이 이루어지고 반응 생성물이 배기 라인을 통하여 배출된다.
가스판넬(Gas pannel): 식각에 필요한 가스의 유량을 조절하는 MFC(Mass Flow Controller) 장치가 있고 여기서 가스를 분배한다.
주 제어장치(Main controller): 식각에 필요한 모든 장치를 통제하는 곳으로, 여러 대의 CPU 보드와 보드 간 통신을 위한 연결용 보드가 있다.
웨이퍼 고정 장치(Wafer clamping): 웨이퍼 앞면을 기계적으로 눌러주면서 동시에 뒷면 공급 가스압(He)을 높혀 주는 기계적 고정 방식과, 서로 다른 물체 간에 끌어 당기는 정전기력을 이용한 정전기적 고정 방식(Electrostatic Clamping, Electrostatic Chuck, ESC)이 있다. ESC는 기계적 고정 방식에서의 이물질, 공정 불균일성 등의 문제를 개선한 방식이다.
②용량성 결합 플라즈마와 유도성 결합 플라즈마 식각 장비
고주파 플라즈마 방식에는 용량성 결합 플라즈마(Capacitive Coupled Plasma, CCP)와 유도성 결합 플라즈마(Inductive Coupled Plasma, ICP)가 있다. CCP 방식은 [그림 3-4(a)]와 같이 두 전극이 마주보고 있는 커패시터 형상을 하고 있어 붙여진 명칭이고, ICP 방식은 코일을 감아 만든 안테나를 이용하여 자기장을 발생시키는 원리이기 때문에 유도성 플라즈마라고 한다. 에너지 전달 방식이 변압기의 원리와 유사하다는 의미로 ICP 대신 T(Transformed)CP라고도 불린다. 여기에는 [그림 3-4(b)]와 같이 챔버의 상부에 나선형으로 코일이 감겨 있는 나선형(평면형) ICP와 [그림 3-4(c)]와 같이 챔버의 벽을 감싸는 솔레노이드형(실린더형) ICP가 있다.
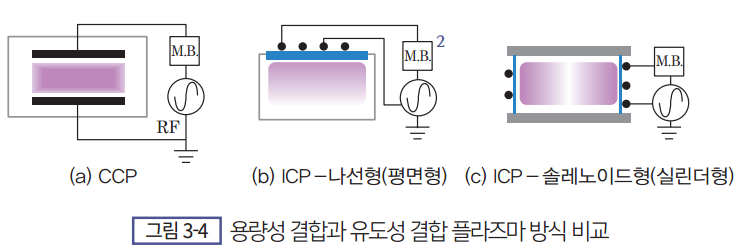
먼저 용량성 결합 플라즈마(CCP)는 주로 10mTorr~10Torr 범위의 압력에서 공정이 이루어지고 전극 간의 거리는 1~10cm로 좁다. RF 전원의 한 주기에 대해 전기장이 한쪽 방향으로만 개방적이므로, 전자가 이동 중에 챔버 벽이나 전극과 부딪혀 손실될 가능성이 크다. 따라서 유도성 결합 플라즈마(ICP) 대비 상대적으로 저밀도의 플라즈마(109~1011/cm3)를 갖는다. 전극이 마주 보고 있어 대면적으로 균일한 플라즈마를 형성할 수 있다는 장점이 있지만, 한 쌍의 전극으로 플라즈마의 생성/유지 및 쉬스 전압의 제어를 동시에 해야 하므로, 플라즈마의 물리적 반응(이온 에너지)과 화학적 반응(전자 및 활성종의 밀도)의 독립적 제어가 어렵다는 단점이 있다. 이러한 단점은 플라즈마의 고 밀도화를 위한 높은 전력 사용에 기인한 것이며, 그 결과 기판 전압의 증가로 인해 이온 에너지가 증가하며 기판을 손상시키게 된다.
반면 ICP는 [그림 3-5(a)]와 같이 절연체에 코일을 감아 만든 안테나에 고주파 교류 전류를 인가해 자기장을 형성하고, 자기장의 시간 변화에 의해 유도된 전기장을 따라 전자가 원운동을 하는 원리이다. ICP는 전자가 폐쇄적인 전기장을 따라 원운동을 하게 되므로, 챔버 벽이나 전극과 충돌하지 않아 상대적으로 고밀도의 플라즈마(1011~1013/cm3)를 얻을 수 있다. 공정 시의 압력은 수mTorr~수Torr 범위이고, ICP 플라즈마 소스를 사용하여 플라즈마의 밀도를 제어한다. [그림 3-5(b)]와 같이 일반적으로, 음의 DC 전압 혹은 절연체(부도체)인 경우에는 저주파 전원을 추가하여 이온의 입사 에너지를 제어함으로써, 플라즈마의 물리·화학적 반응의 독립적 제어가 가능하다. ICP의 안테나 구조상 초 대면적화의 어려움이 있으므로, 현재는 다양한 구조와 직병렬 유도 결합형 안테나(Ladder-parallel shape antenna)로 대체하거나 VHF(Very High Frequency) 플라즈마를 사용하여 이에 대응하고 있다. VHF 플라즈마는 주파수 증가에 따라 플라즈마 밀도가 증가하는 원리를 이용한 것이며, 40~100MHz의 고주파 플라즈마 소스에 의해 발생시킨다.
(2) 스퍼터 식각(Sputter etch)
스퍼터 식각은 자기 직류 바이어스(Self DC bias)에 의해 만들어진 높은 플라즈마 쉬스(Sheath) 전압을 이용해 이온을 가속시키고, 가속된 이온을 피 식각막에 충돌시켜 제거하는 물리적 식각이다. 즉, 스퍼터링3이란 이온이 식각 대상 물질(Target, 타겟)에 충돌하여 타겟 표면의 원자들을 떼어내는 현상을 말한다. 스퍼터 식각에는 양과 음전극의 면적이 다른 고주파 플라즈마 장치가 사용되며, 피 식각 박막의 결합 에너지보다 큰 에너지를 가진 이온 입사 시에 식각이 가능하다.
스퍼터링3: 플라즈마 상태에서 강한 전기장에 의해 가속된 이온을 목표물에 충돌시켜 목표물의 원자를 떼어내는 방식
물리적 식각은 특성상 이온 빔의 입사 방향 및 물질에 따라 식각률이 달라지는데, 이렇게 입사되는 이온의 각도(θ)4에 따라 스퍼터링의 효율, 즉 스퍼터 수율(Yield, S)5이 달라지는 효과를 입사각 효과라고 하며, 최적의 입사각은 [그림 3-6(b)]와 같이 40~70° 사이이다. 스퍼터 식각은 물리적 식각이므로 선택비가 좋지 않은 단점이 있지만, 전기장으로 방향성을 갖게 된 이온에 의한 물리적 식각이므로 수직 방향의 이등방성(Anisotropic) 식각이 가능하다. 박막 공정 측면의 스퍼터 수율에 대해서는 박막 공정 단원에서 다시 한 번 언급할 예정이다.
수직 입사일 경우, θ = 0°4
스퍼터 수율(Sputter yield)5: 이온 하나당 스퍼터링되는 타겟 원자(또는 분자)를 몇 개나 떼어내는가의 비율로, 단위는 ‘[원자]/[이온]’임.
(3) 화학적 식각(Chemical etch)
화학적 식각은 [그림 3-7]과 같이 플라즈마 내 존재하는 중성 라디칼들이 피 식각물 표면과 화학적으로 반응한 후, 휘발성 반응 부산물(By-product)을 형성하여 배기되면서 이루어진다. 예를 들어 실리콘 식각의 경우에는 반응 가스로 주입된 CF4가 분해되어 F* 활성종(라디칼)을 만들고, 이 F* 활성종이 실리콘 원자와 결합하여 휘발성의 SiF4를 생성함으로써 식각이 이루어진다. 이와 같이 화학적 식각은 라디칼의 확산에 의한 식각이므로 방향성이 없는 등방성 식각이며, 화학 반응을 기반으로 하여 선택비가 우수하다.
화학 반응에 있어서는 자발적인 반응이 선호되며, 이는 즉, 흡열 반응보다 발열 반응이 선호됨을 의미한다. 식각이 이루어지기 위해서는 표면에서의 화학 반응 후 반드시 부산물(By-product)이 휘발성으로 기화되어야 한다. 따라서 반응 부산물은 휘발성이거나 높은 증기압을 가져야 한다. 예를 들어 Fe, Ni, Co 등의 할로겐 화합물은 휘발성이 아니어서 식각이 어렵고, Cu의 경우는 비등점이 높아 기판을 고온으로 가열해야만 식각이 가능하다. 따라서 현재는 이에 대한 대책으로 Cu 다마신(Damascene) 공정을 채택하고 있다.
(4) 반응성 이온 식각(Reactive Ion Etching, RIE)
반응성 이온 식각은 [그림 3-8(a)]와 같이 스퍼터 식각에서 사용되는 ‘이온’과 화학적 식각의 ‘라디칼’을 모두 이용하는 혼합형의 방식이지만, 단순한 물리·화학적 식각의 결합이 아닌 양자의 장점이 증폭되어 매우 유용한 시너지 효과를 보이는 방식이다. 먼저 높은 에너지로 가속된 이온이 피 식각 박막의 표면에 충돌하면서 스퍼터링을 일으키고, 이는 피 식각 박막의 원자나 분자 간 결합을 파괴한다. 이후 결합이 약화된 박막 표면의 원자와 라디칼이 쉽게 화학 반응을 일으켜 화학적 식각 원리에 따라 박막이 제거되는 원리이다.
반응성 이온 식각에서 라디칼의 화학적 반응은 측벽 방향보다 이온의 스퍼터링으로 결합력이 약화된 박막의 바닥으로 집중되므로 수평에 비해 수직 식각의 비율이 증가한다. 따라서 스퍼터링 식각보다는 부족하지만, 비등방성 식각이 가능하다. 여기서 잠깐 코번(Coburn)의 유명한 실험6 결과를 예로 들어, 반응성 이온 식각의 시너지 효과에 대해 살펴보자. [그림 3-8(b)]와 같이 실리콘 샘플에 아르곤 이온(Ar+)과 제논 프로라이드(XeF2) 가스를 투입하면, 이온이나 가스에 단독으로 노출되었을 때의 실리콘 식각 속도보다 양자를 모두 사용했을 때의 식각 속도가 10배 이상 빨라지는 것을 알 수 있다.
이온 충돌 효과와 라디칼에 의한 화학적 식각 효과에 대한 실험6
심화개념 |
(5) 이온 증속 억제제에 의한 식각(Ion enhanced inhibitor etching) 상술한 반응성 이온 식각의 경우도 피 식각 박막의 측벽이 바닥면보다 식각률이 떨어져 비등방성 식각이 가능하지만, 소자의 미세화에 따라 이보다 더 강화된 수직 방향의 식각이 요구되고 있다. 또한 반응성 이온 식각 중에서 반응성이 너무 높은 경우에는 비등방성이 잘 확보되지 않는 경우도 있다. 이러한 문제점은 피 식각 박막의 측벽에 식각 억제 물질을 피복시킴으로써 개선할 수 있으며, 이렇게 측벽을 보호하여 수직성을 확보하는 방식을 이온 증속 억제제(Inhibitor)에 의한 식각이라 한다. 식각의 원리는 [그림 3-9]와 같으며, 먼저 반응 기체와 함께 첨가제를 주입한다. 주입된 첨가제는 화학 반응을 통해 피 식각 박막의 표면, 즉 측벽과 바닥면에 식각을 방해하는 물질을 형성(증착)한다. 이렇게 식각을 방해하는 물질을 식각 억제제(Inhibitor)라고 한다. 식각 억제제는 화학적 식각에는 안정하지만, 이온 충돌에 의한 물리적인 식각이 진행되면 바닥면의 억제제만 식각된다. 이렇게 이온 충돌에 의해 노출된 바닥면은 라디칼에 의한 화학적 식각에 의해 식각되고 다시 ⓐ 억제제 형성, ⓑ 이온에 의한 바닥면 식각, ⓒ 라디칼에 의한 바닥면의 화학적 식각의 과정을 반복하게 된다. 그 결과 거의 수직에 가까운 식각 형상(Profile, 프로파일)을 얻을 수 있는 것이다. 이때 후속 금속 박막 증착 공정에서의 계단 피복 능력(Step coverage)7 개선을 위해 [그림 3-10]과 같이 억제제의 생성 및 식각을 제어하여 식각 프로파일에 각도를 주는 경사 식각(Tapered etch)을 하기도 한다. 계단 피복 능력7: 단차를 가진 구조에서 박막 증착 시 위치에 따라 일정한 두께를 유지하는지의 여부 억제제를 형성하기 위해 주입하는 첨가제는 플라즈마에서 반응한 후에 증기압이 낮은 반응 부산물이 되어 표면에 증착되기 용이한 물질이어야 한다. 억제제는 주로 CxFy 기체 반응으로부터 생성되는 고분자 물질이며, 산화막 및 비휘발성의 염화 화합물 등이 있다. |
(6) 건식 식각의 공정 변수(Parameter)
건식 식각 특성에 영향을 주는 변수는 플라즈마 생성과 관련이 있을 수밖에 없고 그 외에도 반응 가스의 종류, 유량, 기판 온도 등 다양한 변수에 의해 영향을 받는다. 이러한 변수들은 항상 트레이드 오프(Trade-off) 관계에 있으므로 조건별 합일점을 찾아 적절한 제어를 통해 최적의 결과를 추구해야 한다. 예를 들어, 생산성 향상을 위한 식각률(Etch rate) 증가를 목적으로 반응 가스 유량과 가스의 압력을 높일 경우, 화학적 식각 특성이 강해져 등방성 특성이 나타나기 쉽다. 다른 방법으로 무선 주파수(RF)의 전력을 증가시키면 이온 에너지의 증가에 따라 식각 속도의 증가와 수직성 특성은 개선되지만, 선택비의 저하를 가져오게 된다. 이 경우에는 플라즈마 생성 전압과 이온 가속을 위해 기판 전압이 분리된 형태인 ICP로의 전환이 해결책이 될 수 있다.
4 식각 공정의 평가 항목
(1) 식각률(Etch Rate, E/R)
식각률은 일정 시간 동안 박막을 얼마만큼 제거할 수 있는지를 나타낸 값으로, [그림 3-11]과 같이 식각된 박막의 두께를 식각 시간으로 나눈 값이다. 습식 식각의 경우는 식각제(Etchant)로 사용되는 케미칼의 종류, 농도, 온도에 따라 식각률이 달라지고, 건식 식각은 플라즈마 가스의 종류, 압력, 유속, 온도, 기판 전압에 따라 식각률이 달라진다.
(2) 식각 바이어스(Etch bias)
식각 바이어스는 [그림 3-12]와 같이 포토레지스트(PR)의 폭(DI CD) 대비 식각 후 폭(FI CD)의 차이를 반으로 나눈 값이다. 포토레지스트(PR)의 프로파일, 식각 조건 등에 따라 DI CD 대비 FI CD가 더 커지는 경우를 (+) 바이어스, 작아지는 경우를 (-) 바이어스를 갖는다고 한다(Line CD 기준).
(3) 선택비(Selectivity, S)
선택비는 식각 과정에서 동시에 식각되는 서로 다른 물질의 식각률의 비율을 뜻한다. 즉, [그림 3-13]과 같이 제거해야 할 층(SiO2)의 식각 속도와 보호해야 할 층(예를 들어, 마스크 또는 정지층, Poly-Si)의 식각 속도의 비율인 것이다. 일반적으로. 특정 박막만을 식각할 필요가 있기 때문에, 가능한 선택비가 높아야 한다.
(4) 균일도(Uniformity)
식각에서의 균일도는 웨이퍼 내(In-a-Wafer), 웨이퍼 간(Wafer-to-Wafer), 로트(Lot) 간 식각 후 잔여막의 두께 균일도, 식각률의 균일도 등 식각의 고른 정도 또는 공정의 재현성을 평가하는 척도이다. 통상 생산성을 고려하여 웨이퍼 내 여러 위치에서 측정하며, 표준편차 또는 [그림 3-14]와 같은 불균일성(%)으로 나타낸다. 불균일성 값이 클수록 균일도가 좋지 않다는 의미이다. 식각률의 균일도는 플라즈마의 밀도, 가스 유량 및 압력 등의 플라즈마 균일도의 개선으로 확보할 수 있다.
5 식각 공정 주요 부가 기술
(1) 하드 마스크(Hard Mask)
패턴이 미세화됨에 따라 단파장 광원의 노광 장비를 사용해야 하고. 이에 따라 낮아진 초점 심도(Depth of foucs)를 보상하기 위해 공정 시 포토레지스트(PR) 두께는 더 얇아져야 한다. 하지만 포토레지스트(PR) 박막 두께가 얇아지게 되면 식각 공정 시에 포토레지스트(PR)가 버티지 못하는 문제가 생긴다. 이 때문에 도입된 것이 바로 하드 마스크 공정이다. 공정을 마치면 하드 마스크는 남아 있지 않기 때문에 중간막 혹은 희생막이라고도 불린다. 하드 마스크에는 화학 기상 증착(CVD) 공정으로 형성하는 비정질 탄소 박막(Amorphous Carbon Layer, ACL)과 반사 방지막 기능을 포함하는 SiON막(Si-hard mask)이 있고, 이 외에 회전 도포(Spin coating) 방식을 이용해 유기 규소 물질과 고분자 탄소 물질을 쌓아서 적용하는 것도 있다. 이때 유기 규소 물질은 투자 비용이 적고 공정이 단순하다는 장점이 있으나 식각 선택성이나 식각 내성 특성이 ACL이나 SiON보다 열악하므로, 대부분의 미세 패턴 형성에는 ACL 또는 SiON 하드 마스크가 사용된다. [그림 3-15]에는 하드 마스크의 공정 과정을 나타내었으며, 단계별로 살펴보도록 보자.
먼저 피 식각층 위에 ACL 및 SiON 하드 마스크를 증착하고, 그 위에 반사 방지막(BARC)을 형성한다. 이후 포토 공정을 통해 포토레지스트(PR)로 패터닝한 다음, 포토레지스트(PR)를 마스크로 하여 반사 방지막(BARC)과 SiON을 식각한다. 이때 SiON 하드 마스크는 유기 화합물인 포토레지스트(PR)보다 식각 속도가 빨라, 얇은 두께의 포토레지스트(PR)층으로도 패터닝을 할 수 있다. 그러고 나서 남은 포토레지스트(PR)와 반사 방지막(BARC)을 제거한 후, SiON을 하드 마스크로 하여 아래 ACL 하드 마스크를 식각한다. 이때는 주로 산소 플라즈마를 이용해 탄소 함량이 높은 ACL을 식각하게 되는데, 탄소막질은 산소에 의해 쉽게 산화가 일어나므로, 식각이 수월하다. 다음으로 ACL을 하드 마스크로 하여 피 식각층을 식각한다. 이때 ACL보다 피 식각층을 더 잘 식각하는 할로겐 플라즈마 등을 이용해야 하며, 피 식각층을 제거한 후 남은 ACL을 제거함으로써 공정이 완료된다. 이러한 하드 마스크 공정은 안정적인 패턴을 구현할 수 있는 장점이 있는 반면, 하드 마스크 증착 공정 및 건식 식각 단계가 추가되어 원가 상승 요인으로도 작용한다.
(2) 비등방성 식각에 의한 스페이서(Spacer) 형성
[그림 3-16]과 같이 구조물이 있는 상황에서 박막을 증착하면 구조물의 형상을 따라 피복이 이루어진다. 이때 반응성 이온 식각(RIE) 등의 비등방성(Anisotropic) 식각을 하면 수직 방향으로만 식각이 되므로 [그림 3-16(c)]와 같이 구조물의 측벽에 증착했던 박막의 일부가 남게 되는데, 이를 측벽 스페이서(Sidewall spacer)라고 한다. 이러한 스페이서는 본 서의 MOSFET 단원에서 설명한 열 전자 효과(Hot electron effect) 방지를 위한 저농도 드레인 도핑(Lightly Drain Doping, LDD) 공정이나, 포토 공정의 다중 패터닝 공정 등에 이용되는 기본적인 식각 공정 중 하나이다.
(3) 과도 식각(Over etching)
[그림 3-17]과 같이 하부 피 식각 박막의 표면이 평탄하지 않고 굴곡을 가지게 되면, 건식 식각이 진행됨에 따라 국부적으로 얇은 부분의 박막이 식각되면서 그 부분의 기판이 먼저 드러나게 된다. 이때 식각하려는 박막과 기판 간의 식각 선택비가 좋지 않으면, 남은 박막이 식각되는 동안 기판이 식각되어 손상되는 문제가 발생한다. 이러한 기판 손상은 제품의 특성 및 품질의 저하를 가져온다.
생산성 향상을 위해서는 식각 처리량(Throughput)이 커야 하고 그러려면 식각 속도가 빨라야 하지만, 통상 식각 속도가 빠른 공정 조건과 선택비가 좋은 공정 조건은 서로 트레이드 오프 관계에 있다. 공정을 진행하는 데 있어 필요한 온도, 압력, 시간, 가스 유량, 전력 등의 모든 공정 조건을 명문화한 것을 레시피(Recipe)라 하고 이 레시피를 장비에 입력하여 공정을 진행하게 되는데, 트레이드 오프 관계로 인해 식각 속도가 빠른 레시피는 선택비가 나쁘고, 선택비가 좋은 레시피는 식각 속도가 느리다는 이야기이다. 이 두 마리의 토끼를 다 잡기 위해서는, 식각 시작부터 기판이 드러나는 순간까지는 식각 속도가 빠른 레시피를 사용하여 식각하고, 기판의 노출에 따른 종말점 감지(End Point Detection, EPD) 후에는 자동적으로 선택비가 좋은 레시피로 전환되도록 전체 레시피를 만들어 실행시키면 된다. 그럼 결과적으로 생산성과 품질 모두를 만족시킬 수 있게 되는 것이다. 이때 식각 시작부터 종말점 감지까지의 식각을 주 식각(Main etch)이라 하고, 이후 선택비가 우수한 레시피를 써서 잔여 박막을 상대적으로 느린 식각률로 식각하는 단계를 과도 식각(Over etch)이라 한다. 이렇게 되면 과도 식각 시 파인 기판의 깊이(Δd′)가 식각 전 굴곡면의 두께 차이(Δd)보다 훨씬 작아지게 된다. 한편, 종말점 감지 방법에는 공정 챔버의 플라즈마에서 발생하는 빛을 관찰하여 피 식각층과 기판의 경계면에서 발생하는 플라즈마 발광 신호를 OES(Optical Emission Spectroscopy) 장비 등으로 감지하는 방법 등이 있다. 이는 특정 물질에 고유한 파장이 피크(Peak) 형태로 검출되는지 알아보는 원리를 이용한다.
6 식각 공정의 주요 문제점들
(1) 부하 효과(Loading effect)
부하 효과란 식각제(Etchant)의 양 대비 웨이퍼 상의 패턴 밀도 및 구조에 따라 식각률이 감소하는 현상을 의미하며, 다음의 3가지로 세분화할 수 있다.
① 거시적 부하 효과(Macro loading effect)
거시적 부하 효과란 [그림 3-18]과 같이, 반응 가스가 일정하게 공급되는 상황에서 표면적이 증가함에 따라 식각률이 감소하는 현상을 말한다. 즉, 단위 면적당 반응 가스(라디칼)의 농도가 낮아 식각제의 공급이 원활하지 않게 되고, 이로 인해 넓은 면적의 패턴에서 식각이 잘 일어나지 않아 식각되는 깊이가 달라지는 현상이다. 이 현상은 화학적 식각제인 라디칼(Radical)의 양에 의존하여 발생하므로 챔버의 압력을 낮추고 RF 파워를 증가시키는 등의 공정 조건 최적화를 통해 식각이 라디칼이 아닌 반응성 이온 충돌 플럭스(Reactive ion bombardment flux)에 의존하게 함으로써 완화시킬 수 있다.
② 미시적 부하 효과(Micro loading effect)
미시적 부하 효과는 웨이퍼 내의 동일한 종횡비를 갖는 패턴에 있어 외떨어진 저밀도 영역의 패턴 대비 고밀도 영역에 위치한 패턴들의 식각 속도가 느려지는 현상을 말한다. 이는 [그림 3-19]와 같이 밀도가 높아 식각될 패턴이 많은 지역에서는 식각제의 소모가 많아 잔류하는 식각제의 양이 상대적으로 적기 때문이며, 식각제가 이동하기 어려운 높은 압력에서 발생하기 쉽다. 따라서 낮은 압력에서 입자의 충돌 확률을 낮춰 확산속도를 증가시킴으로 미시적 부하 효과를 저감할 수 있다.
③ 종횡비 의존 식각(Aspect Ratio Dependent Etching, ARDE)
종횡비 의존 식각 현상은 [그림 3-20]과 같이 식각되는 패턴의 종횡비(Aspect Ratio)가 증가함에 따라 식각 속도가 느려지는 문제를 말하며 RIE-lag라고도 한다. 이러한 ARDE를 일으키는 원인으로는 i) 고 종횡비 패턴의 입구 및 하부에 대전된 전하에 의한 이온 플럭스의 궤도 이탈, ii) 종횡비가 큰 미세 패턴 내 식각제의 유입 및 식각 후 반응 생성물의 배출 어려움, iii) 이온 증속 억제제에 의한 식각(Ion enhanced inhibitor etching)에 의해, [그림 3-21]의 좌측과 같이 고 종횡비의 패턴에서는 CxFy와 같은 고분자 억제제가 들어가지 못해 보호막 피복이 되지 않아 식각 속도가 빨라지는 역 종횡비 의존 식각률 지연(Inverse RIE-lag) 현상 등이 있다.
(2) 식각 측면 형상(Profile, 프로파일) 이상
식각 후에는 원치 않는 다양한 식각 프로파일 이상이 발생할 수 있다. 먼저 [그림 3-22(a)]의 미세 트렌치 현상(Micro trench)은 입사된 이온이 측벽의 경사부분에서 꺾이면서 식각 바닥면의 구석에 집중되고, 그 결과 그 부분이 미세하게 식각이 더 많이 되는 현상을 말한다. 이는 포토레지스트(PR)나 하드 마스크 측면의 수직성을 확보하여 개선하는 것으로 알려져 있다. [그림 3-22(b)]의 언더컷(Under-cut)은 화학적 식각의 강한 등방성 식각 특성으로 인하여 마스크 아래 부분이 수평 방향으로 식각되어 생기는 현상이다. 화학적 활성도가 상대적으로 낮은 라디칼과 이온 에너지의 제어, 또는 이온 증속 억제제 방식으로 개선이 가능하다.
[그림 3-22(c)]는 노칭(Notching) 불량이라 하며, 식각 시 방향성이 작고 빠르게 운동하는 전자들이 포토레지스트(PR)의 측면에 포획됨으로써 그 정전기력에 의해 양이온들의 진행 방향에 영향을 주게 되어 발생한다. 진행 방향이 바뀐 양이온에 의해, 패턴의 하부는 측면 방향으로 비정상적으로 식각된다. 이는 고분자 억제제의 증착을 증가시켜 전자에 의한 효과를 감소시키거나, 기판 바이어스의 감소에 의해 이온 에너지를 감소시킴으로써 개선할 수 있다. 다음 [그림 3-22(d)]는 식각 바닥면의 중앙 부분에 있는 고분자 반응 부산물(Polymer, 폴리머)의 두께가 두꺼워, 바닥의 양쪽 가장자리의 식각이 더 많이 되는 현상이다. 형상이 비둘기 꼬리와 유사하다 하여 비둘기 꼬리(Dove tailing, 도브 테일링) 불량이라 한다.
심화개념 |
7 최근 식각 기술 - 펄스 플라즈마 식각 기술(1) 펄스 플라즈마 식각 기술(Pulsed plasma etching) ①펄스 플라즈마 식각 기술의 필요성 및 정의 기존 일반적인 플라즈마 식각 장치에서 플라즈마를 발생시는 고주파(Radio Frequency, RF) 소스 전력(Source power)과 기판 쪽으로 양이온(Ion)을 끌어당기는 RF 바이어스 전력(Bias power)은 공정이 진행되는 동안 지속적으로 공급되는 연속파(Continuous Wave, CW) 형태를 띤다. 이러한 연속파(CW)를 이용한 식각 공정에서는 주파수 선택이나 입력 전력 변화 정도의 플라즈마만 조절 가능하여, 소자 미세화에 따른 다양한 문제(식각 균일도 및 임계 치수(CD) 제어, 식각 선택비 및 식각 프로파일 확보, 전하 축적, 식각 손상, 부하 효과, 패턴 왜곡 등)에 대한 대처에 한계가 있었다. 이에, 보다 향상된 식각 공정의 제어를 위한 방안 중 하나인 펄스 플라즈마가 필요하게 되었다. 펄스 플라즈마는 소스나 바이어스 전극부에 연속파(CW)가 아닌 펄스파(Pulsed wave)를 인가하여 플라즈마가 켜져 있는(ON) 주기 및 꺼져 있는(OFF) 주기를 조절함으로써 플라즈마의 생성과 소멸을 반복하게 해 플라즈마의 특성을 각 공정에 적합하도록 제어할 수 있다. [그림 3-23(a)]는 RF 파워를 인가하여 연속파(CW)를 형성한 경우이고, [그림 3-23(b)]는 [그림 3-23(a)]의 RF 파워를 펄싱(Pulsing)함으로써 펄스파를 형성한 경우를 나타낸 그림으로, 펄스파에서는 플라즈마의 파워가 챔버 내에 시간 변조(Time modulate)의 방식으로 인가된다. 펄스 조건에 대한 파라미터에는 [그림 3-24]와 같이 ① 펄스 파워가 반복되는 주기의 역수인 펄스 주파수, ② 펄스 플라즈마의 온(ON)과 오프(OFF) 주기의 비율로, 이 비율 변화에 따라 챔버 내 전하 상쇄 정도, 반응성 등의 조절이 가능한 펄스 작동 비율(Duty ratio), ③ [그림 3-25]와 같은 파워 변조(Power modulation) 등이 있다. 파워 변조 방식에는 크게, [그림 3-25(a)]와 같이 기판에 연속파, 소스부에 펄스파가 인가되는 소스 펄스 방법(Source pulsing)과, [그림 3-25(b)]와 같이 소스부에 연속파, 기판에는 펄스가 인가되는 바이어스 펄스 방법(Bias pulsing), [그림 3-25(c)]와 같이 소스부와 기판 모두에 펄스(위상 차이 설정 가능)가 인가되는 싱크로 펄스 방법(Synchronous pulsing)의 3가지가 있으며, 위상차가 존재하는 경우를 비동기(Asynchronously) 펄스 모드라 한다. ② 펄스 플라즈마의 효과 기존 연속파(CW) 고밀도 플라즈마에서는 일반적으로 공정가스의 분해율이 높고, 전력이 증가함에 따라 전자 밀도, 웨이퍼에 도달하는 이온 및 활성종(Radical)의 플럭스(Flux)도 증가하여, 이런 다양한 종의 플럭스 및 밀도 등을 독립적으로 제어하기가 매우 어려웠다. 그러나 펄스 플라즈마의 경우에는 고 에너지 이온을 이용한 대부분의 식각이 온(ON) 구간에서만 일어나므로 전체적인 식각 속도는 감소하는 경향이 있지만, 오프(OFF) 구간의 영향으로 [그림 3-26]과 같이 낮은 플라즈마 전위(VP), 전자 온도(Te), 전자 밀도(ne), 그로 인한 낮은 영역대의 이온 에너지 확보가 가능하다는 장점이 있다. 이러한 펄스 플라즈마의 특성을 이용하면, 플라즈마로 인한 기판 손상 및 전하 축적 문제를 감소시킬 수 있어 노칭(Notching) 및 보우잉(Bowing), 미세 트렌치(Micro trench) 현상과 같은 식각 형상(Profile) 이상 문제를 경감시킬 수 있다. RF 오프(OFF) 중 플라즈마 내 다양한 입자들의 확산에 의해 플라즈마 균일도도 개선할 수 있어 식각 균일도 향상도 가능하며, 반응 부산물의 잔류 시간 제어를 통해 종횡비 의존 식각률 지연(ARDE)과 같은 부하 효과도 감소시킬 수 있다. 다음은 다양한 펄스 플라즈마 효과 중 미세 트렌치(Micro trench) 및 ARDE 특성 개선의 예를 소개한다. [그림 3-27]과 같이 연속파(CW)를 사용한 트렌치 식각의 경우, 양이온은 플라즈마 쉬쓰(Sheath)에서 기판을 향해 이방성으로 가속하는 반면, 전자는 무작위(등방성)로 이동한다. 그 결과, 트렌치의 바닥은 이방성 양이온으로 인해 양전하를 띠고, 트렌치 측면은 등방성 전자에 의해 음전하를 띤다. 트렌치의 측면과 바닥 사이의 전하 차이로 인해 전기장이 생성되어 이온이 측벽 쪽으로 휘게 되고, 결국 미세 트렌치를 생성한다. 그러나 펄스 플라즈마의 식각 형상에서는 미세 트렌치가 나타나지 않는데, 이는 양이온이 방향성을 잃는 펄스 오프(OFF) 기간 동안 플라즈마 내 음이온이 웨이퍼 표면을 중화시켜 미세 트렌치가 소멸되기 때문이다. 다음은 ICP(Inductively Coupled Plasma) 시스템을 이용한 실리콘 트렌치 식각 공정(Cl/Ar)에 있어 연속파(CW) 모드와 비동기 펄스 플라즈마(Asynchronously pulsed) 모드에서의 ARDE 특성 개선의 예이다. 연속파(CW) 모드의 경우, [그림 3-28(a)]와 같이 해리된 염소(Cl) 라디칼은 넓은 트렌치의 경우 실리콘 트렌치의 바닥에 쉽게 도달하지만 좁은 트렌치에 도달하는 염소 라디칼의 양은 더 적다. 이온 또한 좁은 트렌치의 측벽에서 일부 이온이 손실되는 동안 넓은 트렌치의 바닥에 균일하게 쉽게 도달할 수 있으므로 좁은 트렌치의 경우 이온 플럭스(Flux)가 감소한다. 마찬가지로 식각 부산물 또한 넓은 트렌치의 경우 트렌치 바닥에서 쉽게 빠져나갈 수 있지만 좁은 경우에는 쉽게 제거되지 않는다. 따라서 좁은 트렌치의 식각률 감소에 따라 ARDE%8값은 증가한다. 이에 반해 [그림 3-28(b)]는 비동기 펄스 플라즈마 모드에 대한 실리콘 트렌치 식각 원리에 대한 그림이다. 비동기 펄스 플라즈마 모드를 사용한 실리콘 트렌치 식각의 경우, 식각 주기는 고밀도의 소스 플라즈마 기간과 저밀도의 바이어스 플라즈마 기간으로 나뉜다. 반주기 전반의 소스 플라즈마 기간 동안 고밀도의 염소 라디칼과 저 에너지의 이온이 형성되고 고밀도의 염소 라디칼은 좁은 트렌치 내로도 충분히 확산되어 트렌치 바닥 영역을 화학 흡착한다. 이온 밀도는 높지만 기판 바이어스가 없기 때문에 실리콘 식각 속도는 느리다. 이후 반주기 후반의 바이어스 플라즈마 기간 동안 저밀도의 염소 라디칼과 이온이 형성된다. 그러나 이때 기판에 음의 DC 바이어스 전압이 형성되고, 낮은 플라즈마 밀도로 인해 동일한 바이어스 전력에서 ‘더 큰 이온 에너지’와 높은 직진성으로 인한 ‘더 예리한 이온 각도 분포’를 형성할 수 있다. 따라서 화학 흡착된 실리콘 트렌치 바닥 영역은 고 에너지의 이온에 의해 우선적으로 충격을 받고 화학 흡착된 박막은 식각된다. 이로 인한 식각 부산물은 넓은 트렌치 및 좁은 트렌치 모두에 대해 용이하게 제거되므로 낮은 식각 능력에도 불구하고 비동기 펄스 플라즈마 적용 시 ARDE가 개선되는 것이다. 8 최근 식각 기술 - 원자층 식각 기술(Atomic Layer Etch, ALE)반도체 소자의 미세화에 따라 더욱 정밀한 식각이 요구되어 원자층 식각(Atomic Layer Etching, ALE) 공정의 필요성이 부각되고 있다. 예를 들어 1nm 두께 수준의 게이트 산화막을 사용하는 경우, 다결정 실리콘 게이트 식각 시에 기존의 RIE 공정을 적용하면 산화막과의 낮은 선택비로 인해 실리콘 기판의 손상이 불가피하기 때문이다. 원자층 식각은 원자층 증착(Atomic Layer Deposition, ALD)과 유사하게 자기-제한(Self-limited)적인 표면 개질(Surface modification)9 단계와 그 후 개질된 층의 제거 단계로 구성된 주기적 프로세스이다. [그림 3-29]에 염소(Cl2)와 아르곤(Ar)을 사용한 실리콘 식각 공정을 예로 들어 ALE의 원리를 나타내었다. 먼저 반응-A는 염소 반응 물질을 실리콘 표면에 흡착시키는 단계로, 표면이 염소 전구체(Precursor)10 기체에 노출되고 이는 자기 제한적인 특성에 따라 화학 흡착된다. 여기서 노출된 실리콘 표면이 염소에 의해 모두 흡착되면, 추가적으로 염소 전구체를 투여하더라도 더 이상의 반응이 일어나지 않기 때문에 자기 제한적이라는 용어가 쓰이게 되었다. 이러한 흡착은 원자층을 제거하기 위한 에너지(본 예에서는 이온 충돌 에너지)를 감소시키는 역할을 한다. 예를 들어, 염소로 표면 개질된 SiClx의 경우, 흡착으로 원자층을 제거하기 위한 에너지는 개질되지 않은 경우의 이온 충돌 에너지 대비 약 20% 정도면 충분하다. 이 단계에서 플라즈마 증속(Plasma-Enhanced) ALE 방식을 적용하면 자기 제한까지의 시간을 단축할 수 있어 생산성을 개선할 수도 있다. 한편, 화학 흡착에 필요한 전구체로는 실리콘의 경우 Cl2, CF4가 사용되고, 실리콘 질화막은 H2 플라즈마, 그리고 실리콘 산화막에는 C4F8/Ar 플라즈마 등이 사용된다. 표면 개질9: 표면의 특성을 변화시킴. 전구체10: 어떤 물질대사나 반응에서 특정 물질이 되기 전 단계의 물질로, 통상 반응 가스를 말함. 다음은 질소나 아르곤과 같은 비활성 기체를 충분한 시간 동안 흘려 반응-A 단계에서의 과잉 전구체나 반응 부산물을 모두 제거하는 퍼지(Purge) 단계이다. 이때 염소가 퍼지되지 않고 남아 있으면 다음 반응-B 단계에서 염소가 아르곤 이온(Ar+)에 의해 분해되어 원치 않게 실리콘 표면이 식각되는 문제가 발생된다. 다음은 반응-B 단계로 활성화, 즉 실제로 박막이 식각되는 단계이다. 이때의 반응제(Coreactant)는 전자, 이온, 중성 원자, 열에너지 및 광자(Photon) 등 다양하다. 역시 이 단계에서도 자기 제한적 반응이 중요하며 열에너지에 의한 SiCl2 탈착의 경우는 등방성(Isotropic), 이온 충격에 의해 개질된 층을 제거하는 경우에는 비등방성(Anisotropic) ALE가 된다. 이온 충격의 경우에는 [그림 3-30]과 같이 자기 제한적 프로세스가 가능한 특정 이온 에너지 영역이 존재한다. 이를 공정 여유 구간의 의미인 공정 윈도우(Process window)라고 한다. 이 윈도우를 넘어선 과도한 에너지 영역에서는 스퍼터링이 일어나, 더 이상의 ALE 공정이 구현되지 않는다. ALE는 공정 시간이 길어 생산성이 부족하다는 문제 외에 공정 윈도우가 좁다는 단점도 있어, 이러한 공정 여유도를 넓힐 수 있는 전구체와 공정 조건의 개발이 활발히 진행되고 있다. 다시 [그림 3-29]의 식각 단계로 돌아오면, 두 번째 단계와 동일한 퍼지 단계를 마지막으로 하여 한 주기(Cycle)가 완료되고, 원하는 식각의 두께만큼 사이클을 반복하여 전체 식각 공정을 완료하게 된다. 이상의 표면 개질 및 제거 단계의 자기 제한적 특성으로 인해 ALE는 스케일링(Scaling) 가능성, 선택성 및 균일성에 있어 뛰어난 장점을 갖는다. 다만, 각 단계별 공정 감시(Monitoring)가 어렵고, ALD 공정과 마찬가지로 단위 층별(Layer by layer) 공정을 사용하기 때문에 생산성이 낮다는 점이 한계로 지적되고 있다. 이에 대한 개선책으로, 반응성이 높은 활성종(Radical)을 이용한 플라즈마 증속(Plasma Enhanced) ALE 공정이 등장하게 되었다. ALE 공정은 저손상 스페이서(Spacer) 식각 공정 등의 미세 패턴 형성 공정에 사용되고 있는 차세대 식각 공정 중 하나이다. |
기출문제로 정리하기 ※ 기출문제를 읽고 스스로 답변해 본 후, 이와 관련된 ‘이론 페이지’의 내용을 확인하여 자신의 답안과 비교합니다. | 이론 페이지 |
최신 기출 1 건식 식각과 습식 식각의 차이에 대해 설명하시오. | p.303 |
최신 기출 2 용량성 결합 플라즈마(CCP)와 유도성 결합 플라즈마(ICP) 건식 식각 설비의 차이에 대해 설명하시오. | p.308~310 |
최신 기출 3 반응성 이온 식각(RIE)에 대해 설명하시오 | p.311~312 |
최신 기출 4 식각 공정에서 중요한 평가 항목에 대해 설명하시오 | p.314~316 |
최신 기출 5 식각 공정의 부하 효과(Loading effect)에 대해 설명하시오. | p.319~320 |
커뮤니티 Q&A
위 이론과 관련된 게시글이에요.
이해가 안 되거나 궁금한 점이 있다면 커뮤니티에 질문해 보세요!
게시글 작성하기